Was ist IGBT?
IGBT steht für Insulated Gate Bipolar Transistor (isolierter Gate-Bipolartransistor) und ist eine Art Leistungshalbleiterbauelement, das Bipolartransistoren (BJTs) und Metalloxid-Halbleiter-Feldeffekttransistoren (MOSFETs) kombiniert. IGBTs haben eine hohe Eingangsimpedanz wie MOSFETs und einen geringen Spannungsabfall während der Leitung wie Riesentransistoren (GTRs). Sie werden häufig in Anwendungen mit einer Gleichspannung von 600 V oder mehr eingesetzt, z. B. in Wechselstrommotoren, Wechselrichtern, Stromversorgungen, Beleuchtungskreisen und Traktionsantrieben.
IGBTs sind eine Kernkomponente von Leistungselektronikgeräten und werden oft als „CPU” dieser Geräte bezeichnet. Sie finden breite Anwendung in verschiedenen Bereichen wie Schienenverkehr, Smart Grids, Luft- und Raumfahrt, Elektrofahrzeuge und neue Energieanlagen.
Entwicklungsprozess von IGBT
Fortschritte in der IGBT-Technologie in den 1980er Jahren
Das Konzept des IGBT wurde erstmals 1979 als MOS-gesteuertes Leistungsschaltelement mit einem V-förmigen Graben-Gate vorgestellt. In den frühen 1980er Jahren wurde die für die Herstellung von Leistungs-MOSFETs verwendete DMOS-Technologie (Double Diffused Metal Oxide Semiconductor) für IGBTs übernommen, wobei die Struktur des Siliziumchips ein dickes NPT-Design (Non-Punch-Through) aufwies. Später, mit der Entwicklung der Epitaxietechnologie auf dem Siliziumchip und der Verwendung von n+-Pufferschichten, die für eine bestimmte Sperrspannung ausgelegt waren, wurde durch die Einführung der PT-Struktur (Punch-Through) eine deutliche Verbesserung der Parameterkompromisse erreicht.
Fortschritte im IGBT-Design in den 1990er Jahren
Mitte der 1990er Jahre wurde die Trench-Gate-Struktur in einem neuen IGBT-Konzept wieder eingeführt, wobei ein neues Ätzverfahren aus der LSI-Technologie (Large Scale Integration) zum Einsatz kam, aber die Chipstruktur war weiterhin PT. Diese neue Trench-Struktur ermöglichte einen Kompromiss zwischen Einschaltspannung und Ausschaltzeit. Die Chipstruktur aus Silizium erfuhr ebenfalls eine dramatische Veränderung von NPT- zu LPT-Strukturen (Light Punch-Through), wodurch der sichere Betriebsbereich (SOA) ähnlich wie bei der Entwicklung der planaren Gate-Struktur verbessert wurde.
Der Übergang von PT zu NPT war die grundlegendste und bedeutendste konzeptionelle Änderung. Die PT-Technologie hat einen relativ hohen Ladungsträger-Injektionskoeffizienten, erfordert jedoch eine Steuerung der Minoritätsladungsträger-Lebensdauer, was die Transporteffizienz verringert. Im Gegensatz dazu hat die NPT-Technologie eine gute Transporteffizienz, ohne Minoritätsladungsträger zu zerstören, aber ihr Ladungsträger-Injektionskoeffizient ist relativ niedrig. Die LPT-Technologie, die der Soft-Punch-Through- oder Field-Stop-Technologie ähnelt, ersetzte die NPT-Technologie und verbesserte das Preis-Leistungs-Verhältnis weiter.
CSTBT und IGBT-Module der 5. Generation
Im Jahr 1996 ermöglichte der CSTBT (Carrier Stored Trench Gate Bipolar Transistor) die Realisierung des IGBT-Moduls der 5. Generation. Es verwendete die LPT-Chipstruktur und ein fortschrittlicheres Design mit großem Zellabstand. Derzeit werden neue Konzepte für IGBT-Bauelemente mit „Reverse Blocking Type”- oder „Reverse Conducting Type”-Funktionen untersucht, um eine weitere Optimierung zu erreichen.
IGBT-Leistungsmodule haben sich von Composite Power Modules (PIM) zu Intelligent Power Modules (IPM), Power Electronic Building Blocks (PEBB) und Power Modules (IPEM) weiterentwickelt, die IC-Treiber, verschiedene Ansteuerungsschutzschaltungen, leistungsstarke IGBT-Chips und neue Verpackungstechnologien verwenden.
IGBT-Struktur
Die linke Seite des IGBT-Diagramms zeigt den Aufbau eines N-Kanal-Bipolartransistors mit isoliertem Gate. Der N+-Bereich wird als Source-Bereich bezeichnet, und die daran befestigte Elektrode wird als Source-Elektrode (oder Emitter E) bezeichnet. Die N-Basis wird als Leckbereich bezeichnet. Der Steuerbereich des Bauelements ist der Gate-Bereich, und die daran befestigte Elektrode wird als Gate-Elektrode (oder Gate G) bezeichnet. Der Kanal wird direkt neben der Grenze des Gate-Bereichs gebildet. Der P-Typ-Bereich (einschließlich P+ und P-Bereiche) zwischen den Polen C und E (wo der Kanal gebildet wird) wird als Subkanalbereich bezeichnet. Der P+-Bereich auf der anderen Seite des Leckbereichs wird als Drain-Injektionsbereich bezeichnet, der ein einzigartiger Funktionsbereich des IGBT ist. Er bildet zusammen mit dem Leckbereich und dem Subkanalbereich einen PNP-Bipolartransistor, der als Emitter fungiert und Löcher in den Leckbereich injiziert, um die Leitfähigkeit zu modulieren und die Einschaltspannung des Bauelements zu reduzieren. Die an den Drain-Injektionsbereich angeschlossene Elektrode wird als Drain-Elektrode (oder Kollektor C) bezeichnet.
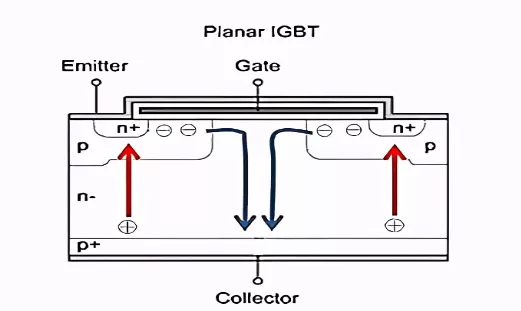
Die Schaltfunktion des IGBT wird durch Anlegen einer Vorwärtsspannung an das Gate erreicht, wodurch ein Kanal gebildet wird, der dem PNP-Transistor (ursprünglich NPN) Basisstrom zuführt und den IGBT einschaltet. Umgekehrt wird durch Anlegen einer Sperr-Gate-Spannung der Kanal eliminiert, der Basisstrom unterbrochen und der IGBT ausgeschaltet. Die Ansteuerungsmethode des IGBT entspricht im Wesentlichen der eines MOSFET, wobei nur der Eingangs-Gate-N-Kanal-MOSFET gesteuert wird, sodass er eine hohe Eingangsimpedanz aufweist. Wenn der Kanal des MOSFET gebildet wird, werden Löcher (Minderheitsträger) aus der P+-Basis in die N-Schicht injiziert, wodurch die Leitfähigkeit der N-Schicht moduliert und ihr Widerstand verringert wird, sodass der IGBT auch bei hohen Spannungen eine niedrige Durchlassspannung aufweist.
IGBT-Funktionsprinzip
Ein IGBT funktioniert wie ein MOSFET, jedoch wird bei einem IGBT der Drain des MOSFET durch den Emitter eines BJT ersetzt. Dadurch werden die hohe Eingangsimpedanz des MOSFET und die Ansteuerungsfähigkeit des BJT erreicht. Sehen wir uns nun anhand der folgenden vier Punkte an, wie ein IGBT funktioniert:
Gate-Steuerung von IGBT
IGBTs werden durch Anlegen einer Spannung an das Gate ein- und ausgeschaltet. Wenn eine positive Spannung an das Gate angelegt wird, werden Löcher in den n-dotierten Driftbereich injiziert, wodurch ein leitender Kanal für den Stromfluss entsteht.
Stromfluss und Schwellenspannung
Die Stromstärke, die durch einen IGBT fließen kann, wird durch die Größe des leitenden Kanals im Driftbereich bestimmt, der durch die Gate-Spannung gesteuert wird. Wenn die Gate-Spannung unter einen Schwellenwert sinkt, wird der Kanal unterbrochen und es kann kein Strom mehr fließen.
Parasitäre Thyristorstruktur und Latch-up-Verhinderung
Wenn die Kollektor-Emitter-Spannung in Sperrrichtung vorgespannt ist, kann sich innerhalb des IGBT eine parasitäre Thyristorstruktur bilden, die zu einem Latch-up oder einem Ausfall des Bauelements führen kann. Um dies zu verhindern, sind IGBTs mit einem leicht dotierten Bereich in der Nähe des Kollektors ausgestattet, um die Verstärkung der parasitären Thyristorstruktur zu reduzieren.
Schwanzstrom in IGBT
IGBTs weisen nach dem Abschalten der Gate-Spannung auch einen Nachlaufstrom oder einen langsamen Abfall des Kollektorstroms auf. Dies ist auf das Vorhandensein von Minoritätsträgern (Löchern) im n-dotierten Driftbereich zurückzuführen, die sich allmählich rekombinieren und den Strom reduzieren. Die Größe des Nachlaufstroms hängt von Faktoren wie Dotierungskonzentration, Temperatur und Gerätegeometrie ab.
IGBT-Eigenschaften
Statische Eigenschaften
Die statischen Eigenschaften eines IGBT umfassen hauptsächlich die Volt-Ampere-Eigenschaften und die Übertragungseigenschaften.
Volt-Ampere
Die Volt-Ampere-Kennlinie eines IGBT bezieht sich auf das Verhältnis zwischen dem Kollektor-Emitter-Strom und der Gate-Source-Spannung, wenn die Gate-Source-Spannung Ugs als Referenzgröße verwendet wird. Der Ausgangskollektor-Emitter-Strom wird durch die Gate-Source-Spannung Ugs gesteuert, wobei eine höhere Ugs zu einem größeren Id führt. Dies ähnelt den Ausgangseigenschaften eines GTR und kann in den Sättigungsbereich (1), den Verstärkungsbereich (2) und die Durchbruchseigenschaften (3) unterteilt werden. Im ausgeschalteten Zustand eines IGBT wird die Durchlassspannung vom J2-Übergang getragen, während die Sperrspannung vom J1-Übergang getragen wird. Wenn kein N+-Pufferbereich vorhanden ist, können die Durchlass- und Sperrspannungen auf dem gleichen Niveau liegen. Nach dem Hinzufügen des N+-Pufferbereichs kann die Sperrspannung jedoch nur noch einige zehn Volt erreichen, was den Anwendungsbereich des IGBT einschränkt.
Übertragung
Die Übertragungseigenschaften eines IGBT beziehen sich auf die Beziehung zwischen dem Ausgangs-Kollektor-Emitter-Strom Id und der Gate-Source-Spannung Ugs. Sie entsprechen den Übertragungseigenschaften eines MOSFET. Wenn die Gate-Source-Spannung unter der Schwellenspannung Ugs(th) liegt, befindet sich der IGBT im ausgeschalteten Zustand. Innerhalb des größten Teils des Kollektor-Emitter-Strombereichs, in dem der IGBT leitet, steht Id in linearer Beziehung zu Ugs. Die maximale Gate-Source-Spannung wird durch den maximalen Kollektor-Emitter-Strom begrenzt, und ihr optimaler Wert liegt im Allgemeinen bei etwa 15 V.
Dynamische Eigenschaften
Die dynamischen Eigenschaften eines IGBT werden auch als Schalteigenschaften bezeichnet und lassen sich in zwei Bereiche unterteilen: Schaltgeschwindigkeit und Schaltverluste.
Die Schalteigenschaften eines IGBT beziehen sich auf das Verhältnis zwischen dem Kollektor-Emitter-Strom und der Kollektor-Source-Spannung. Befindet sich ein IGBT im leitenden Zustand, hat sein PNP-Transistor aufgrund seiner breiten Basis einen niedrigen B-Wert. Obwohl es sich bei dem Ersatzschaltbild um eine Darlington-Struktur handelt, macht der durch den MOSFET fließende Strom den größten Teil des Gesamtstroms des IGBT aus. Zu diesem Zeitpunkt kann die Einschaltspannung Uds(on) wie folgt ausgedrückt werden:
Uds(on) = Uj1 + Udr + IdRoh
wobei Uj1 die Durchlassspannung des J1-Übergangs mit einem Wert von 0,7–1 V ist, Udr der Spannungsabfall am Verlängerungswiderstand Rdr und Roh der Kanalwiderstand. Der Strom im eingeschalteten Zustand Ids lässt sich wie folgt ausdrücken:
Ids=(1+Bpnp)Imos
wobei Imos der durch den MOSFET fließende Strom ist. Aufgrund des Leitfähigkeitsmodulationseffekts im N+-Bereich ist der Spannungsabfall im eingeschalteten Zustand des IGBT gering, und der Spannungsabfall im eingeschalteten Zustand eines 1000-V-IGBT beträgt 2–3 V. Wenn sich der IGBT im ausgeschalteten Zustand befindet, liegt nur ein geringer Leckstrom vor.
Während des Einschaltvorgangs eines IGBT arbeitet dieser die meiste Zeit als MOSFET. Erst in der späteren Phase der Abnahme der Kollektor-Source-Spannung Uds schaltet der PNP-Transistor vom Verstärkungsbereich in die Sättigung, wodurch sich die Verzögerungszeit erhöht. td(on) ist die Einschaltverzögerungszeit und tri ist die Stromanstiegszeit. In praktischen Anwendungen ist die Einschaltzeit des Kollektor-Emitter-Stroms ton die Summe aus td(on) und tri, und die Abfallzeit der Kollektor-Source-Spannung setzt sich aus tfe1 und tfe2 zusammen.
Arten von IGBT
IGBT mit geringem Stromverbrauch
IGBT wird im Allgemeinen im Bereich von 600 V, 1 KA und 1 kHz oder darüber verwendet. Um den Entwicklungsanforderungen der Haushaltsgeräteindustrie gerecht zu werden, haben Unternehmen wie Motorola, ST Semiconductor und Mitsubishi IGBT-Produkte mit geringem Stromverbrauch auf den Markt gebracht, die für Haushaltsgeräte wie Mikrowellenherde, Waschmaschinen, Induktionsherde, elektronische Gleichrichter und Kameras geeignet sind.
Der IGBT
U (Trench-Struktur) – IGBT ist eine Struktur, bei der durch das Einfräsen von Rillen in den Chipkern ein trenchförmiges Gate innerhalb der Chipzelle gebildet wird. Durch die Verwendung der Trench-Struktur kann die Zellengröße weiter reduziert, der Kanalwiderstand verringert, die Stromdichte verbessert und das kleinste Produkt mit derselben Nennstromstärke und Chipgröße hergestellt werden. Es gibt viele Unternehmen, die verschiedene U-IGBT-Produkte herstellen, die für Niederspannungsantriebe und Oberflächenmontageanforderungen geeignet sind.
Nichtverbreitungsvertrag – Internationale Atomenergie-Organisation
NPT (Non-Punch-Through) – IGBT nutzt die Technologie dünner Siliziumwafer, um die dicke, hochohmige Epitaxieschicht durch Ionenimplantation in den Emitterbereich zu ersetzen, wodurch die Produktionskosten um etwa 25 % gesenkt werden können. Je höher die Spannungsfestigkeit, desto größer der Kostenunterschied. Er zeichnet sich durch hervorragende Eigenschaften in Bezug auf Leistung, hohe Geschwindigkeit, geringe Verluste, positiven Temperaturkoeffizienten, keinen Latch-up-Effekt und höchste Zuverlässigkeit bei der Konstruktion von IGBTs von 600 bis 1200 V aus. Siemens kann Produkte der Serien 600 V, 1200 V, 1700 V und 6500 V Hochspannungs-IGBTs liefern. Außerdem hat das Unternehmen einen DLC-Typ NPT-IGBT mit niedrigem Sättigungsspannungsabfall auf den Markt gebracht. Infineon, Harris, Intersil, Toshiba und andere Unternehmen haben ebenfalls NPT-IGBT und Modulserien entwickelt. Fuji Electric, Motorola und andere Unternehmen arbeiten derzeit an der Entwicklung, und der NPT-Typ wird zur Richtung der IGBT-Entwicklung.
Kleinsignal-Bipolartransistor – Bipolartransistor mit isoliertem Gate
Da Hersteller derzeit großen Wert auf die Entwicklung von IGBT legen, verwenden Samsung, QuickLogic und andere Unternehmen die SDB-Technologie (Silicon Wafer Direct Bonding), um die vierte Generation von Hochgeschwindigkeits-IGBT- und Modulserienprodukten auf der IC-Produktionslinie herzustellen. Die Merkmale sind hohe Geschwindigkeit, geringer Sättigungsspannungsabfall, geringer Reststrom und positiver Temperaturkoeffizient, die im Spannungsbereich von 600 V und 1200 V hervorragend sind und in zwei Systeme unterteilt sind: UF und RUF.
Ultraschneller IGBT
Der Schwerpunkt der Forschung und Entwicklung des internationalen Gleichrichterunternehmens IR liegt darauf, den Tail-Effekt von IGBT zu reduzieren und dessen Abschaltzeit zu verkürzen. Der entwickelte ultraschnelle IGBT kann den Tail-Effekt minimieren und hat eine Abschaltzeit von nicht mehr als 2000 ns. Durch den Einsatz einer speziellen Hochenergie-Bestrahlungsschichttechnologie kann die Abschaltzeit unter 100 ns liegen und der Tail-Effekt ist sogar noch kürzer. Die wichtigsten Produkte sind für die Motorsteuerung konzipiert, in sechs Modellen erhältlich und können auch in Hochleistungsstromrichtern eingesetzt werden.
Bipolartransistor mit isoliertem Gate / Vorwärtsspannungsabfall
Das Unternehmen IR hat zwei neue Geräte vorgestellt, die FRD (Fast Recovery Diode) mit IGBT kombinieren. Die effektive Kombination von IGBT/FRD reduziert die Schaltverluste um 20 %. Es verwendet ein TO-247-Gehäuse und hat eine Nennleistung von 1200 V, 25, 50, 75 und 100 A. Es wird für Motorantriebe und die Energieumwandlung verwendet. Die neue Technologie auf Basis von IGBT und FRD begünstigt die Parallelschaltung von Geräten, sorgt für eine gleichmäßigere Temperatur in Multi-Chip-Modulen und verbessert die allgemeine Zuverlässigkeit.
IGBT-Module
Ein IGBT-Modul ist eine Art modulares Halbleiterprodukt, das aus IGBT-Chips und Freilaufdioden-Chips (FWD) besteht, die mithilfe spezifischer Schaltungsverbindungen zusammengebaut sind. Diese Module werden direkt in verschiedenen Geräten wie Frequenzumrichtern (VFDs) und Wechselrichtermodulen verwendet. Sie sind bekannt für ihre energiesparenden Eigenschaften, ihre einfache Installation und Wartung sowie ihre stabile Wärmeableitung. Die meisten auf dem Markt erhältlichen IGBTs sind in Form dieser modularen Produkte erhältlich.
Von PIM zu IPEM: Die Entwicklung der IGBT-Module
IGBT-Module verwenden IC-Treiber und verschiedene Treiber-Schutzschaltungen, leistungsstarke IGBT-Chips und neue Verpackungstechnologien. Sie haben sich vom Power Integrated Module (PIM) zum Intelligent Power Module (IPM), Power Electronic Building Blocks (PEBB) und Integrated Power Electronic Modules (IPEM) weiterentwickelt. PIMs haben sich in Richtung Hochspannungs- und Hochstromanwendungen mit einer Produktpalette von 1200–1800 A/1800–3300 V entwickelt. IPMs werden hauptsächlich für Frequenzumrichter verwendet, während 600-A/2000-V-IPMs in VVVF-Wechselrichtern für Elektrolokomotiven zum Einsatz kommen. PEBBs verwenden eine planare Verpackungstechnologie mit niedriger Induktivität und Hochstrom-IGBT-Modulen als aktive Bauelemente, die in Raketenwerfern für Schiffe zum Einsatz kommen. IPEMs verwenden die Co-Fired-Ceramic-Chip-Multi-Chip-Modul-Technologie zur Montage von PEBBs, wodurch die Induktivität der Schaltungsverdrahtung erheblich reduziert und die Systemeffizienz verbessert wird. Die zweite Generation von IPEMs wurde erfolgreich entwickelt, bei der alle passiven Komponenten in Form von vergrabenen Schichten in das Substrat eingebettet sind.
Intelligentes und modulares Design wird zu einem Entwicklungsschwerpunkt für IGBTs. Mit der Förderung von Energieeinsparungs- und Umweltschutzkonzepten werden diese Produkte auf dem Markt immer mehr Verbreitung finden.
IGBT vs. MOSFET
| Feature | IGBT | MOSFET |
|---|---|---|
| Full name | Insulated Gate Bipolar Transistor | Metal-Oxide-Semiconductor Field-Effect Transistor |
| Number of leads | 3 | 3 |
| Lead names | Collector (C), Emitter (E), Gate (G) | Source (S), Drain (D), Gate (G) |
| Breakdown Voltage | Up to 1200V | Lower than IGBTs |
| Collector Saturation Current | Over 1500A | Lower than IGBTs |
| Switching Speed | between 1 kHz and 20 kHz | 20 to 200 picoseconds |
| Conduction Losses | Lower | Higher |
| Switching Losses | Higher | lower |
| Thermal Stability | Better | Worse |
| Safe Operating Area (SOA) | Larger | Smaller |
| Advantages | High breakdown voltage, high collector saturation current, good high-frequency performance | Good thermal stability, large safe operating area |
| Disadvantages | Slow switching speed, high switching losses | Low breakdown voltage, low operating current |
| Typical applications | Inverters, motor drives, power supplies for high voltage and high current applications | Switching power supplies, DC-DC converters, power amplifiers |
Wie überprüft man einen IGBT mit einem Multimeter?
Um einen IGBT mit einem Multimeter zu überprüfen, müssen Sie die folgenden Schritte ausführen:
Bestimmen Sie die Polarität:
Stellen Sie das Multimeter auf R×1KΩ ein und messen Sie den Widerstand zwischen jedem der drei Pins. Der Pin mit unendlichem Widerstand zu den beiden anderen Pins nach dem Vertauschen der Multimeterleitungen ist der Gate-Pin (G). Messen Sie dann erneut den Widerstand mit den beiden anderen Pins. Der Pin mit dem geringeren Widerstand ist der Kollektor (C), während der andere der Emitter (E) ist.
Funktionsprüfung:
Stellen Sie das Multimeter auf R×10KΩ ein und verbinden Sie die schwarze Sonde mit dem Kollektor (C) und die rote Sonde mit dem Emitter (E) des IGBT. Der Zeiger des Multimeters sollte auf Null stehen. Berühren Sie gleichzeitig mit den Fingern den Gate- (G) und den Kollektor- (C) Pin, woraufhin sich der IGBT einschalten sollte und der Zeiger des Multimeters sich in Richtung eines niedrigeren Widerstandswertes bewegen und dort bleiben sollte. Berühren Sie dann mit Ihren Fingern sowohl den Gate-Pin (G) als auch den Emitter-Pin (E), woraufhin sich der IGBT ausschalten und der Zeiger des Multimeters wieder auf Null zurückkehren sollte. Ist dies der Fall, funktioniert der IGBT ordnungsgemäß.
Vorsichtsmaßnahmen:
Verwenden Sie zum Testen von IGBTs ein beliebiges Zeiger-Multimeter. Stellen Sie das Multimeter beim Testen der Funktionsfähigkeit immer auf R×10KΩ ein, da die niedrigeren Widerstandseinstellungen nicht über genügend Spannung verfügen, um den IGBT auszulösen. Diese Methode kann auch zum Testen der Funktionsfähigkeit von Leistungs-MOSFETs (P-MOSFET) verwendet werden.
IGBT-Anwendung
Als eines der wichtigsten Hochleistungsgeräte der Leistungselektronik wird der IGBT in großem Umfang in Haushaltsgeräten, im Transportwesen, in der Energietechnik, in erneuerbaren Energien und in intelligenten Stromnetzen sowie in anderen Bereichen eingesetzt.
In industriellen Anwendungen, wie z. B. Verkehrssteuerung, Stromumwandlung, Industriemotoren, unterbrechungsfreie Stromversorgungen, Windkraft- und Solarenergieanlagen sowie Frequenzumrichter für die automatische Steuerung.
In der Unterhaltungselektronik werden IGBTs in Haushaltsgeräten, Kameras und Mobiltelefonen eingesetzt.