IC Failure Analysis
Comprehensive technical resource for semiconductor failure analysis methodologies, tools, and case studies
What is IC Failure Analysis?
Integrated Circuit (IC) Failure Analysis is a systematic process used to identify, isolate, and determine the root cause of semiconductor device failures. This critical engineering discipline combines advanced imaging techniques, electrical testing, and material science to resolve issues in integrated circuits across various industries.
Effective failure analysis improves product reliability, reduces manufacturing costs, accelerates time-to-market, and ensures compliance with industry standards. It plays a vital role in quality control, reliability engineering, and product improvement cycles.
Key Objectives of IC Failure Analysis
- Identify root causes of IC failures through systematic investigation
- Determine whether failures originate from design, manufacturing, or application
- Develop corrective actions to prevent future failures
- Validate reliability and performance of integrated circuits
- Support failure reporting and reliability data analysis
Technical Guides & Methodologies
Diagnostic Flowchart
Systematic approach from failure symptom to root cause identification
No Power/Output Failure Path
- 1 Check for ESD damage using SEM/EDS analysis
- 2 Verify solder joints with 3D X-ray inspection
- 3 Test for gate oxide breakdown using EMMI
- 4 Perform continuity testing with OBIRCH
- 5 Analyze package integrity with C-SAM
Intermittent Glitches Failure Path
- 1 Rule out BGA microcracks using C-SAM
- 2 Check for thermal stress with infrared imaging
- 3 Test for design-related latch-up through circuit simulation
- 4 Verify power distribution network integrity
EMMI Operation Guide
Step-by-step workflow for Emission Microscopy analysis
Device Preparation
Power up the device in failure-reproducing state, ensure proper cooling
Darkroom Setup
Position device under EMMI microscope, ensure proper alignment
Camera Configuration
Set appropriate exposure time (typically 10-60 seconds) and sensitivity
Image Acquisition
Capture multiple images with varying exposure times for optimal results
Analysis & Overlay
Overlay emission spots with design layout to identify failing structures
Troubleshooting Tip
If no hotspots appear, verify the chip is in a failure-reproducing state and check if the failure mechanism produces photon emissions (open circuits typically do not)
Common Failure Analysis Pitfalls
ESD Damage Overlook
Failing to account for electrostatic discharge damage during handling, especially in CMOS chips. Always verify wrist strap functionality and grounding protocols.
Inadequate Power Derating
Resistor burnout from operating at 80%+ power load. Recommended practice is 50% derating to ensure reliability under varying conditions.
Incorrect Failure Reproduction
Analyzing devices under conditions that don't accurately reproduce the field failure scenario, leading to incorrect root cause identification.
Overlooking Packaging Issues
Focusing exclusively on die-level issues while missing package-related failures like delamination, lead corrosion, or solder joint fatigue.
Insufficient Documentation
Failing to document each analysis step thoroughly, making it difficult to replicate results or perform trend analysis across multiple failures.
Tool Calibration Issues
Using improperly calibrated equipment, leading to inaccurate measurements and incorrect failure analysis conclusions.
Industry Case Studies
IGBT Module Failure in EVs
Symptom
Sudden power loss during charging, with no visible external damage to the EV powertrain.
Analysis Process
- Thermal imaging revealed hotspots in IGBT module during power cycling
- SEM/EDS analysis identified excessive IMC (Cu₆Sn₅) growth in solder joints
- Cross-sectioning showed Kirkendall void formation at the solder-substrate interface
- FEA simulation linked failure to insufficient solder reflow profile
Solution & Outcome
Adjusted reflow profile to ensure proper wetting and added nickel-plated pads to control IMC growth.
Result: Field failure rate reduced by 0.58% annually, saving $2M in warranty costs.
Relevant Standards
Thermal Imaging Results

SEM Image of IMC Growth
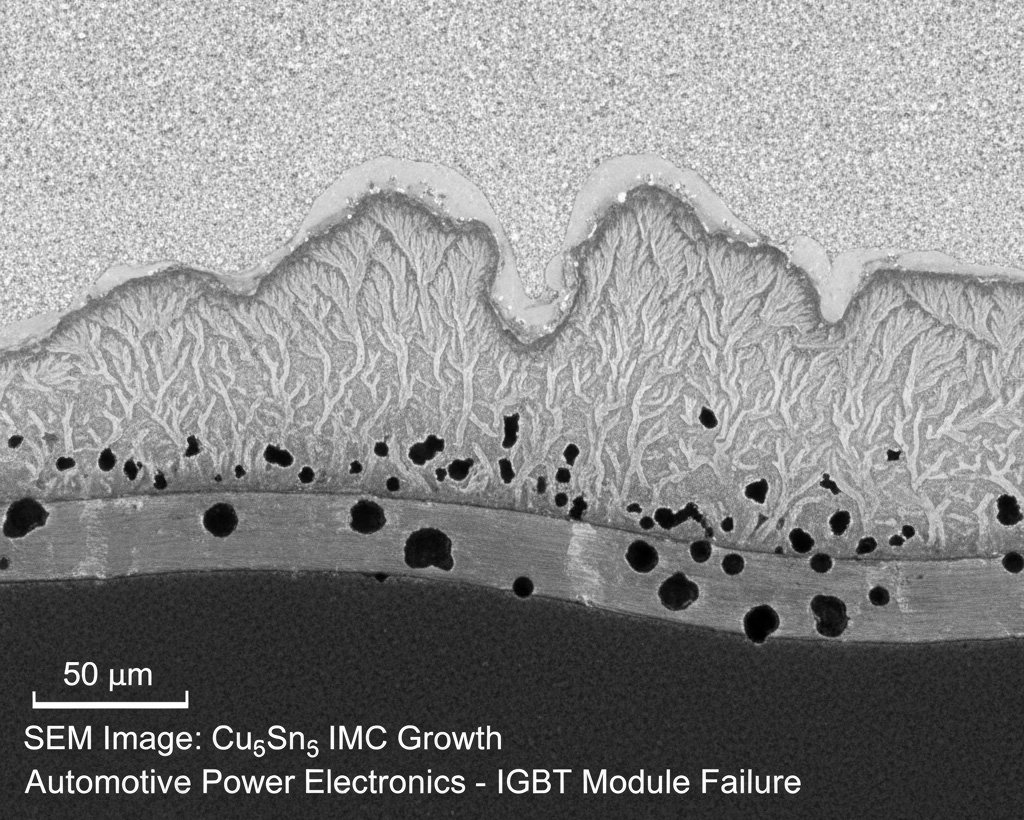
GaAs Amplifier Failure in 5G AAUs
Symptom
Field failures in 5G Active Antenna Units (AAUs) within 6 months of deployment, resulting in signal degradation.
Analysis Process
- C-SAM inspection detected die cracks in GaAs power amplifiers
- Packaging audit found abnormal ejector marks on die backside
- Reliability data analysis showed failure distribution fitting early failure mode
- Finite element analysis confirmed mechanical stress during die bonding
Solution & Outcome
Modified die bonding blue film to reduce mechanical stress and implemented 100% post-bond inspection using automated optical inspection.
Result: Failure rate reduced by 92%, extending mean time between failures to over 5 years.
Relevant Standards
C-SAM Image of Die Cracks

Failure Distribution Analysis

BGA Failure in Smartphones
Symptom
Intermittent display blackouts and unresponsive touchscreen in high-end smartphones after 6-8 months of use.
Analysis Process
- Thermal cycling ( -40°C to 85°C) reproduced the failure in lab conditions
- SAM (Scanning Acoustic Microscopy) revealed solder joint fatigue
- Cross-sectioning confirmed CTE (Coefficient of Thermal Expansion) mismatch
- 3D X-ray analysis quantified void formation in 18% of BGA joints
Solution & Outcome
Implemented underfill with higher Tg (Glass Transition Temperature) and optimized PCB layout to reduce thermal gradients.
Result: Field returns reduced by 76%, with no failures reported beyond 18 months of use.
Relevant Standards
3D X-ray of BGA Voids

Cross-section of Failed Joint
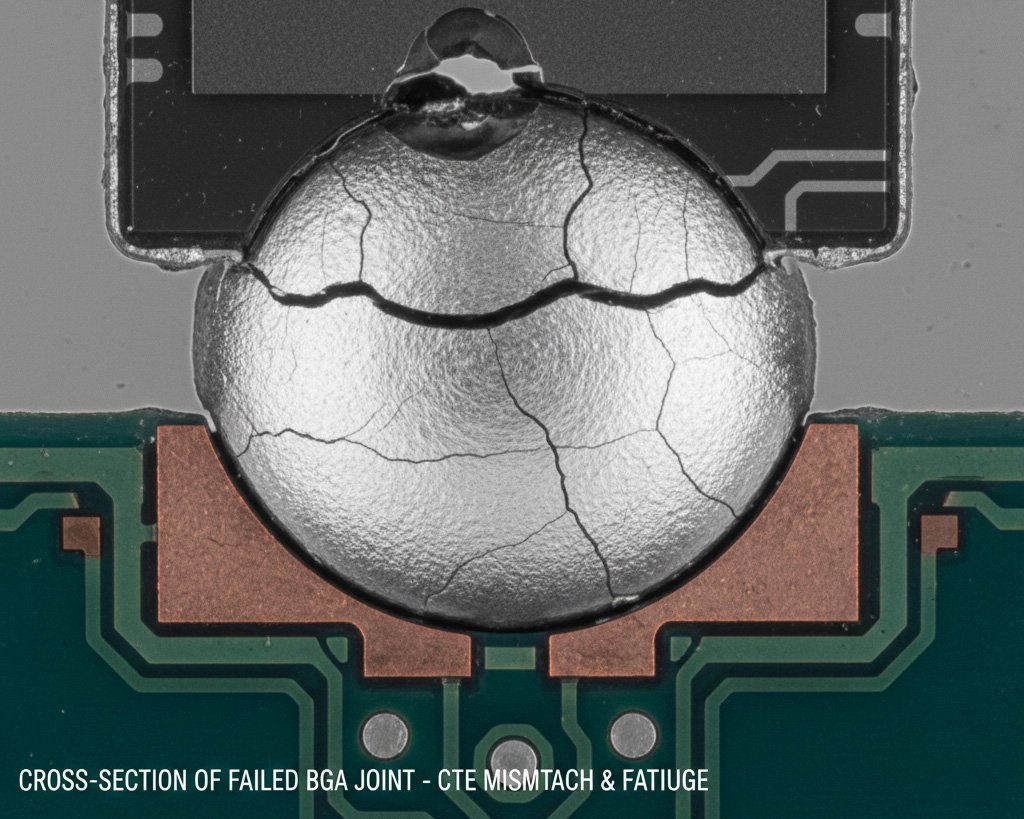
Avionics Control IC Failure
Symptom
Random system resets in avionics control modules during high-altitude flight, with no clear pattern.
Analysis Process
- Environmental testing reproduced failure under low pressure (high altitude) conditions
- EMMI detected intermittent gate leakage in power management IC
- IC-CAP modeling identified unmodeled thermal memory effects in GaN HEMTs
- ESD testing revealed insufficient protection in input circuitry
Solution & Outcome
Updated ASM-HEMT model to include thermal memory effects and enhanced ESD protection circuitry.
Result: Complete elimination of in-flight resets, with successful qualification under DO-254 standards.
Relevant Standards
EMMI Image of Gate Leakage

Thermal Memory Effect Analysis

Tools & Equipment
| Tool | Core Use Case | Resolution Limit | Best For | Limitation |
|---|---|---|---|---|
| EMMI | Hotspot localization (leaks, breakdowns) | ~1μm | CMOS/FinFETs | No signal for open circuits |
| C-SAM | Delamination/void detection | 50nm | Flip-chip, BGA | Requires liquid coupling |
| 3D X-ray CT | TSV/stacked die inspection | 100nm | 3D ICs | High cost for high resolution |
| Lock-in Thermography | Sub-°C thermal mapping | 0.1°C | Power ICs (IGBTs) | Slow scan time |
| SEM/EDS | Material characterization, defect imaging | 1-5nm | Die-level physical analysis | Requires conductive coating for insulators |
| FIB-SEM | Cross-sectioning, circuit editing | 5nm | 3D ICs, advanced packaging | Destructive, time-consuming |
Tool-Technique Pairing Guide
Matching the right tools to specific failure scenarios ensures efficient and accurate root cause analysis:
ESD Damage Analysis
- Start with EMMI to locate leakage sites
- Follow with FIB-SEM for nanoscale imaging of damage
- Use EDS to check for contamination at failure sites
- Verify with electrical testing (IV curve analysis)
3D IC TSV Cracks
- Use 3D X-ray CT for non-destructive inspection
- Validate with FIB cross-sectioning at critical locations
- Perform SEM imaging to characterize crack morphology
- Apply finite element analysis to determine stress origins
Thermal-Related Failures
- Begin with lock-in thermography for thermal mapping
- Use C-SAM to check for delamination due to thermal stress
- Perform cross-sectioning to examine solder joint integrity
- Validate with thermal cycling tests
Intermittent Failures
- Use environmental chamber to reproduce failure conditions
- Apply OBIRCH for dynamic current path analysis
- Employ thermal imaging during stress testing
- Verify with vibration testing if mechanical stress is suspected
Emerging Tools & Technologies
AI-Enhanced EMMI
Machine learning algorithms that automatically distinguish normal vs. abnormal photon emission patterns, reducing analysis time by up to 70%.
Quantum Dot Labeling
Nanoscale fluorescent markers that highlight defect regions in semiconductors, enabling earlier detection of potential failure sites.
Predictive FA Platforms
Integrated systems that combine manufacturing data, in-field failure reports, and AI to predict potential failure mechanisms before they occur.
Standards & Compliance
JEDEC Standards
JESD22-A121: ESD Testing
Defines procedures for human body model (HBM), machine model (MM), and charged device model (CDM) electrostatic discharge testing.
JESD47: Stress Test Methods for Integrated Circuits
Comprehensive standard covering various stress tests including temperature cycling, voltage temperature, electromigration, and time-dependent dielectric breakdown.
JESD22-A104: Temperature Cycling
Specific standard for temperature cycling tests to evaluate component reliability under thermal stress conditions.
Industry-Specific Standards
AEC-Q100: Automotive ICs
Qualification specification for integrated circuits used in automotive applications, with stringent reliability requirements.
DO-254: Aerospace Avionics
Design assurance guidance for airborne electronic hardware, including integrated circuits used in flight-critical systems.
Telcordia GR-468: Telecommunications
Requirements for reliability assurance of semiconductor devices used in telecommunications equipment.
Reliability Data Analysis
Effective failure analysis requires statistical analysis of reliability data to understand failure distributions and predict product lifetime:
Failure Distributions
- Log-normal distribution: Common for semiconductor failures
- Weibull distribution: Useful for analyzing early, random, and wear-out failures
- Exponential distribution: Appropriate for constant failure rate regions
Key Metrics
- MTBF (Mean Time Between Failures)
- Failure Rate (λ) - typically expressed in FITs (Failures In Time: 1 FIT = 1 failure per 10^9 device-hours)
- Accelerated Life Testing (ALT) conversion factors
Failure Rate Analysis Example
Future Trends in IC Failure Analysis
Advanced Process Nodes (2nm/1nm)
Analysis challenges at the atomic scale with quantum effects becoming significant factors in failure mechanisms.
Key Challenges
- • Quantum tunneling effects
- • Backside power delivery defects
- • Atomic-level contamination detection
Emerging Solutions
- • Cryogenic TEM for atomic-level inspection
- • AI-driven nanoprobing techniques
- • Advanced atom probe tomography
3D IC & Heterogeneous Integration
Complex failure modes in stacked die architectures requiring new non-destructive analysis techniques.
Key Challenges
- • TSV (Through-Silicon Via) cracking
- • Underfill delamination in stacked dies
- • Thermal management issues
Emerging Solutions
- • Advanced 3D X-ray CT with higher resolution
- • Multi-modal imaging techniques
- • Design-for-testability in 3D ICs
AI & Machine Learning
Automated failure detection and classification to handle the increasing complexity of ICs.
Key Applications
- • Automated defect classification in SEM images
- • Predictive failure analysis from manufacturing data
- • Anomaly detection in wafer test data
Benefits
- • 50-70% reduction in analysis time
- • Improved accuracy in root cause identification
- • Early failure prediction before field deployment
