Son yıllarda, yeniden dağıtım katmanı (RDL) teknolojisi büyük ilgi görmeye başladı. Bu, entegre devrelerin (IC) paketlenme şeklini kökten değiştiren devrim niteliğinde bir paketleme çözümüdür.
Bu makalede, RDL'nin tanımını, işlevini, avantajlarını, sürecini, uygulamalarını ve diğer IC paketleme teknolojileriyle karşılaştırmasını inceleyeceğiz.
Yeniden Dağıtım Katmanı Teknolojisi nedir?
RDL olarak da bilinen yeniden dağıtım katmanı, elektrik bağlantılarını yeniden dağıtmak amacıyla entegre devreye veya mikroçipe eklenen bir metal katmandır. Bu RDL teknolojisi, entegre devreler (IC'ler) için gelişmiş bir paketleme çözümüdür ve birden fazla yonganın tek bir pakete entegre edilmesini sağlar. Bu, dielektrik tabakanın üzerine desenli bir metal tabaka oluşturma işlemidir ve IC'nin giriş/çıkışını (I/O) yeni bir konuma yeniden dağıtır. Yeni konum genellikle yonganın kenarındadır ve bu sayede IC, standart yüzey montaj teknolojisi (SMT) kullanılarak baskılı devre kartına (PCB) bağlanabilir. RDL teknolojisi, tasarımcının yongayı kompakt ve verimli bir şekilde yerleştirmesini sağlayarak cihazın toplam ayak izini azaltır.
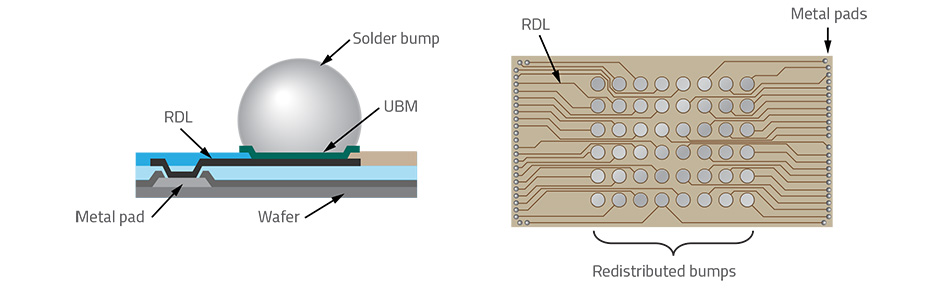
RDL teknolojisi, giderek daha kompakt ve karmaşık hale gelen modern elektronik cihazların geliştirilmesinde hayati öneme sahiptir. Bu teknoloji, yongaların daha küçük, daha hızlı ve daha verimli olmasını sağlar. Genellikle MEMS cihazları, sensörler, güç cihazları, bellekler, mikroişlemciler ve grafik işlemcilerin paketlenmesinde kullanılır.
Yeniden Dağıtım Katmanının İşlevi
Yeniden dağıtım katmanı (RDL), yonga tasarımı ve üretiminde XY düzleminin genişletilmesi ve birbirine bağlanmasında kritik bir rol oynar.

G/Ç bağlantısını yeniden dağıtın
G/Ç (giriş/çıkış) pedleri, genellikle yonganın kenarlarında veya çevresinde yer alan yonga pini işleme modülleridir. Bu pedler, yonga pinlerinin sinyallerini işleyebilir ve işleme sonrasında yonganın sinyalini pinlere iletebilir.
RDL, yongadan pakete I/O bağlantılarının yeniden dağıtımını kolaylaştırabilir. RDL, yongadaki bağ pedlerini paket uçlarına veya toplarına bağlar, bu da IC'nin daha kolay montajını ve daha iyi performansını sağlar.
Bu, bağlama teli işlemi için doğal olarak elverişlidir, ancak flip çipler için biraz zordur. Bu nedenle, RDL bu noktada anahtar rol oynamıştır. Çipin yüzeyine bir metal tabaka ve buna karşılık gelen dielektrik tabaka yerleştirir, bir metal tel oluşturur ve IO bağlantı noktalarını yeni, daha geniş bir alana yeniden tasarlar, böylece bir yüzey dizisi düzeni oluşturur.
Yol Sinyalleri ve Güç
Buna ek olarak, RDL, entegre devre (IC) içinde sinyalleri ve gücü iletmek için bir yol da sağlar. Entegre devrelerin giderek daha karmaşık hale gelmesi ve daha fazla I/O bağlantısı gerektirmesi nedeniyle RDL’lerin kullanımı giderek daha önemli hale gelmiştir. Bunlar, mikroişlemciler, bellek yongaları ve sensörler gibi çok çeşitli uygulamalarda kullanılmaktadır.
Yeniden Dağıtım Katmanının Avantajları
RDL teknolojisi, yüksek performanslı, kompakt ve uygun maliyetli elektronik cihazlar tasarlamak isteyen tasarımcılara birçok avantaj sunar. IC paketlerinde RDL teknolojisinin kullanılmasının bazı avantajları şunlardır:
Daha Az Yer Kaplama
RDL teknolojisi, birden fazla yonganın tek bir pakete entegre edilmesini sağlayarak cihazın toplam kapladığı alanı azaltır. Bu sayede tasarımcılar, akıllı telefonlar, giyilebilir cihazlar ve IoT cihazları gibi uygulamalar için hayati önem taşıyan daha küçük ve kompakt elektronik cihazlar geliştirebilirler.
Geliştirilmiş Elektriksel Performans
RDL teknolojisi, tasarımcının yongayı kompakt ve verimli bir şekilde yerleştirmesini sağlar; bu da bağlantı hatlarının uzunluğunu azaltır. Bu da sinyal gecikmesini azaltır ve cihazın elektriksel performansını artırır. RDL teknolojisi ayrıca parazitik kapasitansı ve endüktansı azaltır; bu da cihazın sinyal bütünlüğünü iyileştirir.
İndirimli Fiyat
RDL teknolojisi, maliyetli ve zaman alıcı süreçler olan tel bağlama ve flip-chip bağlama ihtiyacını ortadan kaldırır. RDL teknolojisi ayrıca cihaz için gerekli bileşen sayısını azaltarak cihazın maliyetini daha da düşürür. RDL teknolojisi, küçük form faktörü gerektiren yüksek performanslı entegre devrelerin üretimi için uygun maliyetli bir çözümdür.
Yeniden Dağıtım Katmanı Teknolojisi Türleri
Yeniden dağıtım katmanı (RDL) teknolojisinin iki türü vardır: fan-in ve fan-out. Fan-in RDL teknolojisi tek bir yonganın paketlenmesinde kullanılırken, fan-out RDL teknolojisi birden fazla yonganın paketlenmesinde kullanılır.
Fan-in RDL Teknolojisi
Fan-in RDL teknolojisi, tek bir yonganın paketlenmesi için kullanılır. Fan-in RDL teknolojisi, yonga üzerinde doğrudan bir paket oluşturma işlemi olan yonga düzeyinde paketleme (WLP) olarak da bilinir. Fan-in RDL teknolojisi, küçük ve ince paketler oluşturmak için uygun maliyetli bir çözümdür.
Fan-in RDL teknolojisi, sensörler, MEMS cihazları, RF cihazları, mikroişlemciler ve bellek cihazları gibi uygulamalar için uygundur.
Fan-out RDL Teknolojisi
Fan-out RDL teknolojisi, birden fazla yonganın paketlenmesi için kullanılır. Fan-out RDL teknolojisi, yeniden yapılandırılmış bir yonga üzerinde paket oluşturma işlemi olan wafer-level fan-out (WLFO) olarak da bilinir. Fan-out RDL teknolojisi, küçük form faktörlü yüksek performanslı paketler oluşturmak için uygun maliyetli bir çözümdür.
Fan-out RDL teknolojisi, grafik işlemciler, sistem-on-chip (SoC), bellek cihazları, güç cihazları ve LED cihazları gibi uygulamalar için uygundur.
Yeniden Dağıtım Katmanı Süreci
RDL teknolojisi, dielektrik biriktirme, metal biriktirme, desen oluşturma ve aşındırma gibi birçok adımı içeren karmaşık bir süreçtir. Aşağıda Fan-in RDL ve Fan-out RDL için süreç akış şeması yer almaktadır.
Fan-in RDL Süreci
Fan-in RDL süreci, Wafer-Level Chip-Scale Packaging (WLCSP) ve System-in-Package (SiP) tasarımları gibi gelişmiş paketleme çözümlerinin üretiminde kullanılır. Bu süreç, yarı iletken cihazlar için daha yüksek entegrasyon seviyeleri, daha küçük boyutlar ve daha iyi performans sağlar. Süreç, aşağıda belirtildiği gibi birçok aşamadan oluşur:
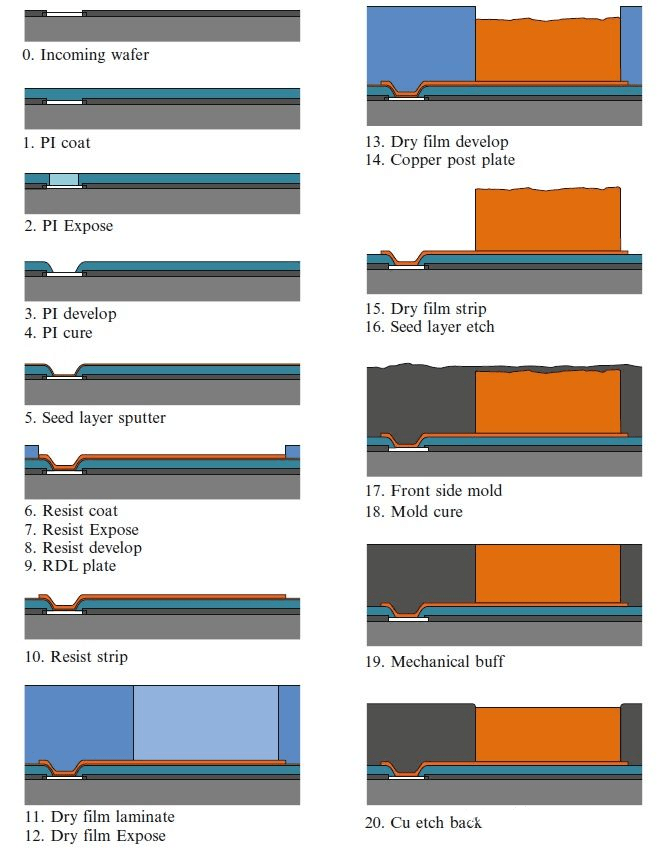
Süreç, gelen bir yonga plakasıyla başlar; bu plaka 1. adımda PI (Fotorezist İzolatör) ile kaplanır. Bunu 2. adımda PI pozlaması, 3. adımda PI banyosu ve 4. adımda PI kürlemesi izler.
5. adımda, yonga üzerine bir tohum tabakası püskürtülür ve ardından 6. adımda resist ile kaplanır. Resist daha sonra 7. adımda pozlanır, 8. adımda geliştirilir ve 9. adımda RDL kaplanır.
Bundan sonra, 10. adımda resist sıyırılır ve 11. adımda yonga üzerine bir kuru film lamine edilir. Kuru film daha sonra 12. adımda pozlanır ve 13. adımda geliştirilir. Ardından, 14. adımda yonga üzerine bakır direkler kaplanır ve 15. adımda kuru film sıyırılır.
16. adımda tohum tabakası aşındırılır ve 17. adımda ön taraf kalıbı oluşturulur. Ardından kalıp 18. adımda kürlenir ve yonga plakası 19. adımda mekanik olarak parlatılır. Son olarak, 20. adımda fazla bakır geriye doğru aşındırılır ve Fan-in RDL işlem akışı tamamlanır.
Fan-out RDL Süreci
Fan-in RDL sürecine benzer şekilde, Fan-out RDL süreci de daha fazla bağlantı içeren, daha küçük ve daha yüksek performanslı yonga paketleri üretmenin bir yoludur. Üretim aşamaları şunlardır:
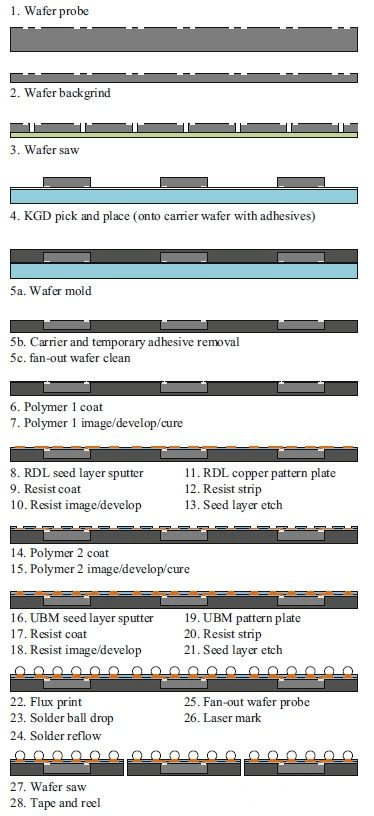
1. Yonga probu: Bu, yonganın sonraki işleme aşamalarına geçmeden önce gerekli teknik özellikleri karşıladığından emin olmak için yapılan ilk testtir.
2. Wafer arka taşlama: Paketin kalınlığını azaltmak için wafer'ın arka yüzü belirli bir kalınlığa kadar taşlanır.
3. Wafer kesme: Wafer, ayrı ayrı yongalara kesilir.
4. KGD (Known Good Die) alma ve yerleştirme: İyi yongalar alınır ve yapıştırıcı ile bir taşıyıcı wafer üzerine aktarılır.
5a. Wafer kalıplama: Taşıyıcı wafer'a yapıştırılmış yongaların bulunduğu wafer, fan-out yapısı oluşturmak üzere dielektrik bir malzeme ile kalıplanır.
5b. Taşıyıcı ve geçici yapıştırıcının çıkarılması: Taşıyıcı yonga, fan-out yongadan çıkarılır ve işlem sırasında kullanılan geçici yapıştırıcı da çıkarılır.
5c. Fan-out yonga plakasının temizlenmesi: Fan-out yonga plakası, kalan parçacıkları veya kirlilikleri gidermek için temizlenir.
6. Polimer 1 katmanı: Fan-out yonganın yüzeyine, dielektrik katman görevi görecek bir polimer katmanı uygulanır.
7. Polimer 1 görüntüleme/geliştirme/kürleme: Polimer tabakası, RDL yapısının istenen şekil ve boyutunu oluşturmak için fotolitografi kullanılarak desenlendirilir.
8. RDL tohum tabakası püskürtme: Püskürtme yöntemi kullanılarak polimer tabakasının üzerine ince bir bakır veya başka bir iletken malzeme tabakası yerleştirilir.
9. Direnç katmanı: Tohum katmanının üzerine bir direnç malzemesi katmanı uygulanır.
10. Direnç görüntüsü/geliştirme: Direnç tabakası, RDL yapısının istenen şekil ve boyutunu oluşturmak için fotolitografi kullanılarak desenlendirilir.
11. RDL bakır desen plakası: Elektrokaplama kullanılarak tohum tabakasının açıkta kalan alanlarının üzerine bakır biriktirilir ve istenen RDL deseni oluşturulur.
12. Direnç şeridi: Kalan direnç malzemesi kaldırılır ve sadece bakır RDL deseni kalır.
13. Tohum tabakasının aşındırılması: Tohum tabakasının gereksiz kısmı aşındırma yöntemi kullanılarak kaldırılır.
14. Polimer 2 kaplaması: Dielektrik tabaka görevi görmesi için RDL yapısının üzerine başka bir polimer tabakası uygulanır.
15. Polimer 2 görüntüleme/geliştirme/kürleme: Polimer tabakası, UBM yapısının istenen şekil ve boyutunu oluşturmak için fotolitografi kullanılarak desenlendirilir.
16. UBM tohum tabakası püskürtme: Püskürtme yöntemi kullanılarak polimer tabakanın üzerine ince bir bakır veya başka bir iletken malzeme tabakası yerleştirilir.
17. Direnç katmanı: Tohum katmanının üzerine bir direnç malzemesi katmanı uygulanır.
18. Direnç görüntüsü/geliştirme: Direnç tabakası, UBM yapısının istenen şekil ve boyutunu oluşturmak için fotolitografi kullanılarak desenlendirilir.
19. UBM desen plakası: Elektrokaplama kullanılarak tohum tabakasının açıkta kalan alanlarının üzerine bakır biriktirilir ve istenen UBM deseni oluşturulur.
20. Direnç şeridi: Kalan direnç malzemesi kaldırılır ve sadece bakır UBM deseni kalır.
21. Tohum tabakasının aşındırılması: Tohum tabakasının gereksiz kısmı aşındırma yöntemi kullanılarak kaldırılır.
22. Akı baskısı: UBM pedlerine bir akı malzemesi uygulanır.
23. Lehim topu yerleştirme: Lehim topları UBM pedlerinin üzerine yerleştirilir.
24. Lehim yeniden akışı: Lehim topları ısıtılır ve eriyerek UBM pedleri ile harici uçlar veya çıkıntılar arasında bağlantılar oluşturur.
25. Fan-out yonga probu: Paketlenmiş IC, gerekli spesifikasyonları karşıladığından emin olmak için test edilir.
26. Lazer markalama: Lazer kullanılarak IC'nin yüzeyine benzersiz bir tanımlayıcı veya barkod kazınır.
27. Wafer kesme: Fan-out wafer, ayrı paketler halinde kesilir.
28. Bant ve makara: Tek tek paketlenmiş IC'ler, kolay taşıma ve nakliye için bir makaraya monte edilir.
RDL'yi Gelişmiş Ambalajlama Alanında Uygulamak
Fan-in wafer-level package (FIWLP) ve fan-out wafer-level package (FOWLP) gibi gelişmiş paketleme yöntemlerinde RDL en kritik teknolojidir. Paketleme tesislerinin fan-out paketleme teknolojisi alanında yonga dökümhaneleriyle rekabet edebilmesini sağlayan şey, işte bu teknolojinin yaygınlaşmasıdır. RDL sayesinde, IOPad, FIWLP veya FOWLP formatında farklı türde yonga seviyesi paketlere dönüştürülebilir. FIWLP'de tüm çıkıntılar yonga üzerinde oluşturulur ve yonga ile ped arasındaki bağlantı esas olarak RDL'nin metal hattına bağlıdır. Paketleme işleminden sonra IC, yonga alanıyla neredeyse aynı boyuta gelir. FOWLP'de çıkıntılar yonga dışında oluşturulabilir ve paketleme sonrası IC, yonga alanından daha büyüktür (1,2 kat).
Özellikle 2.5D ileri düzey paketlemede, silikon substrat üzerindeki TSV'nin yanı sıra RDL de vazgeçilmezdir. 2.5D ileri düzey paketlemenin bir temsilcisi olan TSMC'nin InFO'sunu örnek olarak alırsak, InFO, taşıyıcı üzerinde bir veya daha fazla çıplak yonga kullanır ve bunlar daha sonra kalıplama bileşiğinin yeniden oluşturulmuş yongasına gömülür. Ardından, RDL ara bağlantı ve dielektrik katmanlar yonga üzerinde üretilir; bu, "önce yonga" süreç akışıdır. Tek yongalı InFO, yüksek bump sayısı sağlar ve RDL hatları yonga alanından dışa doğru uzanarak bir "fan-out" topolojisi oluşturur.

Hangi Dağıtım Katmanı Teknolojisini Kullanmalıyım?
Daha önce de belirttiğimiz gibi, iki tür RDL teknolojisi bulunmaktadır: Fan-in RDL ve Fan-out RDL. Peki, yüksek performanslı, kompakt ve uygun maliyetli elektronik cihazlar üretmek için hangisini seçmeliyiz? Bu, uygulama türü, yonga sayısı ve performans gereksinimleri gibi çeşitli faktörlere bağlıdır.
Uygulama
Fan-in RDL teknolojisi, sensörler, MEMS cihazları ve RF cihazları gibi uygulamalar için uygundur. Fan-out RDL teknolojisi ise grafik işlemcileri, sistem-on-chip (SoC) ve bellek cihazları gibi uygulamalar için uygundur.
Kalıp Sayısı
Fan-in RDL teknolojisi tek bir yonganın paketlenmesine uygunken, fan-out RDL teknolojisi ise birden fazla yonganın paketlenmesine uygundur.
Performans Gereksinimleri
Fan-in RDL teknolojisi, küçük ve ince paketlerin üretilmesine uygunken, fan-out RDL teknolojisi ise küçük boyutlu, yüksek performanslı paketlerin üretilmesine uygundur.
RDL ile Diğer IC Paketleme Teknolojilerinin Karşılaştırılması
Farklı üretim süreçleri nedeniyle, entegre devreler için çeşitli paketleme teknolojileri mevcuttur. Bu teknolojiler arasındaki farklar hakkında daha fazla bilgiyi aşağıdaki tabloda bulabilirsiniz:
| IC Packaging | Description | Advantages | Disadvantages | Applications |
|---|---|---|---|---|
| Wire Bonding | Connecting the IC to the PCB using wires | Low cost, flexible, proven technology | Limited performance, not suitable for high-frequency and high-power applications | Consumer electronics, automotive, medical devices |
| Flip-Chip Bonding | Chips are bonded face-down to the substrate, Connecting the IC to the PCB using solder bumps | High performance, high-density, low inductance | Expensive, requires precise alignment and underfilling | High-speed data communication, high-power applications, microprocessors |
| Through-Silicon Via (TSV) | Creating vertical interconnects through the silicon substrate | Shorter interconnect lengths, higher performance, smaller form factor | Complex and expensive manufacturing process, thermal and mechanical stress issues | Memory devices, image sensors, 3D ICs |
| Chip-scale package (CSP) | Replacing the lead frame with a substrate | Small form factor, high density, low cost | Limited I/O, susceptibility to mechanical and thermal stress | Mobile devices, wearable technology |
| Integrated Fan-out (InFO) | Integrated package of multiple chips and the soldering point of the pin is outside of the chip | High density, small form factor, low power consumption | Complex manufacturing process, high cost | Mobile devices, IoT, wearable technology |
| High Bandwidth Memory (HBM) | 3D stacking technology | High bandwidth, low power consumption | Expensive, limited scalability | High-performance computing, graphics processing |
| Chip on Wafer on Substrate (CoWoS) | Integrate chip and silicon wafer (substrate) together | High bandwidth, low power consumption, heterogeneous integration | Complex manufacturing process, high cost | High-performance computing, graphics processing |
| Redistribution Layer (RDL) | Creating a patterned metal layer on top of the dielectric layer | High density, fine pitch, low profile | Limited power handling capability, susceptibility to mechanical and thermal stress | Mobile devices, consumer electronics |
| Bump Technology | Depositing small metal bumps on the chip | Low cost, simple manufacturing process, flexible design | Limited performance, not suitable for high-speed and high-power applications | Consumer electronics, automotive, medical devices |
Yeniden Dağıtım Katmanı Teknoloji Çözümleri Sunan Şirketler
Yeniden dağıtım katmanı (RDL) teknolojisi çözümleri sunan birçok şirket bulunmaktadır; örneğin:
ASE Grubu
ASE Group, yarı iletken üretim hizmetleri sunan küresel bir tedarikçidir. ASE Group, bellek, mikroişlemciler ve grafik işlemciler gibi çeşitli uygulamalar için geniş bir yelpazede RDL teknolojisi çözümleri sunmaktadır.
Amkor Technology
Amkor Technology, yarı iletken paketleme ve test hizmetleri sunan küresel bir tedarikçidir. Amkor Technology, sensörler, MEMS cihazları ve güç cihazları gibi çeşitli uygulamalar için geniş bir yelpazede RDL teknolojisi çözümleri sunmaktadır.
Tayvan Yarıiletken Üretim Şirketi
TSMC, sistem-içinde-çip (SoC), bellek cihazları ve güç cihazları gibi çeşitli uygulamalar için geniş bir yelpazede RDL teknolojisi çözümleri sunan küresel bir yarı iletken üretim şirketidir.
Sonuç
Yeniden dağıtım katmanı (RDL) teknolojisi, entegre devrelerin (IC) paketlenme şeklini kökten değiştiren devrim niteliğinde bir paketleme çözümüdür. Bu teknoloji, tek bir çip üzerinde daha fazla bağlantı kurulmasını sağlayarak cihazın toplam kapladığı alanı azaltır. Bu nedenle akıllı telefonlar, giyilebilir cihazlar ve IoT cihazları gibi çeşitli uygulamalarda kullanılmaktadır. IC paketlerinde RDL teknolojisinin geleceği umut vericidir ve önümüzdeki yıllarda elektronik endüstrisi üzerinde önemli bir etkiye sahip olması beklenmektedir.






