Analisis Kegagalan IC
Sumber daya teknis komprehensif untuk metodologi, alat, dan studi kasus analisis kegagalan semikonduktor.
Apa itu Analisis Kegagalan IC?
Analisis Kegagalan Sirkuit Terpadu (IC) adalah proses sistematis yang digunakan untuk mengidentifikasi, mengisolasi, dan menentukan akar penyebab kegagalan perangkat semikonduktor. Disiplin teknik yang penting ini menggabungkan teknik pencitraan canggih, pengujian listrik, dan ilmu material untuk menyelesaikan masalah pada sirkuit terpadu di berbagai industri.
Analisis kegagalan yang efektif meningkatkan keandalan produk, mengurangi biaya produksi, mempercepat waktu pemasaran, dan memastikan kepatuhan terhadap standar industri. Analisis ini memainkan peran penting dalam pengendalian mutu, rekayasa keandalan, dan siklus peningkatan produk.
Tujuan Utama Analisis Kegagalan IC
- Mengidentifikasi akar penyebab kegagalan IC melalui investigasi sistematis.
- Tentukan apakah kegagalan berasal dari desain, manufaktur, atau aplikasi.
- Kembangkan tindakan korektif untuk mencegah kegagalan di masa mendatang.
- Memvalidasi keandalan dan kinerja sirkuit terpadu.
- Mendukung pelaporan kegagalan dan analisis data keandalan.
Panduan & Metodologi Teknis
Diagram Alur Diagnostik
Pendekatan sistematis dari gejala kegagalan hingga identifikasi akar penyebab.
Tidak Ada Jalur Kegagalan Daya/Output
- 1. Periksa kerusakan ESD menggunakan analisis SEM/EDS.
- 2. Verifikasi sambungan solder dengan inspeksi sinar-X 3D.
- 3. Pengujian kerusakan oksida gerbang menggunakan EMMI
- 4. Lakukan pengujian kontinuitas dengan OBIRCH
- 5. Analisis integritas kemasan dengan C-SAM
Jalur Kegagalan Gangguan Intermiten
- 1. Singkirkan kemungkinan retakan mikro pada BGA menggunakan C-SAM.
- 2. Periksa adanya tekanan termal dengan pencitraan inframerah.
- 3. Pengujian untuk latch-up terkait desain melalui simulasi rangkaian.
- 4. Verifikasi integritas jaringan distribusi daya.
Panduan Pengoperasian EMMI
Alur kerja langkah demi langkah untuk analisis Mikroskop Emisi
Persiapan Perangkat
Nyalakan perangkat dalam kondisi yang berpotensi menimbulkan kegagalan, pastikan pendinginan yang tepat.
Pengaturan Ruang Gelap
Posisikan perangkat di bawah mikroskop EMMI, pastikan penyelarasan yang tepat.
Konfigurasi Kamera
Atur waktu pencahayaan yang sesuai (biasanya 10-60 detik) dan sensitivitas.
Akuisisi Gambar
Ambil beberapa gambar dengan waktu pencahayaan yang berbeda untuk hasil optimal.
Analisis & Hamparan
Tumpang tindihkan titik-titik emisi dengan tata letak desain untuk mengidentifikasi struktur yang rusak.
Tips Pemecahan Masalah
Jika tidak ada titik panas yang muncul, verifikasi apakah chip berada dalam kondisi yang dapat mereproduksi kegagalan dan periksa apakah mekanisme kegagalan menghasilkan emisi foton (rangkaian terbuka biasanya tidak).
Kesalahan Umum dalam Analisis Kegagalan
Pengabaian Kerusakan ESD
Mengabaikan kerusakan akibat pelepasan muatan elektrostatik selama penanganan, terutama pada chip CMOS. Selalu verifikasi fungsi tali pergelangan tangan dan protokol pembumian.
Penurunan Daya yang Tidak Memadai
Resistor terbakar akibat pengoperasian pada beban daya 80% ke atas. Praktik yang direkomendasikan adalah penurunan daya sebesar 50% untuk memastikan keandalan dalam berbagai kondisi.
Reproduksi Kegagalan yang Tidak Akurat
Menganalisis perangkat dalam kondisi yang tidak secara akurat mereproduksi skenario kegagalan di lapangan, yang menyebabkan identifikasi akar penyebab yang salah.
Mengabaikan Masalah Pengemasan
Berfokus secara eksklusif pada masalah tingkat chip (die-level) sambil mengabaikan kegagalan terkait kemasan seperti delaminasi, korosi timbal, atau kelelahan sambungan solder.
Dokumentasi Tidak Memadai
Kegagalan mendokumentasikan setiap langkah analisis secara menyeluruh, sehingga menyulitkan untuk mereplikasi hasil atau melakukan analisis tren di berbagai kegagalan.
Masalah Kalibrasi Alat
Penggunaan peralatan yang tidak dikalibrasi dengan benar, menyebabkan pengukuran yang tidak akurat dan kesimpulan analisis kegagalan yang salah.
Studi Kasus Industri
Kegagalan Modul IGBT pada Kendaraan Listrik
Gejala
Hilangnya daya secara tiba-tiba selama pengisian daya, tanpa adanya kerusakan eksternal yang terlihat pada sistem penggerak kendaraan listrik.
Proses Analisis
- Pencitraan termal mengungkapkan titik panas pada modul IGBT selama siklus daya.
- Analisis SEM/EDS mengidentifikasi pertumbuhan IMC (Cu₆Sn₅) yang berlebihan pada sambungan solder.
- Penampang melintang menunjukkan pembentukan rongga Kirkendall pada antarmuka solder-substrat.
- Simulasi FEA mengaitkan kegagalan tersebut dengan profil peleburan solder yang tidak memadai.
Solusi & Hasil
Profil reflow disesuaikan untuk memastikan pembasahan yang tepat dan bantalan berlapis nikel ditambahkan untuk mengendalikan pertumbuhan IMC.
Hasil: Tingkat kegagalan di lapangan berkurang sebesar 0,58% per tahun, menghemat biaya garansi sebesar $2 juta.
Standar yang Relevan
Hasil Pencitraan Termal

Gambar SEM Pertumbuhan IMC
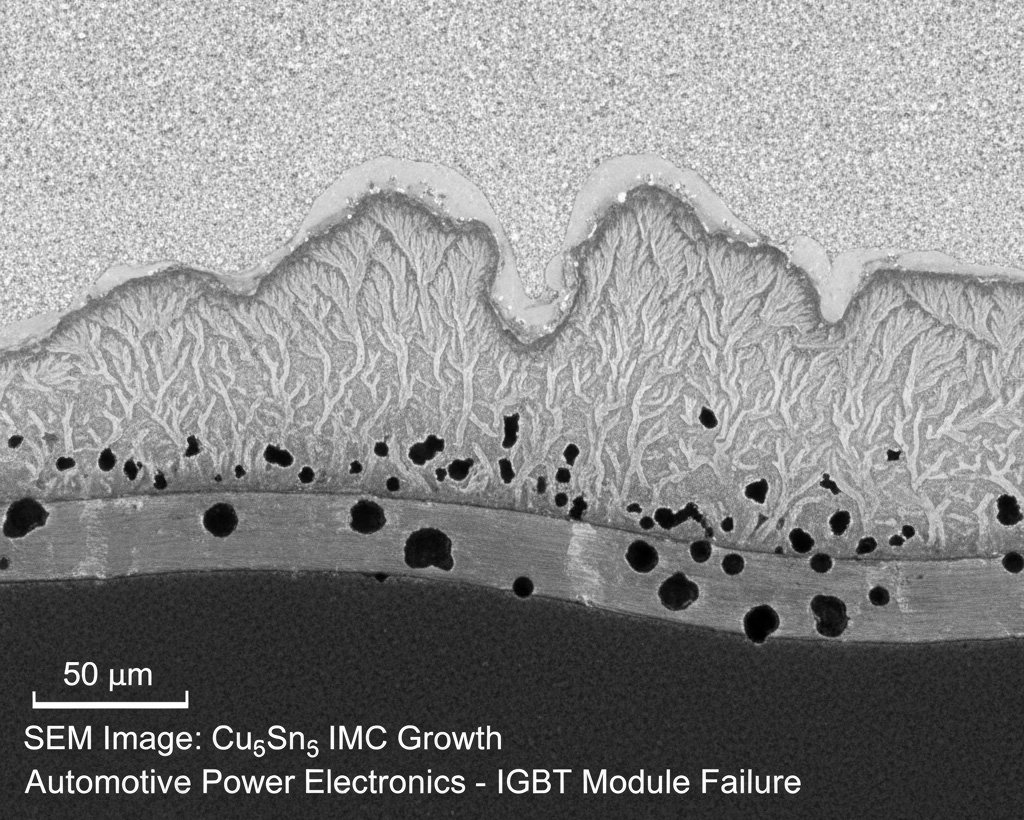
Kegagalan Penguat GaAs pada AAU 5G
Gejala
Kegagalan di lapangan pada Unit Antena Aktif (AAU) 5G dalam waktu 6 bulan setelah pemasangan, yang mengakibatkan penurunan kualitas sinyal.
Proses Analisis
- Inspeksi C-SAM mendeteksi retakan pada chip penguat daya GaAs.
- Audit pengemasan menemukan bekas ejector yang tidak normal di bagian belakang die.
- Analisis data keandalan menunjukkan distribusi kegagalan sesuai dengan mode kegagalan awal.
- Analisis elemen hingga mengkonfirmasi adanya tegangan mekanis selama proses pengikatan cetakan.
Solusi & Hasil
Modifikasi lapisan film biru untuk pengikatan die guna mengurangi tekanan mekanis dan penerapan inspeksi pasca-pengikatan 100% menggunakan inspeksi optik otomatis.
Hasil: Tingkat kegagalan berkurang sebesar 92%, memperpanjang waktu rata-rata antar kegagalan menjadi lebih dari 5 tahun.
Standar yang Relevan
Citra C-SAM dari Retakan pada Cetakan

Analisis Distribusi Kegagalan

Kegagalan BGA pada Smartphone
Gejala
Layar mati sesaat dan layar sentuh tidak responsif pada ponsel pintar kelas atas setelah 6-8 bulan penggunaan.
Proses Analisis
- Pengujian siklus termal (-40°C hingga 85°C) berhasil mereproduksi kegagalan tersebut dalam kondisi laboratorium.
- SAM (Scanning Acoustic Microscopy) mengungkapkan kelelahan sambungan solder.
- Penampang melintang mengkonfirmasi ketidaksesuaian CTE (Koefisien Ekspansi Termal)
- Analisis sinar-X 3D mengukur pembentukan rongga pada 18% sambungan BGA.
Solusi & Hasil
Menerapkan underfill dengan Tg (Suhu Transisi Kaca) yang lebih tinggi dan mengoptimalkan tata letak PCB untuk mengurangi gradien termal.
Hasil: Pengembalian produk ke lapangan berkurang sebesar 76%, tanpa ada kegagalan yang dilaporkan setelah 18 bulan penggunaan.
Standar yang Relevan
Pencitraan sinar-X 3D dari rongga BGA

Penampang Melintang Sambungan yang Rusak
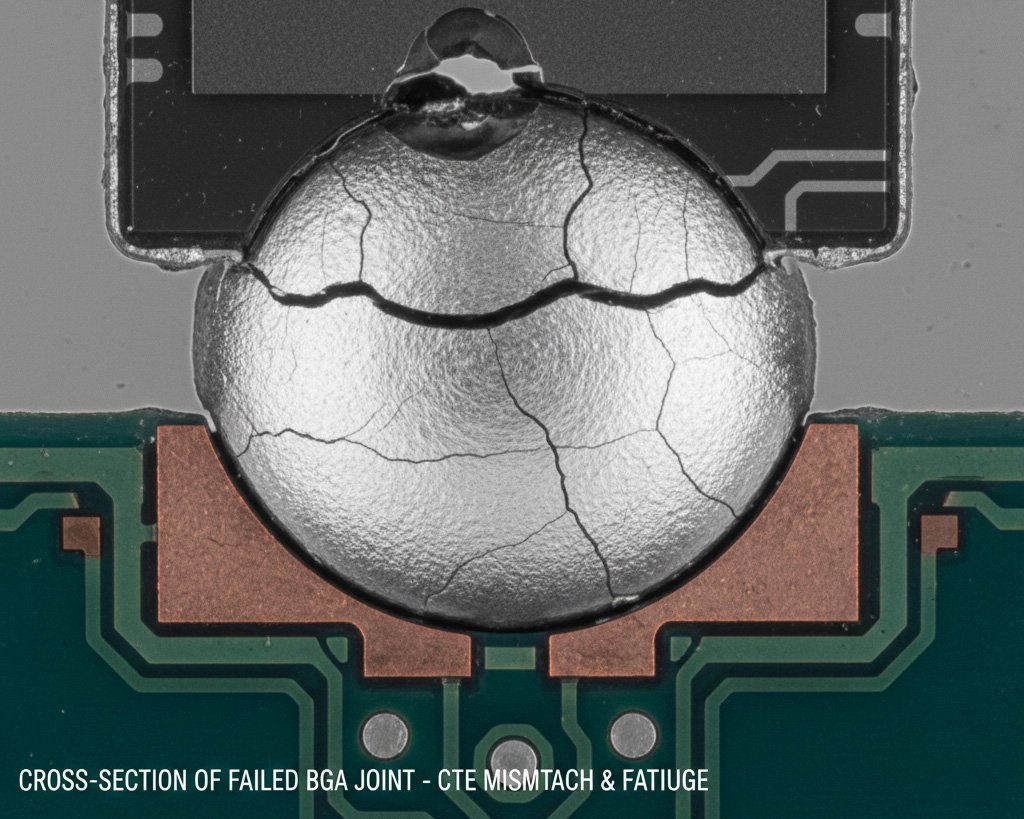
Kegagalan IC Kontrol Avionik
Gejala
Terjadi pengaturan ulang sistem secara acak pada modul kontrol avionik selama penerbangan di ketinggian, tanpa pola yang jelas.
Proses Analisis
- Pengujian lingkungan mereproduksi kegagalan dalam kondisi tekanan rendah (ketinggian tinggi).
- EMMI mendeteksi kebocoran gerbang yang terjadi sesekali pada IC manajemen daya.
- Pemodelan IC-CAP mengidentifikasi efek memori termal yang tidak dimodelkan pada GaN HEMT.
- Pengujian ESD menunjukkan perlindungan yang tidak memadai pada rangkaian input.
Solusi & Hasil
Model ASM-HEMT yang diperbarui kini mencakup efek memori termal dan sirkuit perlindungan ESD yang ditingkatkan.
Hasil: Penghapusan total pengaturan ulang saat penerbangan, dengan kualifikasi yang berhasil sesuai standar DO-254.
Standar yang Relevan
Gambar EMMI Kebocoran Gerbang

Analisis Efek Memori Termal

Peralatan dan Perlengkapan
| Alat | Kasus Penggunaan Inti | Batas Resolusi | Terbaik untuk | Keterbatasan |
|---|---|---|---|---|
| EMMI | Lokalisasi titik rawan (kebocoran, kerusakan) | ~1μm | CMOS/FinFET | Tidak ada sinyal untuk rangkaian terbuka |
| C-SAM | Deteksi delaminasi/rongga | 50nm | Flip-chip, BGA | Membutuhkan kopling cairan |
| CT X-ray 3D | Inspeksi TSV/cetakan bertumpuk | 100nm | IC 3D | Biaya tinggi untuk resolusi tinggi |
| Termografi Terkunci | Pemetaan termal di bawah °C | 0,1°C | IC Daya (IGBT) | Waktu pemindaian lambat |
| SEM/EDS | Karakterisasi material, pencitraan cacat | 1-5nm | Analisis fisik tingkat die | Membutuhkan lapisan konduktif untuk isolator. |
| FIB-SEM | Pemotongan melintang, penyuntingan sirkuit | 5nm | IC 3D, pengemasan canggih | Merusak, memakan waktu |
Panduan Memadukan Alat dan Teknik
Memilih alat yang tepat untuk skenario kegagalan tertentu memastikan analisis akar penyebab yang efisien dan akurat:
Analisis Kerusakan ESD
- Mulailah dengan EMMI untuk menemukan lokasi kebocoran.
- Lanjutkan dengan FIB-SEM untuk pencitraan kerusakan pada skala nano.
- Gunakan EDS untuk memeriksa kontaminasi di lokasi kegagalan.
- Verifikasi dengan pengujian listrik (analisis kurva IV)
Retak IC TSV 3D
- Gunakan CT X-ray 3D untuk inspeksi non-destruktif.
- Lakukan validasi dengan pemotongan penampang FIB di lokasi-lokasi kritis.
- Lakukan pencitraan SEM untuk mengkarakterisasi morfologi retakan.
- Terapkan analisis elemen hingga untuk menentukan asal muasal tegangan.
Kegagalan yang Berkaitan dengan Suhu
- Mulailah dengan termografi penguncian untuk pemetaan termal.
- Gunakan C-SAM untuk memeriksa delaminasi akibat tekanan termal.
- Lakukan pemotongan melintang untuk memeriksa integritas sambungan solder.
- Validasi dengan uji siklus termal.
Kegagalan yang Terjadi Sesekali
- Gunakan ruang uji lingkungan terkontrol untuk mereproduksi kondisi kegagalan.
- Terapkan OBIRCH untuk analisis jalur arus dinamis.
- Gunakan pencitraan termal selama pengujian stres.
- Lakukan verifikasi dengan pengujian getaran jika dicurigai adanya tekanan mekanis.
Alat & Teknologi yang Sedang Berkembang
EMMI yang Ditingkatkan dengan AI
Algoritma pembelajaran mesin yang secara otomatis membedakan pola emisi foton normal dan abnormal, mengurangi waktu analisis hingga 70%.
Pelabelan Titik Kuantum
Penanda fluoresen skala nano yang menyoroti wilayah cacat pada semikonduktor, memungkinkan deteksi dini lokasi kegagalan potensial.
Platform Analisis Faktor Prediktif
Sistem terintegrasi yang menggabungkan data manufaktur, laporan kegagalan di lapangan, dan AI untuk memprediksi mekanisme kegagalan potensial sebelum terjadi.
Standar & Kepatuhan
Standar JEDEC
JESD22-A121: Pengujian ESD
Menentukan prosedur untuk pengujian pelepasan muatan elektrostatik pada model tubuh manusia (HBM), model mesin (MM), dan model perangkat bermuatan (CDM).
JESD47: Metode Uji Stres untuk Sirkuit Terpadu
Standar komprehensif yang mencakup berbagai uji stres termasuk siklus suhu, suhu tegangan, elektromigrasi, dan kerusakan dielektrik bergantung waktu.
JESD22-A104: Siklus Suhu
Standar khusus untuk pengujian siklus suhu guna mengevaluasi keandalan komponen dalam kondisi tekanan termal.
Standar Khusus Industri
AEC-Q100: IC Otomotif
Spesifikasi kualifikasi untuk sirkuit terpadu yang digunakan dalam aplikasi otomotif, dengan persyaratan keandalan yang ketat.
DO-254: Avionik Dirgantara
Panduan jaminan desain untuk perangkat keras elektronik di pesawat terbang, termasuk sirkuit terpadu yang digunakan dalam sistem penting penerbangan.
Telcordia GR-468: Telekomunikasi
Persyaratan untuk jaminan keandalan perangkat semikonduktor yang digunakan dalam peralatan telekomunikasi.
Analisis Data Keandalan
Analisis kegagalan yang efektif memerlukan analisis statistik data keandalan untuk memahami distribusi kegagalan dan memprediksi umur produk:
Distribusi Kegagalan
- Distribusi log-normal: Umum terjadi pada kegagalan semikonduktor
- Distribusi Weibull: Berguna untuk menganalisis kegagalan awal, acak, dan akibat keausan.
- Distribusi eksponensial: Sesuai untuk wilayah dengan tingkat kegagalan konstan.
Metrik Utama
- MTBF (Waktu Rata-Rata Antar Kegagalan)
- Tingkat Kegagalan (λ) - biasanya dinyatakan dalam FIT (Failures In Time: 1 FIT = 1 kegagalan per 10^9 jam perangkat)
- Faktor konversi Pengujian Umur Pakai yang Dipercepat (ALT)
Contoh Analisis Tingkat Kegagalan
Tren Masa Depan dalam Analisis Kegagalan IC
Node Proses Lanjutan (2nm/1nm)
Tantangan analisis pada skala atom dengan efek kuantum yang menjadi faktor signifikan dalam mekanisme kegagalan.
Tantangan Utama
- • Efek penerowongan kuantum
- • Kerusakan pada sistem penyaluran daya di bagian belakang
- • Deteksi kontaminasi tingkat atom
Solusi yang Sedang Berkembang
- • TEM kriogenik untuk inspeksi tingkat atom
- • Teknik nanoprobing yang digerakkan oleh AI
- • Tomografi probe atom tingkat lanjut
Integrasi IC 3D & Integrasi Heterogen
Modus kegagalan yang kompleks pada arsitektur die bertumpuk memerlukan teknik analisis non-destruktif baru.
Tantangan Utama
- • Keretakan TSV (Through-Silicon Via)
- • Delaminasi underfill pada die bertumpuk
- • Masalah manajemen termal
Solusi yang Sedang Berkembang
- • CT X-ray 3D canggih dengan resolusi lebih tinggi
- • Teknik pencitraan multimodal
- • Desain untuk kemudahan pengujian pada IC 3D
AI & Pembelajaran Mesin
Deteksi dan klasifikasi kegagalan otomatis untuk menangani kompleksitas IC yang semakin meningkat.
Aplikasi Utama
- • Klasifikasi cacat otomatis pada gambar SEM
- • Analisis kegagalan prediktif dari data manufaktur
- • Deteksi anomali pada data uji wafer
Manfaat
- • Pengurangan waktu analisis sebesar 50-70%
- • Peningkatan akurasi dalam identifikasi akar penyebab
- • Prediksi kegagalan dini sebelum penerapan di lapangan
