Pengujian IC bertujuan untuk mendeteksi apakah chip tersebut memiliki cacat desain atau cacat fisik yang disebabkan oleh proses manufaktur. Proses ini dapat dilakukan dengan menggunakan berbagai metode pengujian.
Pengemasan IC adalah proses memasukkan sirkuit terpadu (IC) ke dalam kemasan pelindung. Proses ini melindungi IC dari kerusakan dan memastikan bahwa IC berfungsi dengan benar. Proses ini juga memungkinkan koneksi IC ke perangkat dan sirkuit lain.
Bagaimana cara menguji IC menggunakan alat penguji IC?
kit pengujian IC
Ada beberapa jenis perangkat uji IC yang tersedia di pasaran, masing-masing dirancang untuk tujuan tertentu. Misalnya, beberapa perangkat uji IC dirancang untuk pengujian umum. Sementara yang lain dirancang untuk aplikasi khusus seperti IC otomotif atau IC daya.
Sebagian besar kit pengujian IC dilengkapi dengan berbagai aksesori dasar, seperti multimeter, probe, penguji IC digital, dan kabel pengujian. Beberapa kit mungkin juga dilengkapi dengan peralatan yang lebih khusus, seperti osiloskop atau penganalisis logika.
Metode Pengujian
Ada beberapa cara berbeda untuk menguji IC, tetapi metode yang paling umum disebut pengujian dalam sirkuit (ICT). Jenis pengujian ini dilakukan dengan menghubungkan alat penguji ke perangkat yang diuji (DUT). Kemudian, kita menjalankan serangkaian pengujian untuk memeriksa fungsi-fungsi dasarnya.
ICT dapat digunakan untuk menguji IC digital maupun analog. Untuk IC digital, penguji akan mengirimkan serangkaian sinyal input ke DUT. Kemudian memeriksa output untuk melihat apakah sesuai dengan hasil yang diharapkan. IC analog biasanya diuji menggunakan teknik yang disebut pengujian dinamis. Selama proses ini, penguji menerapkan serangkaian sinyal ke DUT dan kemudian mengukur responsnya.
Ada berbagai perusahaan yang memproduksi penguji ICT; Anda perlu memilih yang kompatibel dengan IC Anda. Setelah memiliki penguji, Anda perlu membuat fixture pengujian yang terhubung ke DUT. Fixture pengujian ini dapat memberikan sinyal yang diperlukan ke DUT dan juga mengukur responsnya.
Setelah memiliki keduanya, selanjutnya Anda perlu menulis program pengujian untuk memeriksa hasilnya. Ini bisa menjadi proses yang memakan waktu, tetapi penting untuk memastikan bahwa IC Anda berfungsi dengan baik.
Jenis Pengujian
Uji kontinuitas IC
Uji kontinuitas IC itu sederhana, dan dapat Anda gunakan untuk mengetahui apakah IC berfungsi dengan baik atau tidak.
Uji ini dilakukan dengan menghubungkan multimeter ke IC dan mengukur resistansi antara berbagai pin.
Jika IC berfungsi dengan baik, resistansi seharusnya rendah (biasanya kurang dari 10 ohm). Sebaliknya, resistansi akan tinggi (biasanya lebih dari 10 ohm).
tes tingkat
Pengujian tingkat IC adalah jenis pengujian kelistrikan untuk menentukan fungsi dan kinerja sirkuit terpadu (IC).
Pengujian ini biasanya dilakukan pada IC yang telah terpasang pada papan sirkuit.
Tujuan pengujian ini adalah untuk memverifikasi bahwa IC berfungsi dengan baik dan memenuhi spesifikasi untuk penggunaan yang dimaksudkan.
Terdapat berbagai metode pengujian yang berbeda untuk pengujian tingkat IC, termasuk pengujian logika, pengujian fungsional, dan pengujian parametrik.
Jalur Pengembangan Kemasan IC
Pengemasan secara garis besar telah melalui proses perkembangan sebagai berikut:
1. Dari segi struktur:
TO->DIP->PLCC->QFP->BGA->CSP->WLP dan SiP, dll.
2. Bahan:
Logam, keramik -> keramik, plastik -> plastik;
3. Bentuk pin:
Kabel panjang sejajar -> kabel pendek atau pemasangan tanpa kabel -> bola bump
4. Metode perakitan:
Pemasangan Melalui Lubang -> Pemasangan Permukaan -> Pemasangan Langsung
5. Faktor pendorong perbaikan berkelanjutan dalam pengemasan:
Ukuran lebih kecil, jenis chip lebih banyak, I/O lebih banyak
6. Tantangan:
Prosesnya menjadi semakin kompleks, dan perlu mempertimbangkan pembuangan panas serta konduktivitas listrik sambil mengurangi volume.

Fitur dan keunggulan kompetitif utama
1. Keunggulan di bidang manufaktur
Kapasitas produksi sepenuhnya bergantung pada pengadaan peralatan (investasi modal), dan sama seperti industri manufaktur konvensional, proses ini juga akan melewati tahap peningkatan kapasitas dan optimalisasi proses. Seiring dengan berkembangnya skala usaha, akan terakumulasi pula pengalaman serta keunggulan teknologi terdepan.
2. Skala pengemasan dan pengujian menentukan komposisi pelanggan
Produsen desain berskala besar hanya akan bekerja sama dengan produsen penguji yang memiliki skala tertentu. Jika skalanya tidak bertambah, akan sulit untuk menangani pesanan dalam jumlah besar, dan sulit pula untuk mengoptimalkan struktur pelanggan. Oleh karena itu, perusahaan yang memiliki teknologi terdepan dan skala besar akan memasuki lingkaran positif: teknologi terdepan → pengembangan pelanggan → perluasan pembiayaan → peningkatan kapasitas produksi → optimalisasi proses → teknologi terdepan, dan secara bertahap akan memperlebar jarak dengan para pesaing.
3. Daya Saing Inti
Kedua karakteristik industri di atas menentukan daya saing inti perusahaan pengujian profesional IC:
Kemampuan R&D: berfokus pada pengembangan prosedur pengujian dan solusi pengujian.
Tingkat Komersialisasi: kemampuan pengembangan program pengujian dan optimasi proses berasal dari pengalaman pengujian berbagai jenis chip yang dibawa oleh sejumlah besar pelanggan.
Proses Pengujian yang Sempurna: Melalui integrasi yang erat antara desain hulu dan pemrosesan wafer, proses pengujian dan prosedurnya terus dioptimalkan.
Kemampuan Operasional Modal: Tahap perkembangan domestik saat ini menentukan bahwa skala merupakan prasyarat pengembangan. Oleh karena itu, kemampuan pembiayaan yang sesuai dengan kekuatan teknologi dan pasar merupakan dukungan bagi perkembangan dan pertumbuhan perusahaan.
pasar kemasan dan pengujian IC
1. Skala pengemasan dan pengujian IC
1.1 Transaksi Pengemasan dan Pengujian IC Global (2011–2020)
Pada tahun 2019, industri semikonduktor secara keseluruhan mengalami perlambatan dan mencatat pertumbuhan negatif, begitu pula dengan pasar pengemasan dan pengujian chip. Namun, pasar tersebut kemudian pulih berkat meningkatnya permintaan akan teknologi 5G, kecerdasan buatan (AI), Internet of Things (IoT), komputasi awan, dan big data. Para ahli memperkirakan bahwa pasar pengemasan dan pengujian chip secara keseluruhan pada tahun 2024 dapat mencapai $75 miliar.

1.2 Produksi Global Wafer IC (2012–2022)
Seiring dengan pesatnya perkembangan bidang-bidang baru seperti 5G, IoT, dan AI, ukuran chip yang dibutuhkan semakin kecil. Di saat yang sama, jenis chip pun semakin beragam. Jumlah pin I/O juga meningkat secara signifikan, dan permintaan akan kemasan canggih pun semakin meningkat.

1.3 Skala Pengemasan dan Pengujian iC di Tiongkok (2014–2018)
Pada tahun 2018, kapasitas pengemasan dan pengujian IC di Tiongkok daratan mencapai 217,44 miliar unit, dan nilai pasar industri pengemasan dan pengujian IC mencapai 219,39 miliar yuan, meningkat 16,1% dibandingkan tahun sebelumnya.

2. Pertumbuhan skala pengemasan canggih
2.1 Proporsi Kemasan IC Tingkat Lanjut dalam total
Menurut data statistik Yole, meskipun industri semikonduktor secara keseluruhan mengalami perlambatan dan pertumbuhan negatif pada tahun 2019, ukuran pasar kemasan canggih diperkirakan akan tetap menunjukkan tren pertumbuhan. Pada tahun 2018, ukuran pasar kemasan canggih mencapai US$27,6 miliar.
Tumbuh dengan tingkat pertumbuhan tahunan gabungan (CAGR) sebesar 8%, mencapai sekitar $44 miliar pada tahun 2024. Pasar pengemasan tradisional akan tumbuh dengan CAGR sebesar 2,4%, sementara CAGR industri pengemasan IC secara keseluruhan akan mencapai 5%.

2.2 Tren perkiraan pendapatan kemasan canggih (2018–2024)
Dalam industri pengemasan canggih, teknologi flip-chip memegang pangsa pasar terbesar. Pada tahun 2018, pendapatan dari pengemasan dan pengujian flip-chip mencapai sekitar 81% dari pasar pengemasan canggih. Pada tahun 2024, seiring dengan perkembangan pesat teknologi lain, angkanya akan turun menjadi 72%.
Dari tahun 2018 hingga 2024, TVS, ED, dan fan-out adalah teknologi dengan pertumbuhan tercepat. Tingkat pertumbuhan pendapatan pengemasan 2.5D/3D (TSV), ED, dan pengemasan fan-out (Fan-out) diperkirakan masing-masing sebesar 26%, 49%, dan 26%.
CAGR Fan-in WLP 2018-2024 relatif rendah, hanya 6,5%, dan ukuran pasar embedded die pada tahun 2018 kurang dari US$25 juta.
Namun, CAGR akan mencapai 49% dalam lima tahun ke depan, dan faktor pendorong utamanya akan berasal dari permintaan fasilitas komunikasi, elektronik otomotif, dan pasar seluler.
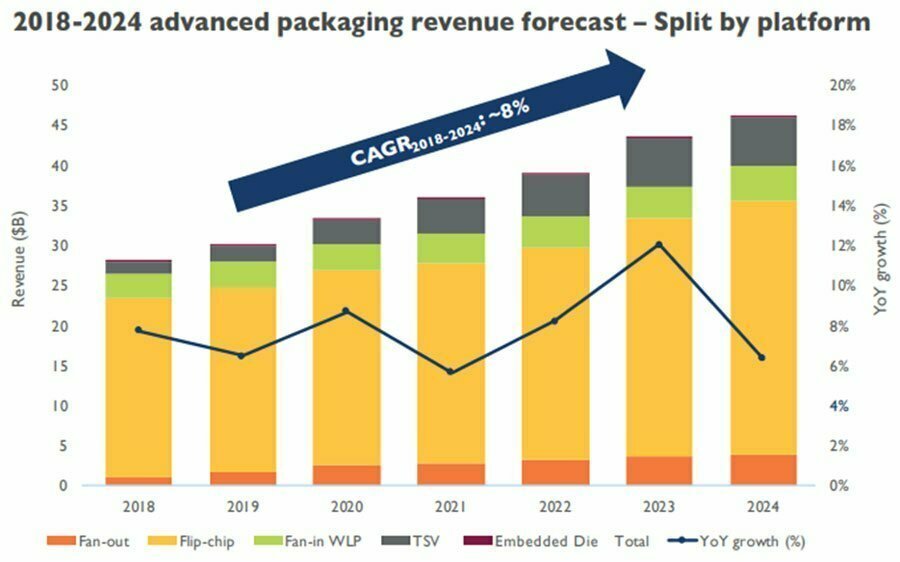
2.3 Aplikasi kemasan tingkat lanjut
Berdasarkan bidang aplikasi, pada tahun 2018, aplikasi seluler dan konsumen menyumbang 84% dari total pasar kemasan canggih. Dari tahun 2019 hingga 2024, CAGR segmen pasar aplikasi ini mencapai 5%, dan pada tahun 2024, segmen ini menyumbang 72% dari total pasar kemasan canggih.
Segmen telekomunikasi dan infrastruktur merupakan segmen dengan pertumbuhan tercepat di pasar kemasan canggih (sekitar 28%), dan pangsa pasarnya akan tumbuh dari 6% pada tahun 2018 menjadi 15% pada tahun 2024.
Pada saat yang sama, pangsa pasar segmen otomotif dan transportasi tumbuh dari 9% pada tahun 2018 menjadi 11% pada tahun 2024.

Pada tahun 2018, perusahaan pengemasan dan pengujian chip profesional menguasai 61% pasar pengemasan dan pengujian tingkat lanjut, sementara perusahaan tipe IDM menguasai 23% dan produsen tipe foundry menguasai 16%.

Lanskap Persaingan
1. 10 Perusahaan Terbesar di Dunia (2018–2019)
Pasar pengemasan dan pengujian chip relatif terkonsentrasi. Sepuluh produsen teratas menguasai sekitar 80% pasar. Produsen dari Tiongkok daratan dan Taiwan mendominasi pasar ini. Selama bertahun-tahun, industri pengemasan dan pengujian Taiwan telah menguasai hampir setengah dari pendapatan operasional global, sehingga mengukuhkan posisinya di antara sepuluh besar.
Terlepas dari pendapatan pengemasan dan pengujian chip dari IDM (seperti Intel dan Samsung), ASE dan Amkor tetap berada di peringkat dua teratas dalam bidang pengemasan dan pengujian chip profesional.

2. Peluang dan Tantangan
Perubahan dalam rantai pasokan semikonduktor, pergeseran model bisnis, dan ketidakpastian dalam hubungan perdagangan AS-Tiongkok telah membuka peluang bagi sebagian produsen sekaligus menimbulkan ancaman bagi produsen lainnya.
2.1 Perluasan rantai industri
Dalam lingkungan bisnis yang terus berubah ini, rantai pasokan semikonduktor mengalami transformasi di setiap tingkatan. Beberapa pemasok telah berhasil mengembangkan model bisnis baru.
Hal ini berdampak signifikan pada rantai manufaktur IC, sementara produsen lain gagal memanfaatkan momentum tersebut. Setiap vendor memiliki faktor pendorong yang berbeda-beda yang mendorong mereka untuk berekspansi ke bisnis baru.
Misalnya, perusahaan perangkat lunak seperti Google, Microsoft, Facebook, dan Alibaba merancang prosesor mereka sendiri untuk mendapatkan integrasi/kustomisasi tingkat sistem dan kendali rantai pasokan pada tingkat perakitan.
Perubahan terbesar terlihat pada pabrik-pabrik yang mulai merambah ke bisnis pengemasan canggih. Meskipun mereka relatif merupakan "pendatang baru", dampaknya sangat besar.
2.2 Inovasi teknologi pengemasan
TSMC memimpin inovasi dalam bidang fan-out packaging dan platform pengemasan canggih 3D. Mereka menawarkan beragam produk seperti InFO (dan variannya), CoWoS, WoW, 3D SoIC, dan lainnya.
Pengemasan canggih telah menjadi bisnis yang matang bagi TSMC. Mereka memperkirakan bisnis ini akan menghasilkan pendapatan sebesar $3 miliar pada tahun 2019, yang akan menempatkannya di peringkat keempat dalam daftar OSAT.
UMC adalah pemasok utama interposer silikon untuk pengemasan 2.5D. Mereka baru-baru ini bermitra dengan Xperi untuk mengoptimalkan dan mengkomersialkan teknologi ZiBond dan DBI untuk berbagai perangkat semikonduktor.
Sementara itu, Wuhan Xinxin (XMC) menyediakan kemasan 3D IC TSV untuk sensor gambar dan aplikasi berkinerja tinggi. Secara kolektif, para pemain ini telah memainkan peran utama dalam memindahkan pengemasan dari substrat ke platform silikon.
2.3 Pengemasan tingkat sistem cenderung populer
Saat ini, para pelaku industri rantai pasokan kemasan SiP cenderung memperluas jangkauan bisnis mereka ke hulu dan hilir. Dalam rantai pasokan kemasan SiP tradisional, perusahaan-perusahaan terkemuka di bidang kemasan dan pengujian IC antara lain Changdian Technology dan ASE, yang terutama menyediakan produk kemasan dan pengujian standar pada tingkat fungsional. Perusahaan terkemuka di bidang kemasan tingkat sistem adalah USI, yang terutama bergerak di bidang kemasan sistem pada tingkat modul. Kedua perusahaan ini berada dalam hubungan hulu-hilir, dan proses serta peralatan yang digunakan pun berbeda.
2.4 Chip Tertanam
Di sisi lain, produsen substrat IC dan PCB seperti Samsung Electro-Mechanics (SEMCO), Unimicron, AT&S, dan Shinko Electric (Shinko) memanfaatkan chip tertanam (dan komponen pasif) dalam kemasan fan-out tingkat panel serta substrat organik untuk memasuki segmen kemasan canggih dan mulai menggerogoti pangsa pasar OSAT (terutama dalam bisnis yang berkaitan dengan kemasan canggih).
3. Pangsa Pasar Wafer Kemasan Canggih
Dibandingkan dengan tingkat konsentrasi pasar pengemasan dan pengujian secara keseluruhan, tingkat konsentrasi pasar pengemasan dan pengujian tingkat lanjut relatif rendah. Pada tahun 2017, delapan produsen teratas menguasai 67% pangsa pasar pengemasan tingkat lanjut.

Para penyedia layanan di pasar kemasan canggih memiliki bidang keahlian yang berbeda-beda:
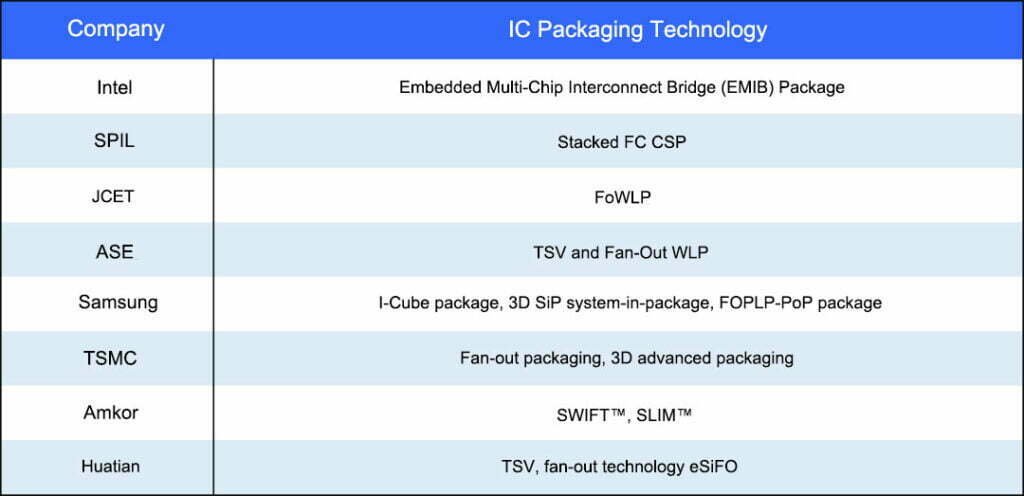
Kondisi Industri Pengemasan IC di Tiongkok
Industri pengemasan IC di Tiongkok telah dimulai sejak dini dan berkembang pesat, dengan fokus utama pada produk pengemasan tradisional. Dalam beberapa tahun terakhir, produsen dalam negeri telah melalui proses merger dan akuisisi. Saat ini, platform teknologi Tiongkok pada dasarnya telah sejajar dengan produsen luar negeri. Selain itu, teknologi pengemasan canggih seperti BGA, TVS, WLCSP, dan SiP telah diproduksi secara massal.
Namun, masih terdapat kesenjangan tertentu antara total pendapatan sektor pengemasan canggih di Taiwan dan Amerika Serikat. Menurut data statistik TrendForce, pendapatan sektor pengemasan canggih di Tiongkok pada tahun 2018 mencapai sekitar 52,6 miliar yuan. Angka tersebut menyumbang 25% dari total pendapatan sektor pengemasan dan pengujian domestik, lebih rendah dibandingkan rasio global sebesar 41%. Oleh karena itu, masih terdapat ruang yang luas untuk pertumbuhan di masa depan.
Pasar Kemasan IC Tingkat Lanjut di Tiongkok
Selain itu, terdapat juga kesenjangan yang besar antara perusahaan pengemasan di daratan Tiongkok dan produsen terkemuka internasional. Terutama, kesenjangan tersebut sangat terlihat dalam teknologi pengemasan sirkuit terpadu kepadatan tinggi, seperti teknologi pengemasan chip HPC. Teknologi penumpukan 3D multi-chip SoC yang diusulkan oleh TSMC. Teknologi ini mengadopsi struktur pengikatan tanpa bump, yang dapat secara signifikan meningkatkan kecepatan komputasi keseluruhan CPU/GPU dan memori. Intel juga mengusulkan konsep pengemasan 3D serupa, dengan menumpuk memori pada chip CPU dan GPU.

Nilai produksi pasar kemasan canggih Tiongkok secara global memang relatif rendah, namun pertumbuhannya pesat dan pangsa pasarnya terus meluas. Data dari Yole menunjukkan bahwa pada tahun 2017, nilai produksi kemasan canggih Tiongkok mencapai US$2,9 miliar, atau 11,9% dari total global, dan diperkirakan akan mencapai US$4,6 miliar pada tahun 2020, atau 14,8% dari total global. Menurut data tersebut, perusahaan kemasan dan pengujian Tiongkok mempercepat peningkatan kapasitas produksi di bidang kemasan canggih pada tahun 2018, dengan tingkat pertumbuhan sebesar 16%, dua kali lipat dari tingkat pertumbuhan global.
faktor pendorong pasar
Ada dua jalur pengembangan dalam bidang pengemasan canggih:
Yang pertama adalah mengurangi ukuran agar mendekati ukuran chip. Salah satu indikator pentingnya adalah rasio luas chip terhadap luas kemasan. Semakin mendekati 1 rasio ini, semakin baik, termasuk WLCSP, FC, Bumping, Fanout, dan sebagainya.
Yang kedua adalah pengembangan fungsional, yang menekankan integrasi heterogen dan menyediakan multifungsi dalam miniaturisasi sistem, termasuk TSV, SIP, dan sebagainya.
1. Teknologi SIP
Proses manufaktur semikonduktor global semakin mendekati batas fisik dioda. Proses paling canggih saat ini adalah 7nm. Karena investasi yang sangat besar, biaya untuk meningkatkan kinerja chip lebih lanjut dari sisi manufaktur menjadi semakin mahal. Mulai dari tahap pengemasan chip, teknologi System-in-Package (SIP) menggabungkan chip dengan fungsi berbeda, seperti chip logika dan memori.
Komponen pasif IPD, RF, sensor, dan chip lainnya dikemas dalam satu modul, yang dapat mengurangi ukuran chip, meningkatkan kinerja chip, dan mengurangi konsumsi daya. Internet of Things (IoT) adalah skenario aplikasi penting yang mendorong pengembangan teknologi pengemasan SIP, dan perangkat yang dapat dikenakan adalah bidang dengan potensi aplikasi yang besar untuk teknologi sistem-dalam-kemasan di masa depan. Sensor pengenalan sidik jari, sensor pengenalan wajah 3D, jaringan nirkabel WiFi, dan modul fungsional lainnya di Apple Watch dikemas bersama, yang merupakan penerapan teknologi modul sistem-dalam-kemasan (SiP) dari ASE.
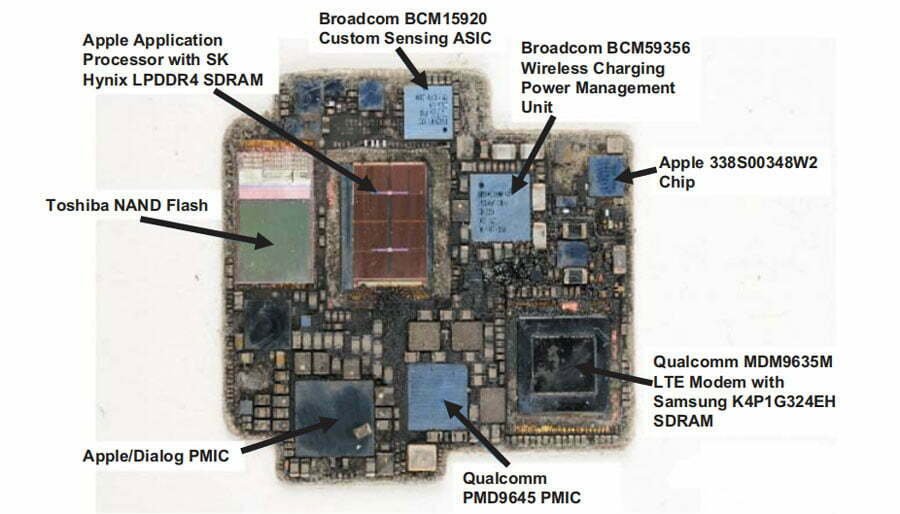
Teknologi SIP berhasil mengintegrasikan sirkuit terpadu, perangkat diskrit, perangkat optik, memori, kapasitor keramik multilayer, dan resistor chip ke dalam substrat yang tipis dan pendek tanpa menyebabkan interferensi antar komponen. Kami meyakini bahwa Apple setidaknya unggul satu hingga dua tahun di depan para pesaingnya dalam penerapan sistem pengemasan. Berdasarkan persyaratan aplikasi yang berbeda dan kompleksitas produk, jenis sistem-in-package (SiP) dapat dibagi menjadi modul 2D yang berisi beberapa komponen aktif dan pasif serta modul 3D yang lebih kompleks. Misalnya, PiP (Package-in-Package) dalam sistem, PoP (Package-on-Package), dan teknologi pengemasan 2.5D/3D pada sistem.
2. Teknologi TSV
Sebagai salah satu perwakilan dari teknologi pengemasan 3D, teknologi TSV akan memiliki penerapan yang lebih luas di bidang pengemasan memori flash 3DNANDFLASH dan pengemasan memori DRAM di masa depan. Memori telah menjadi subsektor dengan potensi pertumbuhan terbesar di bidang semikonduktor dalam negeri. Dua proyek memori utama, yaitu Yangtze Memory (NAND FLASH) dan Hefei Changxin (DRAM), akan diproduksi secara massal pada tahun 2020, yang tentunya akan menjadi peluang pertumbuhan yang sangat besar bagi produsen dalam negeri yang memiliki teknologi pengemasan canggih.
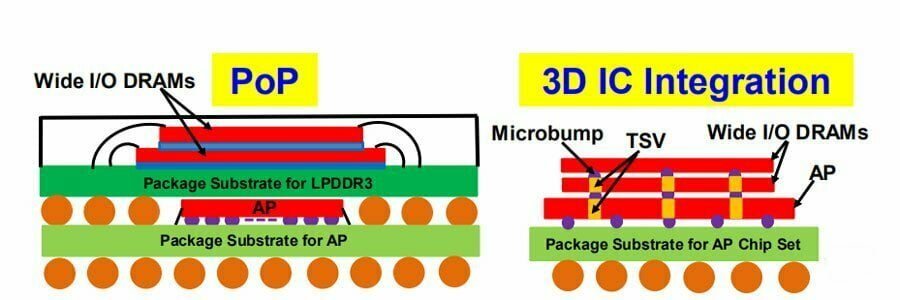
3. Fan-out
Memasuki era 5G, untuk mendapatkan kecepatan transmisi data dan kapasitas bandwidth yang lebih tinggi, gelombang elektromagnetik dengan frekuensi lebih tinggi harus digunakan sebagai media transmisi, sehingga panjang gelombangnya menjadi lebih pendek dan memasuki rentang gelombang milimeter. Dua frekuensi utama di era 5G, yaitu pita frekuensi Sub-6GHz dan pita frekuensi gelombang milimeter 28GHz, akibat peningkatan frekuensi, penurunan panjang gelombang menyebabkan antena menjadi lebih pendek, sehingga antena diharapkan dapat diintegrasikan ke dalam chip pada era chip 5G untuk menyederhanakan desain dan mengurangi biaya.
Ada dua teknologi pengemasan yang mungkin untuk chip 5G generasi berikutnya: AiP (Antenna in Package) dengan substrat dan pengemasan fan-out tanpa papan pembawa. Karena skema pengemasan fan-out yang kedua tidak memerlukan substrat, hal ini dapat lebih mengurangi biaya dan memperkecil ukuran chip berdasarkan integrasi beberapa chip, sehingga teknologi pengemasan fan-out mungkin menjadi teknologi utama dalam pengemasan chip 5G.
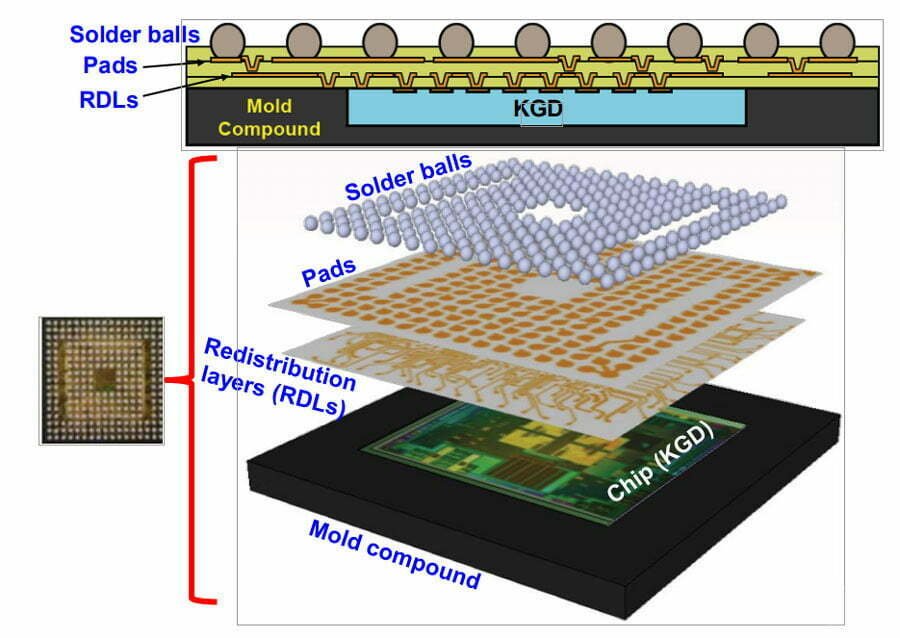
Setiap modul elektronik di dalam mobil menggunakan teknologi pengemasan yang berbeda-beda, dan pengemasan chip radar gelombang milimeter dalam sistem elektronik otomotif juga akan banyak menggunakan teknologi pengemasan Fan-out.
Pabrik pengemasan dan pengujian dalam negeri, Changdian Technology, memperoleh teknologi pengemasan eWLB setelah mengakuisisi Xingke Jinpeng, sehingga menjadi salah satu produsen pengemasan dan pengujian awal di bidang radar gelombang milimeter. Huatian Technology diperkirakan akan berupaya di bidang ini setelah terobosan teknologi terbaru.
Arah pengembangan teknologi
Ada dua jenis pengemasan semikonduktor: pengemasan tradisional dan pengemasan canggih. Seiring dengan terus meluasnya skala pengemasan canggih, porsinya secara bertahap mendekati dan melampaui tren pengemasan tradisional. Bagi industri semikonduktor, pengemasan dan pengujian tidak lagi sekadar tahap terpisah dalam proses manufaktur seperti di masa lalu, melainkan solusi terintegrasi yang menggabungkan desain, bahan, dan peralatan.
Oleh karena itu, pengemasan canggih menjadi semakin penting dalam bidang pengemasan dan pengujian semikonduktor. Menurut perkiraan Yole, pasar pengemasan canggih global akan mencapai 44% dari keseluruhan layanan pengemasan sirkuit terpadu pada tahun 2020, dengan pendapatan operasional tahunan sekitar US$31,5 miliar; pasar pengemasan canggih Tiongkok akan mencapai US$4,6 miliar pada tahun 2020, dengan tingkat pertumbuhan tahunan gabungan sebesar 16%. Dari sudut pandang teknis, FOWLP, SiP, dan 3DTSV merupakan tiga teknologi pengemasan dan pengujian canggih yang paling diperhatikan.
1. Kemasan FOWLP
Paket FOWLP merujuk pada metode baru untuk menggabungkan beberapa chip dari proses yang berbeda ke dalam sebuah paket yang ringkas. Metode ini pertama kali diusulkan oleh Intel. Keunggulan FOWLP dibandingkan teknologi pengemasan fan-in antara lain: ketebalan paket yang lebih tipis, skalabilitas (untuk menambah jumlah I/O), kinerja listrik yang lebih baik, kinerja termal yang baik, serta proses tanpa substrat.
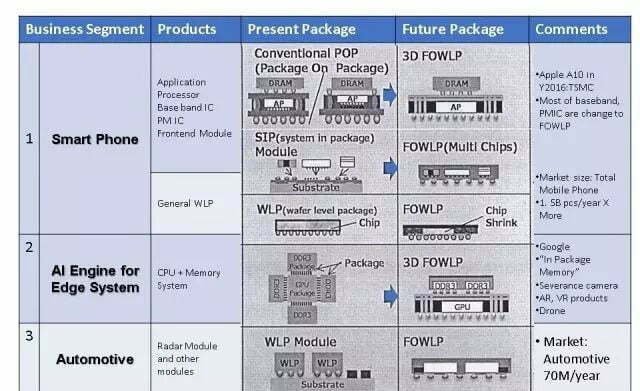
2. Kemasan SiP
System-in-package (SiP) adalah jenis teknologi pengemasan terbaru di segmen kelas atas dalam bidang pengemasan IC, yang mengintegrasikan satu atau lebih chip IC dan komponen pasif dalam satu kemasan. SiP merupakan solusi ideal yang menggabungkan keunggulan sumber daya inti yang ada dan proses produksi semikonduktor untuk menekan biaya dan mempercepat waktu peluncuran produk ke pasar. Pada saat yang sama, SiP mengatasi kesulitan seperti kompatibilitas proses, pencampuran sinyal, gangguan noise, dan gangguan elektromagnetik dalam SOC. Selain itu, penerapan SiP sangat luas. Saat ini, nilai output smartphone mencakup proporsi tertinggi, sekitar 70%.
Meningkatnya permintaan akan kemasan SiP disebabkan oleh penggunaan komersial teknologi 5G. Pertama, karena meningkatnya nilai RF mandiri, ukuran pasar keseluruhan RF front-end telah tumbuh pesat. Terdapat tren umum menuju modularisasi RF front-end, antena gelombang milimeter 5G, dan komponen integrasi RF, yang umumnya berbasis GaAs. Antena 5G terutama terbuat dari LCP (Liquid Crystal Polymer), dan kemasan SiP sangat cocok untuk integrasi heterogen. Kemasan SiP diperkirakan akan semakin populer di sektor RF.
3. Kemasan 3D - TSV
Pengemasan 3D meningkatkan kinerja inti seperti ukuran, berat, kecepatan, hasil produksi, dan konsumsi energi, serta dianggap oleh sebagian besar produsen semikonduktor sebagai metode pengemasan yang paling menjanjikan. Seiring dengan terus meluasnya cakupan pengemasan canggih ke teknologi-teknologi mutakhir dengan kinerja tinggi dan integrasi kepadatan tinggi, TSV—yang dikenal sebagai teknologi pengemasan 3D generasi keempat—diperkirakan akan menjadi pendorong yang berkelanjutan bagi perkembangan pengemasan canggih di masa depan.