Анализ отказов микросхем
Комплексный технический ресурс по методологиям, инструментам и примерам анализа отказов полупроводниковых устройств.
Что такое анализ отказов интегральных схем?
Анализ отказов интегральных схем (ИС) — это систематический процесс, используемый для выявления, локализации и определения первопричины отказов полупроводниковых устройств. Эта важнейшая инженерная дисциплина объединяет передовые методы визуализации, электротехническое тестирование и материаловедение для решения проблем в интегральных схемах в различных отраслях промышленности.
Эффективный анализ отказов повышает надежность продукции, снижает производственные затраты, ускоряет вывод продукции на рынок и обеспечивает соответствие отраслевым стандартам. Он играет жизненно важную роль в контроле качества, проектировании надежности и циклах совершенствования продукции.
Основные цели анализа отказов интегральных схем
- Выявление первопричин отказов интегральных схем посредством систематического исследования.
- Определите, связаны ли отказы с особенностями конструкции, производства или применения.
- Разработайте корректирующие действия для предотвращения будущих сбоев.
- Проверка надежности и производительности интегральных схем.
- Поддержка отчетности о сбоях и анализа данных о надежности.
Технические руководства и методологии
Диагностическая блок-схема
Систематический подход от выявления симптомов неисправности к определению первопричины.
Отсутствие пути устранения неисправности питания/выхода.
- 1. Проверьте наличие повреждений от электростатического разряда с помощью анализа SEM/EDS.
- 2. Проверьте качество паяных соединений с помощью 3D-рентгеновского контроля.
- 3. Проверка на пробой оксида затвора с помощью EMMI.
- 4. Проведите проверку целостности цепи с помощью OBIRCH.
- 5. Анализ целостности пакета с помощью C-SAM
Путь сбоя при периодических неполадках
- 1. Исключить микротрещины в BGA с помощью C-SAM.
- 2. Проверка на наличие термических напряжений с помощью инфракрасной съемки.
- 3. Проверка наличия эффекта защелкивания, связанного с особенностями конструкции, с помощью моделирования схемы.
- 4. Проверка целостности сети распределения электроэнергии.
Руководство по эксплуатации EMMI
Пошаговая инструкция по проведению анализа с помощью эмиссионной микроскопии.
Подготовка устройства
Включите устройство в состоянии, воспроизводящем ошибку, и обеспечьте надлежащее охлаждение.
Оборудование для фотолаборатории
Расположите устройство под микроскопом EMMI, обеспечьте правильное выравнивание.
Конфигурация камеры
Установите подходящее время экспозиции (обычно 10-60 секунд) и чувствительность.
Получение изображений
Для достижения оптимальных результатов сделайте несколько снимков с разной выдержкой.
Анализ и наложение
Наложите точки излучения на проектную схему, чтобы выявить неисправные конструкции.
Совет по устранению неполадок
Если очаги перегрева не появляются, убедитесь, что микросхема находится в состоянии, воспроизводящем сбой, и проверьте, вызывает ли механизм отказа излучение фотонов (разомкнутые цепи обычно этого не делают).
Типичные ошибки анализа отказов
Упущение из виду повреждений от электростатического разряда
Не следует учитывать повреждения от электростатического разряда при обращении с устройствами, особенно с микросхемами CMOS. Всегда проверяйте работоспособность браслета и протоколы заземления.
Недостаточное снижение мощности
Резистор может сгореть при работе с нагрузкой более 80%. Рекомендуется снижать номинальную мощность на 50% для обеспечения надежности в различных условиях.
Неправильное воспроизведение ошибки
Анализ устройств в условиях, которые неточно воспроизводят сценарий отказа в полевых условиях, приводит к неправильному определению первопричины.
Игнорирование проблем упаковки
Сосредоточение внимания исключительно на проблемах на уровне кристалла, игнорируя при этом отказы, связанные с корпусом, такие как расслоение, коррозия выводов или усталость паяных соединений.
Недостаточно документации
Отсутствие тщательного документирования каждого этапа анализа затрудняет воспроизведение результатов или проведение анализа тенденций в условиях множественных отказов.
Проблемы с калибровкой инструмента
Использование неправильно откалиброванного оборудования приводит к неточным измерениям и ошибочным выводам об анализе причин отказов.
Примеры из практики в отрасли
Выход из строя IGBT-модулей в электромобилях
Симптом
Внезапное отключение питания во время зарядки, без видимых внешних повреждений силовой установки электромобиля.
Процесс анализа
- Тепловизионное исследование выявило очаги перегрева в модуле IGBT во время циклов включения/выключения питания.
- Анализ методом сканирующей электронной микроскопии с энергодисперсионным анализом (SEM/EDS) выявил чрезмерный рост интерметаллических соединений (Cu₆Sn₅) в паяных соединениях.
- Поперечное сечение показало образование пустот Киркендалла на границе раздела припой-подложка.
- Моделирование методом конечных элементов показало, что причиной отказа является недостаточный профиль оплавления припоя.
Решение и результат
Скорректирован профиль оплавления для обеспечения надлежащего смачивания, добавлены никелированные контактные площадки для контроля роста интерметаллических соединений.
Результат: частота отказов в полевых условиях снизилась на 0,58% в год, что позволило сэкономить 2 миллиона долларов на гарантийных расходах.
Соответствующие стандарты
Результаты тепловизионной съемки

СЭМ-изображение роста ИМК
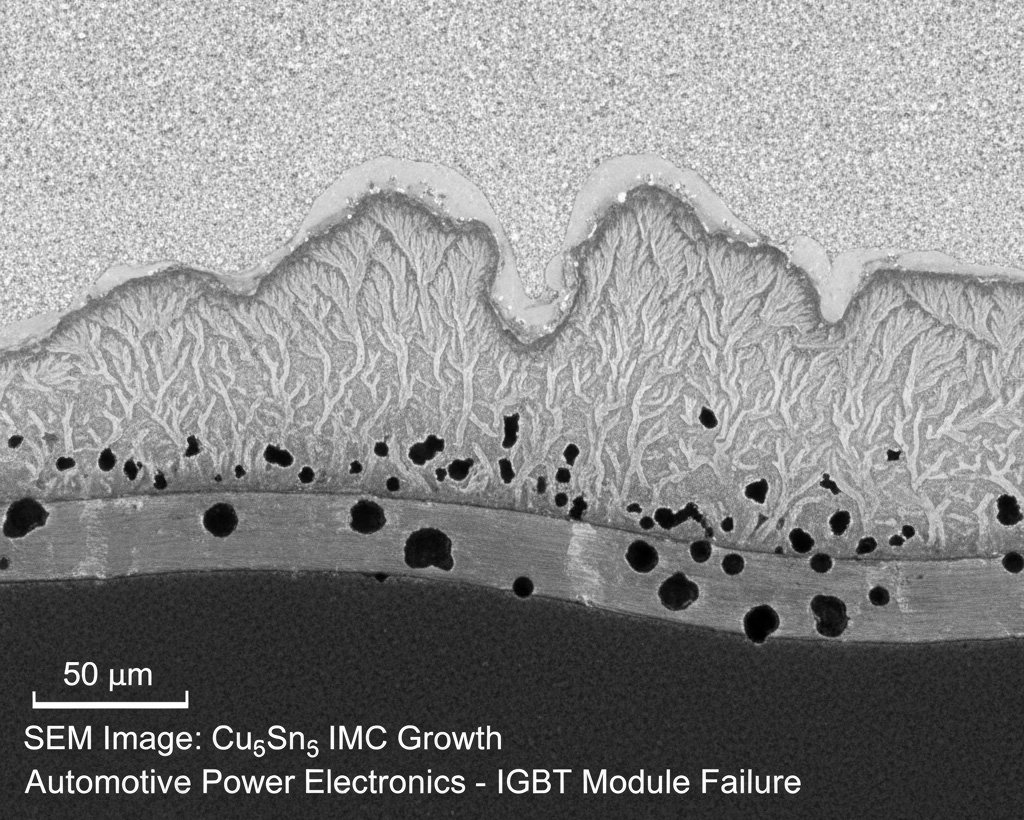
Сбой усилителя на основе GaAs в 5G AAU.
Симптом
Сбои в работе активных антенных блоков 5G (ААБ) в течение 6 месяцев после развертывания, приводящие к ухудшению качества сигнала.
Процесс анализа
- В ходе проверки с помощью C-SAM были обнаружены трещины в кристаллах GaAs усилителей мощности.
- В ходе проверки упаковки были обнаружены аномальные следы от выталкивателя на обратной стороне матрицы.
- Анализ данных о надежности показал, что распределение отказов соответствует раннему режиму отказа.
- Анализ методом конечных элементов подтвердил наличие механических напряжений в процессе склеивания кристаллов.
Решение и результат
Модифицированная синяя пленка для склеивания кристаллов снижает механическое напряжение, а также внедрена 100% проверка после склеивания с использованием автоматизированного оптического контроля.
Результат: частота отказов снизилась на 92%, а средний интервал между отказами увеличился до более чем 5 лет.
Соответствующие стандарты
Изображение трещин на кристалле, полученное с помощью C-SAM.

Анализ распределения отказов

Сбой BGA в смартфонах
Симптом
Периодические провалы изображения и неработающий сенсорный экран в смартфонах высокого класса после 6-8 месяцев использования.
Процесс анализа
- Циклирование температуры (от -40°C до 85°C) воспроизвело отказ в лабораторных условиях.
- Сканирующая акустическая микроскопия (САМ) выявила усталость паяного соединения.
- Поперечное сечение подтвердило несоответствие коэффициента теплового расширения (КТР).
- Трехмерный рентгеновский анализ позволил количественно оценить образование пустот в 18% соединений BGA.
Решение и результат
Была применена заливка компаундом с более высокой температурой стеклования (Tg), а также оптимизирована компоновка печатной платы для уменьшения температурных градиентов.
Результат: количество возвратов в процессе эксплуатации сократилось на 76%, при этом случаев поломок после 18 месяцев использования не зафиксировано.
Соответствующие стандарты
3D-рентгеновское изображение пустот в BGA

Поперечный разрез поврежденного соединения
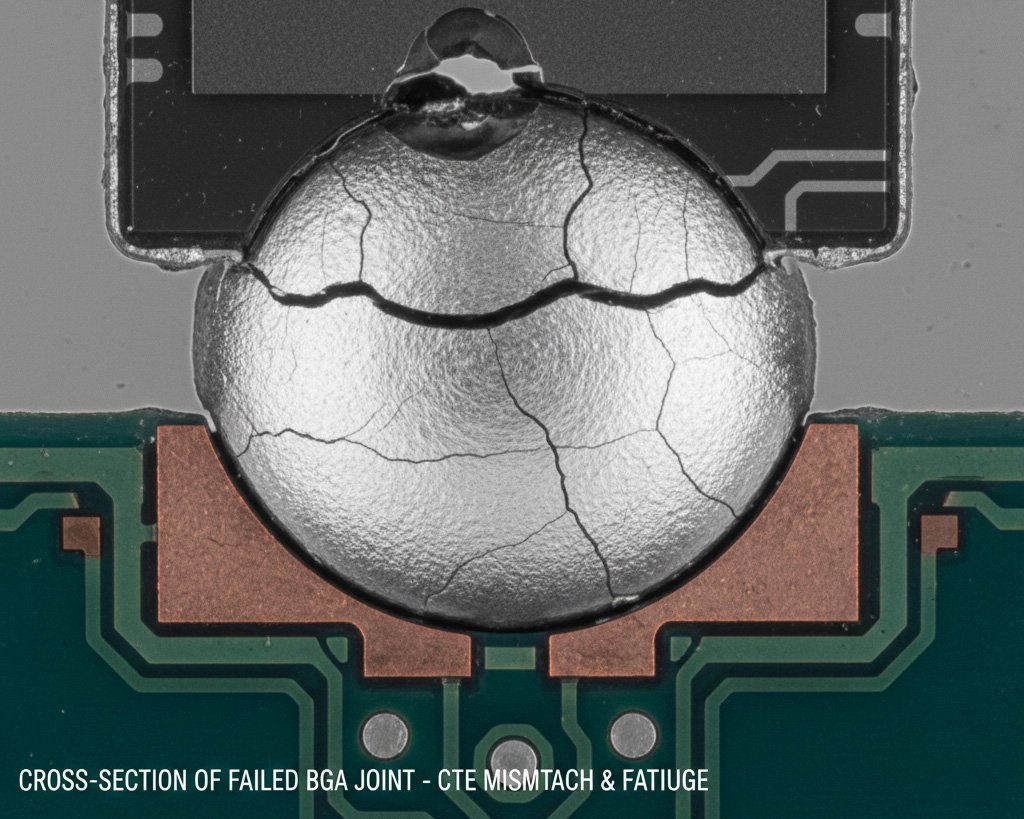
Сбой микросхемы управления авионикой
Симптом
В ходе высотных полетов происходят случайные перезагрузки систем в модулях управления авионикой без какой-либо четкой закономерности.
Процесс анализа
- Экологические испытания воспроизвели отказ в условиях низкого давления (на большой высоте).
- EMMI обнаружила периодическую утечку тока в микросхеме управления питанием.
- Моделирование IC-CAP позволило выявить неучтенные эффекты тепловой памяти в GaN HEMT-транзисторах.
- Тестирование на электростатический разряд выявило недостаточную защиту входной цепи.
Решение и результат
Обновлена модель ASM-HEMT с учетом эффектов тепловой памяти и улучшена схема защиты от электростатического разряда.
Результат: Полное исключение необходимости перезагрузки в полете, успешная квалификация в соответствии со стандартами DO-254.
Соответствующие стандарты
Изображение утечки через затвор, полученное с помощью прибора EMMI.

Анализ эффекта тепловой памяти

Инструменты и оборудование
| Инструмент | Основной вариант использования | Ограничение разрешения | Лучше всего подходит для | Ограничение |
|---|---|---|---|---|
| ЭММИ | Локализация очагов возгорания (утечки, поломки) | ~1 мкм | CMOS/FinFET-транзисторы | Нет сигнала для разомкнутых цепей |
| C-SAM | Обнаружение расслоения/пустот | 50 нм | Перевернутый чип, BGA | Требуется жидкостное соединение. |
| 3D рентгеновская КТ | Контроль TSV/многослойных кристаллов | 100 нм | 3D интегральные схемы | Высокая стоимость за высокое разрешение |
| Термография с синхронным детектированием | термическое картирование в диапазоне ниже °C | 0,1°C | Силовые интегральные схемы (IGBT) | Медленное время сканирования |
| СЭМ/ЭДС | Характеризация материалов, визуализация дефектов | 1-5 нм | Физический анализ на уровне кристалла | Требуется проводящее покрытие для изоляторов. |
| FIB-SEM | Поперечное сечение, редактирование цепей | 5 нм | 3D-микросхемы, передовая упаковка | Разрушительный, отнимающий много времени процесс. |
Руководство по подбору инструментов и техник
Соответствие инструментов конкретным сценариям отказов обеспечивает эффективный и точный анализ первопричин:
Анализ повреждений от электростатического разряда
- Начните с EMMI для обнаружения мест утечек.
- Для получения наноразмерных изображений повреждений используйте FIB-SEM.
- Используйте EDS для проверки загрязнения в местах повреждений.
- Подтвердите с помощью электрофизиологических исследований (анализ вольт-амперной характеристики).
Взломы 3D IC TSV
- Используйте трехмерную рентгеновскую компьютерную томографию для неразрушающего контроля.
- Подтвердите результаты с помощью поперечных срезов, полученных методом фиброоптической микроскопии (FIB), в критических местах.
- Проведите исследование с помощью сканирующего электронного микроскопа (СЭМ) для характеристики морфологии трещин.
- Примените метод конечных элементов для определения источников напряжений.
Неисправности, связанные с перегревом
- Начните с термографии с синхронным детектированием для создания теплового картирования.
- Используйте C-SAM для проверки наличия расслоения, вызванного термическим напряжением.
- Проведите поперечное сечение для проверки целостности паяного соединения.
- Подтвердите результаты с помощью испытаний на термоциклирование.
Периодические сбои
- Используйте климатическую камеру для воспроизведения условий отказа.
- Примените метод OBIRCH для анализа динамических путей протекания тока.
- Используйте тепловизионную съемку во время стресс-тестирования.
- При подозрении на механическое напряжение необходимо провести вибрационные испытания.
Новые инструменты и технологии
EMMI с улучшенной поддержкой ИИ
Алгоритмы машинного обучения, которые автоматически различают нормальные и аномальные паттерны излучения фотонов, сокращая время анализа до 70%.
Маркировка квантовых точек
Флуоресцентные маркеры наноразмерного масштаба, которые выделяют дефектные области в полупроводниках, позволяют на ранней стадии выявлять потенциальные места отказов.
Платформы прогнозной финансовой аналитики
Интегрированные системы, объединяющие производственные данные, отчеты о неисправностях, полученные в полевых условиях, и искусственный интеллект для прогнозирования потенциальных механизмов отказов до их возникновения.
Стандарты и соответствие требованиям
Стандарты JEDEC
JESD22-A121: Тестирование на электростатический разряд
Определяет процедуры проведения испытаний на электростатический разряд с использованием моделей человеческого тела (HBM), машинных моделей (MM) и моделей заряженных устройств (CDM).
JESD47: Методы стресс-тестирования интегральных схем
Комплексный стандарт, охватывающий различные стресс-тесты, включая температурные циклы, напряжение-температуру, электромиграцию и зависящий от времени пробой диэлектрика.
JESD22-A104: Циклирование температуры
Специальный стандарт для испытаний на температурные циклы с целью оценки надежности компонентов в условиях термических нагрузок.
Отраслевые стандарты
AEC-Q100: Автомобильные интегральные схемы
Технические условия для интегральных схем, используемых в автомобильной промышленности, с жесткими требованиями к надежности.
DO-254: Аэрокосмическая авионика
Рекомендации по обеспечению качества проектирования бортового электронного оборудования, включая интегральные схемы, используемые в критически важных для полета системах.
Telcordia GR-468: Телекоммуникации
Требования к обеспечению надежности полупроводниковых приборов, используемых в телекоммуникационном оборудовании.
Анализ данных о надежности
Для эффективного анализа отказов необходим статистический анализ данных о надежности, позволяющий понять распределение отказов и спрогнозировать срок службы изделия:
Распределения отказов
- Логарифмически нормальное распределение: характерно для отказов полупроводниковых устройств.
- Распределение Вейбулла: полезно для анализа ранних, случайных и износовых отказов.
- Экспоненциальное распределение: подходит для областей с постоянной интенсивностью отказов.
Ключевые показатели
- MTBF (среднее время между отказами)
- Частота отказов (λ) — обычно выражается в FIT (количество отказов за время: 1 FIT = 1 отказ на 10^9 устройство-часов).
- Коэффициенты пересчета для ускоренных испытаний на долговечность (ALT)
Пример анализа частоты отказов
Будущие тенденции в анализе отказов интегральных схем
Передовые технологические процессы (2 нм/1 нм)
Анализ на атомном уровне представляет собой сложную задачу, поскольку квантовые эффекты становятся значимыми факторами в механизмах отказов.
Ключевые проблемы
- • Эффекты квантового туннелирования
- • Дефекты подачи питания с обратной стороны
- • Обнаружение загрязнений на атомном уровне
Новые решения
- • Криогенный просвечивающий электронный микроскоп для исследования на атомном уровне
- • Методы нанозондирования с использованием искусственного интеллекта
- • Усовершенствованная томография с использованием атомных зондов
3D IC и гетерогенная интеграция
Сложные механизмы отказов в многослойных кристаллических архитектурах требуют применения новых методов неразрушающего анализа.
Ключевые проблемы
- • Взлом сквозных кремниевых соединений (TSV)
- • Расслоение подложки в многослойных штампах
- • Проблемы управления температурным режимом
Новые решения
- • Усовершенствованная 3D-рентгеновская компьютерная томография с более высоким разрешением
- • Методы мультимодальной визуализации
- • Проектирование с учетом возможности тестирования в 3D-интегральных схемах
Искусственный интеллект и машинное обучение
Автоматизированное обнаружение и классификация неисправностей для работы с возрастающей сложностью интегральных схем.
Основные области применения
- • Автоматическая классификация дефектов на изображениях, полученных с помощью сканирующего электронного микроскопа.
- • Прогнозирующий анализ отказов на основе производственных данных
- • Выявление аномалий в данных тестирования пластин
Преимущества
- • Сокращение времени анализа на 50-70%
- • Повышение точности выявления первопричин
- • Раннее прогнозирование отказов до начала эксплуатации в полевых условиях
