Apa itu Kemasan QFN?
Quad Flat No-Leads Package (QFN) adalah jenis kemasan pemasangan permukaan yang ditandai dengan bentuk persegi dan tidak adanya kaki eksternal. Sebagai gantinya, kemasan ini dilengkapi dengan bantalan konduktif (pin) untuk sambungan listrik di sepanjang keempat sisinya, dengan jarak antar pin yang umum sebesar 0,65 mm, 0,5 mm, 0,4 mm, dan 0,35 mm.
Karena tidak adanya kabel eksternal, kemasan QFN memiliki ukuran dan tinggi yang lebih kecil dibandingkan dengan Quad Flat Packages (QFP). Bagian tengah bagian bawah kemasan QFN memiliki bantalan termal terbuka yang besar. Kemasan QFN tidak memiliki kabel sayap camar; sebagai gantinya, kemasan ini menawarkan jalur listrik pendek antara pin internal dan bantalan, sehingga menghasilkan induktansi diri dan resistansi saluran internal yang rendah, yang memberikan kinerja listrik yang sangat baik. Bantalan termal yang terbuka berfungsi sebagai saluran pembuangan panas, sehingga kemasan QFN sangat efisien dalam pembuangan panas.
Struktur Kemasan QFN
Mari kita lihat kemasan QFN dengan pengikatan kawat; struktur internalnya adalah sebagai berikut:

Cetakan dan Rangka Timbal
Kemasan QFN terdiri dari cetakan yang dikelilingi oleh rangka kabel yang terbuat dari paduan tembaga dengan lapisan timah matte. Bahan utama rangka kabel tersebut adalah tembaga, dengan berbagai jenis yang umum digunakan, seperti A194, C7025, dan FET64.
Bahan Cetakan
Bahan cetak listrik adalah bahan cetak berbentuk bubuk yang terdiri dari resin epoksi sebagai resin dasar, resin fenolik berkinerja tinggi sebagai agen pengeras, serta bahan pengisi seperti bubuk silikon mikro, bersama dengan berbagai bahan tambahan.
Bahan Pelapis
Bahan pelapis untuk pad terbuka di bagian bawah kemasan QFN umumnya terbuat dari timah murni atau nikel-paladium-emas (NiPdAu). Bahan ini berfungsi untuk menghubungkan sirkuit ke PCB sekaligus memfasilitasi perpindahan panas yang efektif. Bahan epoksi mengamankan sambungan antara chip dan pad.
Pemasangan Chip
Ada dua jenis utama: konduktif dan non-konduktif. Bahan-bahan ini dapat hadir dalam berbagai bentuk, termasuk perekat, film pemasangan chip (DAF), kawat solder, dan pasta solder.
Kabel Pengikat
Jenis-jenis utama kawat pengikat meliputi tembaga, emas, perak, dan aluminium.
Keunggulan Kemasan QFN
Ukuran Kecil dan Ringan
Dibandingkan dengan kemasan lain seperti SOP dan TQFP, QFN menawarkan keunggulan signifikan dalam hal ukuran dan berat. Istilah "efisiensi kemasan" mengacu pada rasio luas chip terhadap luas kemasan yang mendekati 1, yang menandakan efisiensi tinggi. Sementara SOP memiliki efisiensi kemasan sebesar 0,1–0,2, QFN dapat mencapai 0,3–0,4, bahkan 0,5 tanpa bantalan termal, yang menunjukkan efisiensinya yang tinggi.
QFN banyak digunakan dalam perangkat elektronik portabel seperti ponsel dan kamera karena kebutuhan ruang PCB-nya yang kecil.
Kinerja Termal yang Unggul
Kemasan QFN dilengkapi dengan bantalan besar di bagian bawah yang dapat disolder langsung ke papan sirkuit. Bantalan ini berfungsi sebagai penyebar panas, yang secara efektif menghilangkan panas yang dihasilkan oleh chip selama pengoperasian, sehingga memperluas area dan mempercepat proses pembuangan panas.
Kinerja Listrik yang Unggul
Kemasan QFN tidak memiliki kabel eksternal, sehingga jalur listriknya lebih pendek serta induktansi sendiri dan resistansi kabel internalnya lebih rendah, sehingga menghasilkan kinerja listrik yang lebih unggul.
QFN juga menawarkan keandalan tinggi dan efisiensi biaya.
Teknologi Koneksi untuk Kemasan QFN
Berikut adalah beberapa teknik pengemasan QFN yang umum: Wire Bonding, Flip Chip, dan Clip Connection.
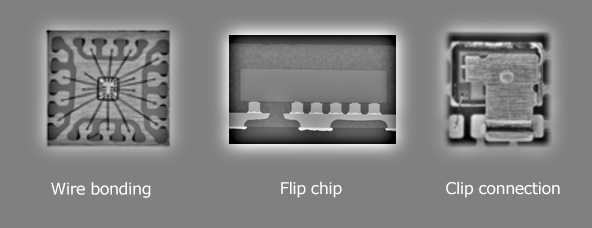
Pemasangan Kabel
- Definisi: Wire bonding adalah metode tradisional yang digunakan untuk menghubungkan chip semikonduktor ke substrat kemasan. Metode ini biasanya menggunakan kabel logam halus (seperti emas atau aluminium) untuk menghubungkan pad chip ke pad pada kemasan atau PCB.
- Hubungan dengan QFN: Dalam kemasan QFN (Quad Flat No-lead), wire bonding dapat digunakan untuk menghubungkan pad chip ke pad solder kemasan QFN. Metode ini sering digunakan untuk membuat sambungan listrik dari chip ke PCB, terutama dalam aplikasi frekuensi rendah atau daya rendah.
- Kasus penggunaan: Ini adalah teknik pengemasan yang banyak digunakan, terutama dalam aplikasi yang membutuhkan ukuran koneksi lebih kecil dan perakitan yang lebih hemat biaya.
Flip Chip
- Definisi: Flip chip adalah teknik pengemasan di mana chip semikonduktor dibalik dan disolder langsung ke kemasan atau PCB menggunakan bola solder (atau bump) alih-alih sambungan kawat tradisional. Hal ini menghasilkan koneksi berdensitas tinggi dengan kinerja termal dan listrik yang lebih baik.
- Hubungan dengan QFN: Meskipun QFN adalah kemasan tanpa kabel, teknologi flip chip dapat digunakan dalam desain QFN, terutama untuk koneksi antara chip dan pad kemasan QFN. Dalam hal ini, chip ditempatkan terbalik (dibalik) dan dipasang langsung ke substrat atau kemasan.
- Kasus penggunaan: Flip chip umumnya digunakan dalam aplikasi berkinerja tinggi yang memerlukan koneksi dengan kepadatan lebih tinggi, seperti sirkuit RF, prosesor, dan perangkat elektronik frekuensi tinggi atau daya tinggi lainnya.
Koneksi Klip
- Definisi: Sambungan klip mengacu pada metode yang menggunakan klip atau penjepit fisik untuk membentuk sambungan listrik atau termal antara chip dan kemasan atau substrat. Metode ini kurang umum digunakan pada kemasan QFN dan lebih sering diterapkan pada aplikasi berdaya tinggi atau industri tertentu.
- Hubungan dengan QFN: Koneksi klip bukanlah metode yang umum digunakan dalam pengemasan QFN. Namun, metode ini dapat diterapkan pada kemasan QFN khusus tertentu, terutama ketika diperlukan penanganan arus atau daya yang lebih tinggi, di mana klip memberikan koneksi mekanis dan listrik yang kuat.
- Kasus penggunaan: Metode koneksi ini digunakan dalam sistem daya tinggi seperti elektronika daya, perangkat daya semikonduktor, atau situasi di mana koneksi yang kokoh dan berresistansi rendah diperlukan.
Proses Pengemasan QFN
Proses pengemasan QFN terdiri dari beberapa tahap, antara lain penggilingan wafer, pemotongan, pemasangan chip, pengikatan kabel, enkapsulasi, pelapisan, penandaan, dan pemisahan. Empat tahap utama adalah:
Langkah 1: Penggilingan Wafer
mengurangi ketebalan wafer agar sesuai dengan ruang yang terbatas untuk kemasan QFN.
Langkah 2: Memotong dadu
Proses pemotongan memisahkan chip-chip individu dari wafer.
Langkah 3: Pemasangan Chip
menempatkan chip-chip yang telah dipisahkan ke atas wadah logam yang dilengkapi dengan konektor yang diperlukan.

Langkah 4: Pengikatan Kabel
menghubungkan pad fungsional chip ke terminal kemasan menggunakan mesin pengikat kabel otomatis.

Langkah 5: Enkapsulasi
melindungi chip dan wadah logam dengan membungkusnya menggunakan resin epoksi.
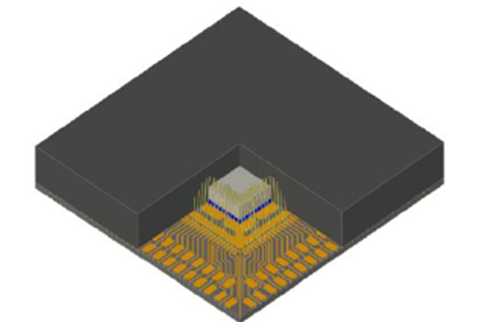
Langkah 6: Penyajian
melapisi kabel tembaga dengan lapisan timah untuk mencegah oksidasi.

Langkah 7: Penandaan
beri label pada chip dengan nama produk, logo pelanggan, dan informasi batch.

Langkah 8: Pemisahan
Proses pemisahan memotong kemasan yang sudah jadi menjadi unit-unit terpisah.
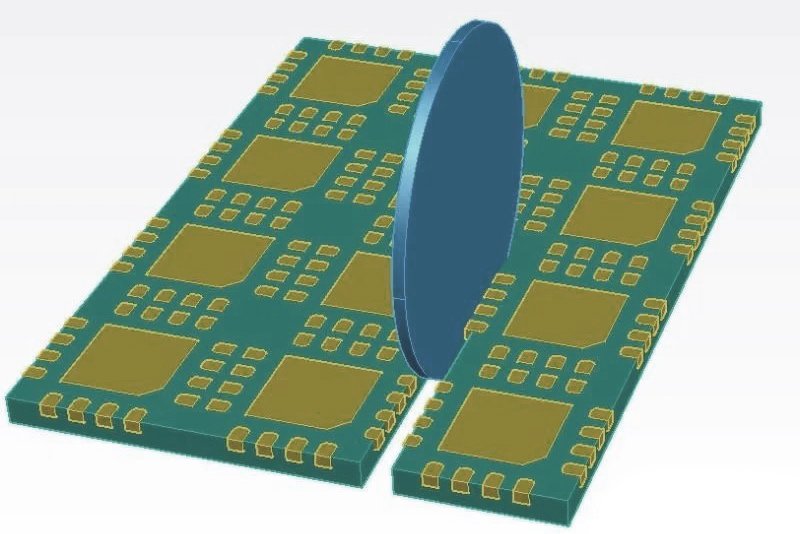
Pedoman Desain Footprint QFN
Saat merancang footprint PCB untuk komponen QFN (Quad Flat No-lead), sangat penting untuk memastikan tata letak yang akurat dan efektif guna menghindari masalah dalam proses penyolderan serta memastikan kinerja listrik dan termal yang optimal. Berikut ini adalah uraian terperinci berdasarkan konten referensi yang Anda berikan, yang mencakup aspek-aspek utama dalam desain footprint QFN:
Jarak Pin QFN yang Umum dan Contohnya
Komponen QFN umumnya tersedia dalam jarak antar pin sebesar 0,5 mm, 0,4 mm, dan 0,35 mm. Sebagai ilustrasi, mari kita fokus pada komponen QFN dengan jarak antar pin 0,5 mm. Lembar data untuk komponen semacam itu sering kali mencantumkan dimensi komponen dalam rentang (misalnya, 0,20–0,30 mm), di mana nilai yang paling umum mungkin adalah 0,25±0,05 mm. Dalam praktiknya, produsen cenderung melebih-lebihkan toleransi untuk melindungi diri mereka sendiri, tetapi penting untuk dicatat bahwa dimensi sebenarnya mungkin tidak selebar yang tercantum.

Desain Footprint PCB yang Direkomendasikan
Merancang footprint PCB untuk komponen QFN memerlukan pertimbangan yang cermat terhadap beberapa faktor:

Lebar Pad Kecil: Pabrikan mungkin merekomendasikan lebar pad sebesar 0,3 mm, tetapi berdasarkan praktik terbaik, disarankan untuk menggunakan lebar 0,27 mm. Lebar pad yang lebih besar dapat meningkatkan risiko terjadinya jembatan timah antar pad, terutama jika desain stensil (pencetakan layar) tidak dioptimalkan dengan baik. Selain itu, lebar pad tidak boleh lebih kecil dari lebar kaki komponen QFN itu sendiri (biasanya 0,25 mm).
Panjang Pad: Panjang pad yang direkomendasikan umumnya 0,8 mm, yang dapat diterima. Misalnya, jika lebar keseluruhan paket adalah 3 mm, dan panjang pad eksternal adalah 3,7 mm, dengan mengurangkan lebar paket (3 mm) dan membaginya dengan 2, akan diperoleh ekstensi 0,35 mm untuk setiap sisi. Panjang ini tidak boleh melebihi nilai tersebut untuk menghindari gangguan terhadap komponen terdekat, terutama pad pembuangan panas pusat.
Ukuran Pad Heat Sink: Pad heat sink pusat harus sesuai dengan dimensi pad termal komponen, biasanya sekitar 1,65 mm. Ukurannya tidak perlu lebih besar dari rekomendasi pabrikan, tetapi harus dirancang dengan sudut yang membulat (terutama untuk pembuangan panas) guna meningkatkan kinerja termal.
Desain Jalur Termal untuk Pembuangan Panas
QFN sering kali memiliki bantalan termal pusat yang besar yang perlu dihubungkan ke beberapa lapisan tembaga untuk pembuangan panas yang efisien. Dalam desain PCB:
Ukuran Via Termal: Untuk PCB dengan ketebalan 1,6 mm, idealnya gunakan via dengan diameter lubang 0,3 mm. Via tidak boleh terlalu besar, karena hal ini dapat menyebabkan kebocoran pasta solder selama proses reflow. Demikian pula, via tidak boleh terlalu kecil, karena hal ini dapat menimbulkan masalah pengeboran atau konduktivitas termal yang tidak memadai. Jarak antar-via harus dipertimbangkan dengan cermat untuk menghindari komplikasi selama proses desain stensil.
Jumlah dan Jarak Via: Untuk menghilangkan panas secara efektif, jarak antar via harus merata di seluruh bantalan termal. Namun, menempatkan via terlalu berdekatan dapat menyebabkan komplikasi pada desain stensil, yang berpotensi menimbulkan masalah selama proses penyolderan. Pastikan jarak antar via cukup untuk memungkinkan pengendapan pasta solder yang tepat dan menghindari jembatan solder.
Hal-hal yang Perlu Diperhatikan dalam Desain Stensil
Ketebalan Stensil: Untuk komponen QFN dengan jarak pin 0,5 mm, ketebalan stensil yang direkomendasikan biasanya adalah 0,13 mm. Ketebalan ini memastikan keseimbangan yang baik antara volume pasta solder dan kemampuannya untuk mengalir selama proses penyolderan reflow.
Bukaan Pad untuk Stensil: Bukaan stensil harus sedikit lebih sempit daripada lebar pad untuk memperhitungkan ekspansi pasta solder. Seperti yang disebutkan sebelumnya, lebar pad 0,27 mm harus sesuai dengan lebar bukaan stensil antara 0,22 mm dan 0,24 mm, memastikan volume pasta solder yang cukup sekaligus mencegah kelebihan pasta yang dapat menyebabkan jembatan solder.
Panjang Pad dan Lubang: Panjang pad untuk stensil harus disesuaikan 0,1 mm ke dalam, dan ekstensi untuk pad luar dapat berkisar antara 0,15 mm hingga 0,25 mm. Tujuannya adalah untuk memastikan lapisan pasta yang merata tanpa pasta berlebih, terutama pada pad yang lebih kecil.
Bukaan Pad Termal: Untuk pad termal besar, bukaan stensil dapat lebih kecil dari ukuran pad sebenarnya, biasanya sekitar 40-60% dari total area. Sangat penting untuk membuat pola kisi atau "hatch" (misalnya, pola silang atau kisi persegi) agar pasta solder dapat mengalir secara merata sekaligus menghindari penyolderan berlebih atau pasta yang tidak mencukupi. Selain itu, bukaan harus dirancang dengan cermat untuk menghindari tumpang tindih dengan via apa pun, yang dapat menyebabkan potensi kebocoran pasta solder.
Kesalahan Umum dan Praktik Terbaik
Mengabaikan Toleransi dalam Desain Footprint: Seringkali, para insinyur secara membabi buta menyalin ukuran footprint yang direkomendasikan pabrikan dari lembar data tanpa mempertimbangkan apakah dimensi tersebut telah dioptimalkan untuk proses penyolderan dan kinerja listrik. Sangat penting untuk memverifikasi dimensi tersebut menggunakan alat ukur, seperti jangka sorong, sebelum menyelesaikan desain PCB.
Desain Pad yang Berlebihan: Beberapa desainer membuat kesalahan dengan memperbesar ukuran pad untuk mengkompensasi toleransi manufaktur, tetapi hal ini dapat menimbulkan lebih banyak masalah daripada yang diselesaikan, seperti jembatan antara pad dan peningkatan risiko korsleting selama proses reflow.
Disipasi Panas yang Tidak Memadai: Tidak cukup memperhatikan via termal dan desain disipasi panas dapat menyebabkan IC menjadi terlalu panas, yang mengakibatkan kegagalan atau malfungsi. Memastikan bahwa ada via yang memadai di bawah bantalan termal dan area tembaga yang cukup untuk pengardean sangat penting untuk menjaga komponen tetap dingin dan beroperasi dalam batas yang aman.
Aplikasi Kemasan QFN
Kemasan QFN banyak digunakan dalam:
- Produk telekomunikasi
- Ponsel
- Jaringan LAN nirkabel
- Produk portabel
- Asisten digital pribadi (PDA)
- Kamera digital
- Kemasan dengan jumlah timah rendah hingga sedang
- Perangkat informasi
Memilih Kemasan QFN yang Tepat
Pemilihan kemasan QFN bergantung pada berbagai faktor, antara lain:
- Keterbatasan Ruang: QFN tipis dan ultra-tipis paling cocok untuk aplikasi dengan ruang terbatas.
- Kebutuhan Manajemen Termal: Kemasan dengan bantalan termal terbuka atau beberapa jalur termal sangat ideal untuk komponen yang sensitif terhadap panas.
- Keandalan: Kemasan seperti SWF QFN memungkinkan inspeksi yang lebih baik, sehingga ideal untuk aplikasi dengan keandalan tinggi di mana kualitas sambungan solder sangat penting.
- Pertimbangan Perakitan dan Manufaktur: Beberapa QFN, seperti yang memiliki sisi yang dapat dibasahi atau desain lead-on-pad, menyederhanakan perakitan dan meningkatkan ketahanan mekanis.