Di era server AI, ponsel pintar 5G, dan kendaraan otonom, kinerja sebuah chip bergantung sepenuhnya pada "sistem saraf" yang mendukungnya—yaitu substrat IC. Seiring kepadatan sirkuit mencapai batas fisiknya, pilihan proses fabrikasi menentukan integritas sinyal dan keandalan produk akhir.
Saat ini, tiga "alat pemodelan" utama mendominasi industri ini: Tenting (Subtraktif), mSAP (Proses Semi-Aditif yang Dimodifikasi), dan SAP (Proses Semi-Aditif). Panduan ini menguraikan mekanisme teknis, kelebihan dan kekurangannya, serta peran masing-masing dalam ekosistem elektronik modern.
1. Proses Pembentukan Cetakan (Metode Subtraktif)
Proses Tenting adalah teknologi pembentukan jalur yang paling tradisional dan paling banyak digunakan dalam industri PCB dan substrat kepadatan rendah. Prinsip dasarnya adalah "menutupi dan menghilangkan"—mirip seperti mengukir stempel dari balok batu.
Cara Kerjanya: Proses ini dimulai dengan Copper Clad Laminate (CCL) yang dilapisi foil tembaga tebal (biasanya $> 12\mu m$). Sebuah lapisan kering (photoresist) menutupi area sirkuit yang diinginkan seperti "tenda" di atas lubang-lubang (karena itulah namanya). Tembaga yang tidak terlindungi kemudian dihilangkan melalui proses etsa kimia.
Masalah (Pengikisan Samping): Karena pengikisan menghilangkan tembaga secara vertikal dan horizontal secara bersamaan, hal ini menciptakan penampang "trapezoidal". "Pengikisan samping" ini membatasi presisi lebar garis dan jarak ($L/S$) menjadi sekitar $30\mu m/30\mu m$.
Cocok untuk: Elektronik konsumen standar, PCB otomotif, dan substrat Wire Bond BGA (WB BGA) tradisional.
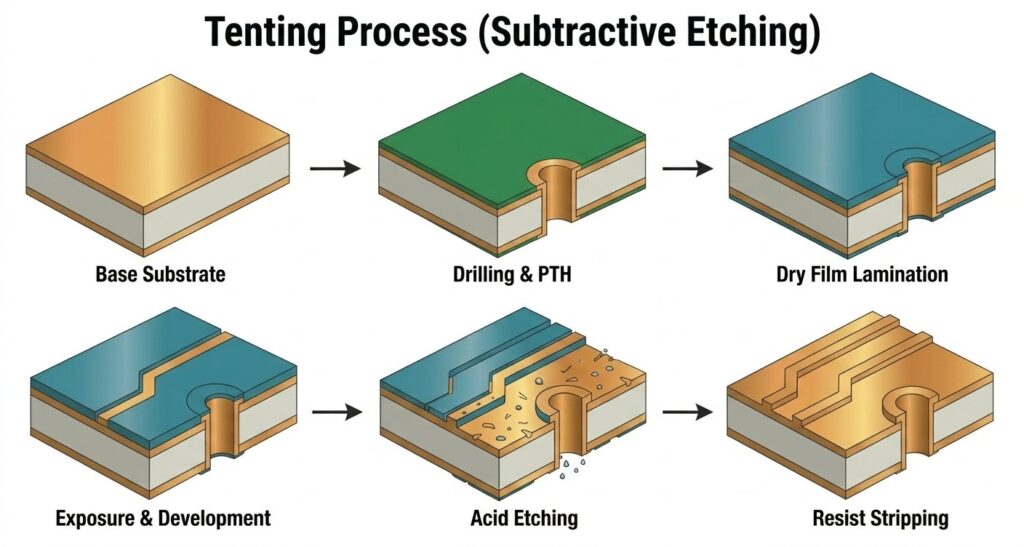
2. mSAP (Proses Semi-Aditif yang Dimodifikasi)
Seiring bertambahnya jumlah pin dan meningkatnya kecepatan sinyal, mSAP muncul sebagai jembatan antara PCB tradisional dan substrat IC kelas atas. Saat ini, mSAP menjadi pilihan utama untuk substrat FCBGA yang digunakan pada chip jaringan dan prosesor smartphone premium.
Cara Kerjanya: Alih-alih menggunakan tembaga tebal, mSAP dimulai dengan dasar tembaga ultra-tipis (biasanya $3$–$5\mu m$) atau "lapisan benih" yang diendapkan secara kimiawi. Sirkuit "ditambahkan" melalui pelapisan listrik selektif hingga ketebalan yang diinginkan.
Keunggulannya: Setelah pelapisan, "pengikisan kilat" yang cepat menghilangkan lapisan dasar ultra-tipis tersebut. Karena dasarnya sangat tipis, waktu pengikisan menjadi minimal, sehingga menghasilkan dinding sirkuit persegi panjang yang hampir vertikal dengan kemampuan $L/S$ hingga $10\mu m/10\mu m$.
Cocok untuk: AP smartphone kelas atas (Apple seri A, Snapdragon), Chip Scale Packaging (FCCSP), dan PCB mirip Substrat (SLP).
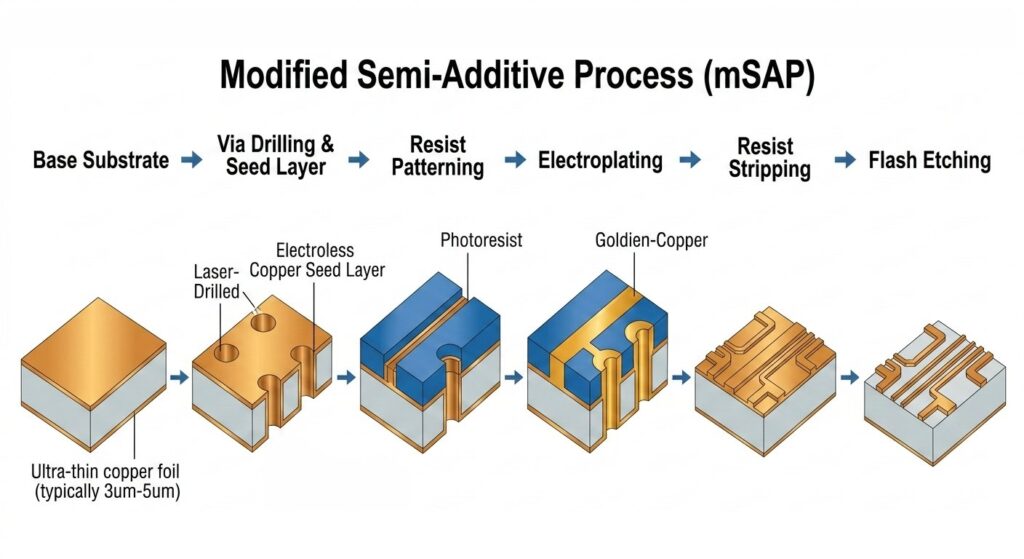
3. SAP (Proses Semi-Aditif)
SAP merupakan puncak presisi sirkuit, yang sering disebut sebagai versi "murni" dari mSAP. Teknologi ini sama sekali tidak menggunakan lembaran tembaga dan sepenuhnya mengandalkan "penambahan murni".
Cara Kerjanya: Teknologi ini menggunakan bahan dielektrik bebas tembaga, terutama ABF (Ajinomoto Build-up Film). Lapisan "benih" mikroskopis ($< 1\mu m$) diendapkan secara kimiawi pada permukaan yang halus, diikuti dengan pelapisan selektif untuk membangun sirkuit.
Keunggulannya: Karena lapisan benih hampir tidak ada, pengetsaan tidak berdampak sama sekali pada morfologi sirkuit. Hal ini memungkinkan presisi yang sangat tinggi ($L/S < 10\mu m$) dan kontrol impedansi yang unggul untuk sinyal berkecepatan tinggi.
Cocok untuk: Komputasi kinerja tinggi (HPC), akselerator AI (Nvidia H100), dan pengemasan canggih seperti CoWoS dan HBM.
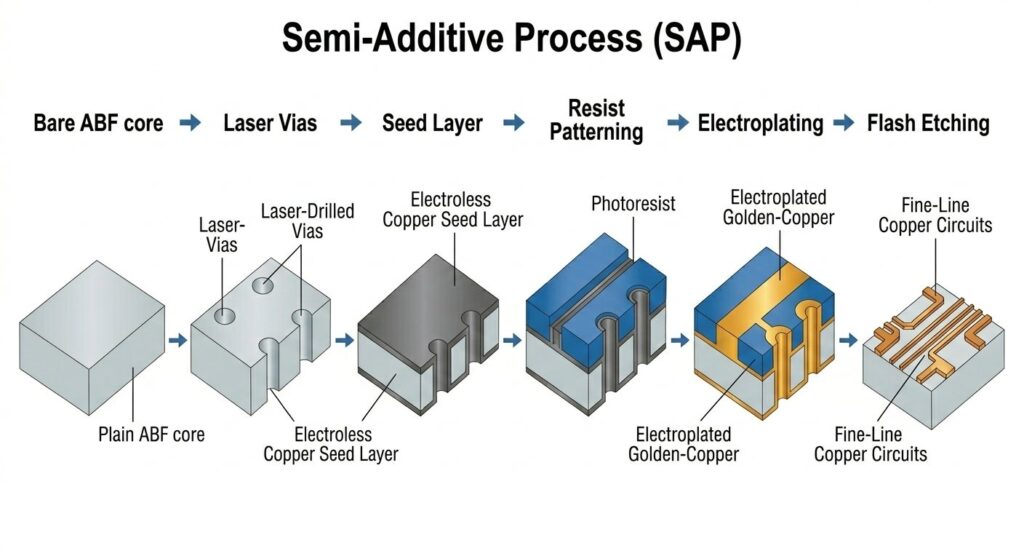
4. Tabel Perbandingan: Tenting vs. mSAP vs. SAP
| Feature | Tenting | mSAP | SAP |
|---|---|---|---|
| Core Principle | Subtractive: Etch away thick copper foil | Additive: Plate over ultra-thin copper base | Pure Additive: Seed layer on copper-free dielectric |
| Line Precision (L/S) | > 30μm | 10μm - 30μm | < 10μm |
| Cross-section Shape | Trapezoidal (Side-etching) | Near-Rectangular | Perfectly Rectangular |
| Base Material | Standard CCL | Ultra-thin copper foil | ABF (Ajinomoto Build-up Film) |
| Primary Application | Consumer PCBs / Motherboards | Smartphone AP / High-end HDI | AI Accelerators / CPU / GPU Substrates |
| Cost & Maturity | Low Cost / Highly Mature | Medium-High / Mainstream High-end | Very High / Cutting-edge |
Melihat ke Depan: Masa Depan Manufaktur
Industri ini bergerak menuju pendekatan "hibrida" untuk menyeimbangkan biaya dan kinerja—dengan menggunakan Tenting untuk lapisan inti dan mSAP/SAP untuk lapisan luar berdensitas tinggi. Seiring dengan meningkatnya permintaan AI yang mendobrak batas-batas Hukum Moore, teknologi-teknologi baru seperti substrat kaca dan die tertanam akan terus berkembang sejalan dengan ketiga proses fundamental ini.
Memahami nuansa metode fabrikasi ini merupakan langkah pertama dalam menguasai lanskap kompleks pengemasan chip modern dan keamanan perangkat keras.