IC testi, yongada tasarım hataları veya üretim sürecinden kaynaklanan fiziksel kusurlar olup olmadığını tespit etmeye yöneliktir. Bu süreç, çeşitli test yöntemleri kullanılarak gerçekleştirilebilir.
IC paketleme, bir entegre devrenin (IC) koruyucu bir pakete yerleştirilmesi işlemidir. Bu işlem, IC'yi hasardan korur ve doğru şekilde çalışmasını sağlar. Ayrıca, IC'nin diğer cihazlara ve devrelere bağlanmasına da olanak tanır.
IC test cihazı ile IC nasıl test edilir?
IC test kiti
Piyasada, her biri belirli bir amaca yönelik olarak tasarlanmış birkaç farklı türde IC test kiti bulunmaktadır. Örneğin, bazı IC test kitleri genel amaçlı testler için tasarlanmıştır. Diğerleri ise otomotiv IC’leri veya güç IC’leri gibi belirli uygulamalar için tasarlanmıştır.
Çoğu IC test kiti, multimetre, problar, dijital IC test cihazı ve test kabloları gibi çeşitli temel aksesuarları içerir. Bazı kitler, osiloskop veya mantık analizörü gibi daha özel ekipmanları da içerebilir.
Test Yöntemi
IC'leri test etmenin birkaç farklı yolu vardır, ancak en yaygın yöntem devre içi test (ICT) olarak adlandırılır. Bu tür testler, test fikstürünün test edilen cihaza (DUT) bağlanmasıyla gerçekleştirilir. Ardından, temel işlevleri kontrol etmek için bir dizi test yürütülür.
ICT, hem dijital hem de analog IC'leri test etmek için kullanılabilir. Dijital IC'ler için, test cihazı DUT'a bir dizi giriş sinyali gönderir. Ardından, çıkışları kontrol ederek beklenen sonuçlarla eşleşip eşleşmediklerini kontrol eder. Analog IC'ler genellikle dinamik test adı verilen bir teknik kullanılarak test edilir. Bu süreçte, test cihazı DUT'a bir dizi sinyal uygular ve ardından yanıtı ölçer.
ICT test cihazları üreten farklı şirketler vardır; kendi IC'lerinizle uyumlu olanı seçmeniz gerekir. Bir test cihazına sahip olduğunuzda, DUT'a bağlanan bir test fikstürü oluşturmanız gerekecektir. Test fikstürü, DUT'a gerekli sinyalleri uygulayabilir ve ayrıca yanıtı ölçebilir.
Her ikisine de sahip olduğunuzda, sonuçları kontrol etmek için bir test programı yazmanız gerekir. Bu, zaman alıcı bir süreç olabilir, ancak IC'lerinizin düzgün çalıştığından emin olmak önemlidir.
Test Türleri
IC devre kesintisizliği testi
IC devamlılık testi basittir ve bu testi kullanarak IC'lerin düzgün çalışıp çalışmadığını belirleyebilirsiniz.
Bu test, bir multimetreyi IC'ye bağlayarak ve çeşitli pimler arasındaki direnci ölçerek gerçekleştirilir.
IC düzgün çalışıyorsa, direnç düşük olmalıdır (genellikle 10 ohm'dan az). Aksi takdirde, direnç yüksek olacaktır (genellikle 10 ohm'dan fazla).
seviye testi
IC düzeyinde test, entegre devrelerin (IC) işlevselliğini ve performansını belirlemeye yönelik bir elektriksel test türüdür.
Bu test genellikle devre kartına önceden takılmış IC'ler üzerinde gerçekleştirilir.
Testin amacı, IC'nin düzgün çalıştığını ve kullanım amacına uygun özellikleri karşıladığını doğrulamaktır.
IC seviyesi testi için mantık testi, işlevsel test ve parametrik test dahil olmak üzere çeşitli farklı test yöntemleri bulunmaktadır.
IC Paketleme Geliştirme Süreci
Ambalajlama genel olarak aşağıdaki gelişim sürecinden geçmiştir:
1. Yapı açısından:
TO->DIP->PLCC->QFP->BGA->CSP->WLP ve SiP, vb.
2. Malzemeler:
Metal, seramik -> seramik, plastik -> plastik;
3. Pim şekli:
Uzun uçlu sıralı -> kısa uçlu veya uçsuz montaj -> top çıkıntı
4. Montaj yöntemi:
Delikten Geçirme -> Yüzey Montajı -> Doğrudan Montaj
5. Ambalajın sürekli iyileştirilmesinin itici gücü:
Daha küçük boyut, daha fazla yonga türü, daha fazla G/Ç
6. Zorluklar:
Süreç giderek daha karmaşık hale geliyor ve hacmi azaltırken ısı dağılımını ve elektriksel iletkenliği de hesaba katmak gerekiyor.

Özellikler ve temel rekabet gücü
1. Güçlü üretim özellikleri
Üretim kapasitesi tamamen ekipman alımına (sermaye yatırımı) bağlıdır ve geleneksel imalat sektöründe olduğu gibi, bu sektörde de kapasite artırımı ve süreç optimizasyonu aşamalarından geçilecektir. Ölçek büyüdükçe, deneyim birikimi ve öncü teknolojinin getirdiği avantajlar da artacaktır.
2. Ambalajlama ve testlerin kapsamı, müşteri yapısını belirler
Büyük tasarım üreticileri, yalnızca belirli bir ölçeğe sahip test üreticileriyle işbirliği yapmaktadır. Ölçek büyütülmezse, büyük siparişleri üstlenmek zorlaşır ve müşteri yapısını optimize etmek de zorlaşır. Bu nedenle, önde gelen teknolojiye ve ölçeğe sahip şirketler bir pozitif döngüye gireceklerdir: önde gelen teknoloji → müşteri geliştirme → finansman genişlemesi → üretim kapasitesinin artırılması → süreç optimizasyonu → önde gelen teknoloji; ve rakipleriyle aradaki farkı giderek artıracaklardır.
3. Temel Rekabet Gücü
Yukarıdaki iki sektör özelliği, entegre devre (IC) profesyonel test şirketlerinin temel rekabet gücünü belirlemektedir:
Ar-Ge Yeteneği: test prosedürleri ve test çözümlerinin geliştirilmesine odaklanma.
Pazarlaşma Derecesi: Test programı geliştirme ve süreç optimizasyon yetenekleri, çok sayıda müşterinin getirdiği farklı türdeki yongaların test deneyiminden kaynaklanır.
Mükemmel Test Süreci: Yukarı akış tasarım ve yonga plakası işlemenin yakın entegrasyonu sayesinde, test süreci ve prosedürleri sürekli olarak optimize edilir.
Sermaye İşletme Yeteneği: Mevcut yurt içi gelişme aşaması, ölçeğin gelişimin ön koşulu olduğunu belirlemektedir. Bu nedenle, teknoloji ve pazar gücüne uygun finansman yeteneği, kurumsal gelişim ve büyümenin desteğidir.
IC Paketleme ve Test Pazarı
1. IC paketleme ve test ölçeği
1.1 Küresel IC Paketleme ve Test Pazarı (2011-2020)
2019 yılında, yarı iletken sektörü genelinde bir yavaşlama yaşandı ve sektörde negatif büyüme kaydedildi; çip paketleme ve test pazarı da bu durumdan nasibini aldı. Ancak, 5G, yapay zeka, nesnelerin interneti, bulut bilişim ve büyük veriye yönelik talep sayesinde bu pazar daha sonra toparlandı. Uzmanlar, 2024 yılında çip paketleme ve test pazarının toplam büyüklüğünün 75 milyar dolara ulaşabileceğini öngörüyor.

1.2 Küresel IC Yonga Plakası Üretimi (2012-2022)
5G, IoT ve yapay zeka gibi yeni gelişen alanların hızla yaygınlaşmasıyla birlikte, yongaların boyutları giderek küçülüyor. Aynı zamanda, yonga çeşitleri de giderek artıyor. G/Ç pinlerinin sayısı da önemli ölçüde arttı ve gelişmiş paketleme teknolojisine olan talep giderek yükseldi.

1.3 Çin'deki iC Ambalaj ve Test Sektörü (2014-2018)
2018 yılında, Çin anakarasındaki IC paketleme ve test kapasitesi 217,44 milyar adede ulaşırken, IC paketleme ve test sektörünün pazar büyüklüğü 219,39 milyar yuan'a ulaştı; bu, bir önceki yıla göre %16,1'lik bir artışa tekabül ediyor.

2. İleri düzey ambalajlama sektörünün büyümesi
2.1 Toplam iç devre paketleme içinde ileri düzey paketlemenin payı
Yole istatistiklerine göre, 2019 yılında yarı iletken sektörü genelinde bir yavaşlama yaşanmış ve negatif büyüme kaydedilmiş olsa da, ileri düzey paketleme pazarının büyüklüğü büyüme eğilimini sürdürecektir. 2018 yılında ileri düzey paketleme pazarının büyüklüğü 27,6 milyar ABD dolarıydı.
Yıllık bileşik büyüme oranı %8 olarak artarak 2024 yılına kadar yaklaşık 44 milyar dolara ulaşacak. Geleneksel paketleme pazarı yıllık bileşik büyüme oranı %2,4 olarak büyüyecek, oysa tüm IC paketleme endüstrisinin yıllık bileşik büyüme oranı %5'e ulaşacak.

2.2 Gelişmiş Ambalajlama gelir tahmin eğilimleri (2018-2024)
Gelişmiş paketleme sektöründe, flip-chip teknolojisi en yüksek paya sahiptir. 2018 yılında, flip-chip paketleme ve test gelirleri, gelişmiş paketleme pazarının yaklaşık %81’ini oluşturmuştur. 2024 yılına kadar, diğer teknolojilerin hızlı gelişimi nedeniyle bu oran %72’ye düşecektir.
2018'den 2024'e kadar TVS, ED ve fan-out en hızlı büyüyen teknolojilerdir. 2.5D/3D paketleme (TSV), ED ve fan-out paketleme (Fan-out) gelir artış oranlarının sırasıyla %26, %49 ve %26 olacağı tahmin edilmektedir.
Fan-in WLP'nin 2018-2024 CAGR'si nispeten düşük, sadece %6,5'tir ve 2018'de gömülü yonganın pazar büyüklüğü 25 milyon ABD dolarının altındadır.
Bununla birlikte, önümüzdeki beş yıl içinde yıllık bileşik büyüme oranı %49'a kadar çıkacak ve ana itici faktörler iletişim tesisleri, otomotiv elektroniği ve mobil pazarların talebinden kaynaklanacaktır.
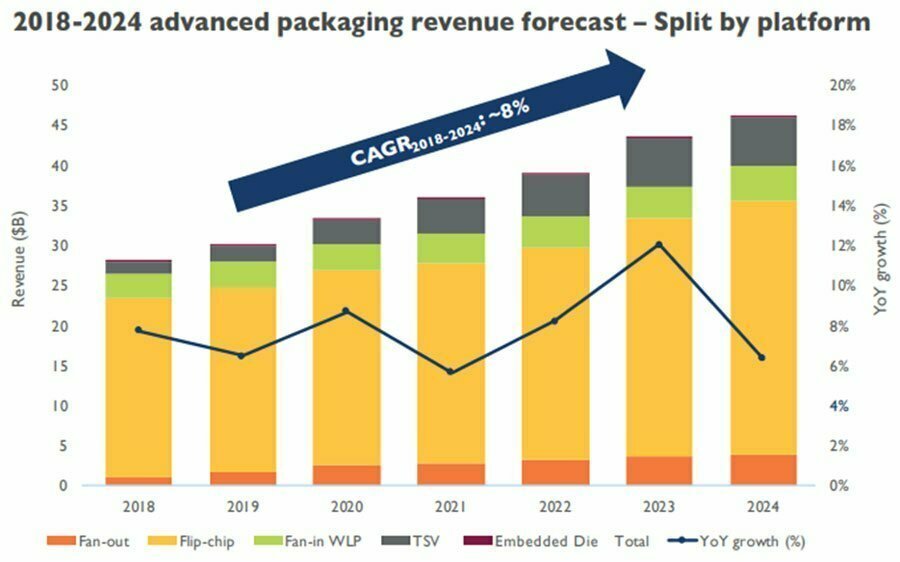
2.3 İleri düzey ambalajlama uygulamaları
Uygulama alanlarına göre, 2018 yılında mobil ve tüketici uygulamaları, toplam gelişmiş ambalaj pazarının %84'ünü oluşturdu. 2019'dan 2024'e kadar, uygulama pazarının bu segmentinin yıllık bileşik büyüme oranı (CAGR) %5 oldu ve 2024 yılında toplam gelişmiş ambalaj pazarının %72'sini oluşturdu.
Telekom ve altyapı segmenti, gelişmiş ambalaj pazarının en hızlı büyüyen segmentidir (yaklaşık %28) ve pazar payı 2018'deki %6'dan 2024'te %15'e çıkacaktır.
Aynı zamanda, otomotiv ve ulaşım segmentinin pazar payı 2018'deki %9'dan 2024'te %11'e yükselmiştir.

2018 yılında, profesyonel yonga paketleme ve test hizmetleri sunan firmalar, gelişmiş paketleme ve test pazarının %61’ini oluştururken, IDM tipi şirketler %23’ünü, dökümhane tipi üreticiler ise %16’sını oluşturdu.

Rekabet Ortamı
1. Dünyanın en büyük 10 şirketi (2018-2019)
Yonga paketleme ve test pazarı nispeten yoğunlaşmış durumdadır. İlk on üretici, pazarın yaklaşık %80’ini elinde tutmaktadır. Çin anakarası ve Tayvan’daki üreticiler pazarda hakim konumdadır. Tayvanlı paketleme ve test endüstrisi, uzun yıllardır dünya çapındaki faaliyet gelirinin neredeyse yarısını elde ederek ilk on arasında sağlam bir yer edinmiştir.
IDM'lerin (Intel ve Samsung gibi) yonga paketleme ve test gelirleri ne olursa olsun, ASE ve Amkor profesyonel yonga paketleme ve test alanında ilk iki sırayı sağlam bir şekilde elinde tutmaktadır.

2. Fırsatlar ve Zorluklar
Yarı iletken tedarik zincirindeki değişiklikler, iş modellerindeki dönüşümler ve ABD-Çin ticaret ilişkilerindeki belirsizlik, bazı üreticiler için fırsatlar yaratırken, diğerleri için tehditler oluşturmuştur.
2.1 Sanayi zincirinin genişletilmesi
Sürekli değişen bu iş ortamında, yarı iletken tedarik zinciri her düzeyde dönüşüm geçiriyor. Bazı tedarikçiler yeni iş modellerini başarıyla yaygınlaştırdı.
IC üretim zincirini önemli ölçüde etkilemişken, diğer üreticiler bu ivmeden yararlanamamıştır. Farklı satıcıların yeni iş alanlarına genişlemelerini sağlayan farklı itici güçleri vardır.
Örneğin, Google, Microsoft, Facebook ve Alibaba gibi yazılım şirketleri, sistem düzeyinde entegrasyon/özelleştirme ve montaj düzeyinde tedarik zinciri kontrolü elde etmek için kendi işlemcilerini tasarlamaktadır.
En büyük değişiklik, dökümhanelerin gelişmiş paketleme işine girmeye başlamasıdır. Nispeten "yeni" olmalarına rağmen, etkileri çok büyüktür.
2.2 Ambalaj teknolojisindeki yenilikler
TSMC, fan-out paketleme ve 3D ileri düzey paketleme platformlarında yenilikçiliğe öncülük etmektedir. Şirket, InFO (ve varyantları), CoWoS, WoW, 3D SoIC ve daha fazlası gibi çeşitli ürünler sunmaktadır.
Gelişmiş paketleme, TSMC için olgun bir iş haline gelmiştir. Şirket, 2019 yılında bu alandan 3 milyar dolar gelir elde etmeyi beklemektedir; bu da onu OSAT sıralamasında dördüncü sıraya yerleştirecektir.
UMC, 2.5D paketleme için önemli bir silikon ara katman tedarikçisidir. Şirket, çeşitli yarı iletken cihazlar için ZiBond ve DBI teknolojilerini optimize etmek ve ticarileştirmek amacıyla kısa süre önce Xperi ile ortaklık kurmuştur.
Bu arada, Wuhan Xinxin (XMC) görüntü sensörleri ve yüksek performanslı uygulamalar için 3D IC TSV paketleri sunmaktadır. Bu oyuncular, paketlemeyi alt tabakalardan silikon platformlara taşımada önemli bir rol oynamıştır.
2.3 Sistem düzeyinde paketleme genellikle popülerdir
SiP ambalajlama endüstri zincirindeki katılımcıların faaliyetlerini hem yukarı hem de aşağı yönde genişletmesi bir trend haline gelmiştir. Geleneksel SiP ambalajlama endüstri zincirinde, IC ambalajlama ve test alanının önde gelen şirketleri arasında Changdian Technology ve ASE yer almaktadır; bu şirketler ağırlıklı olarak işlevsel düzeydeki standart ambalajlama ve test ürünleri sunmaktadır. Sistem düzeyinde ambalajlamanın önde gelen şirketi ise USI’dir ve bu şirket ağırlıklı olarak modül düzeyinde sistem ambalajlaması gerçekleştirmektedir. Bu iki şirket, endüstri zincirinde yukarı ve aşağı yönde bir ilişki içindedir ve kullandıkları süreçler ile ekipmanlar birbirinden farklıdır.
2.4 Gömülü Yonga Devreleri
Öte yandan, Samsung Electro-Mechanics (SEMCO), Unimicron, AT&S ve Shinko Electric (Shinko) gibi IC alt tabaka ve PCB üreticileri, panel düzeyinde fan-out paketlerdeki gömülü yongalar (ve pasif bileşenler) ile organik alt tabakaları kullanarak gelişmiş paketleme alanına giriyor ve OSAT’ların pazar payını (özellikle gelişmiş paketleme ile ilgili işlerde) azaltıyor.
3. İleri Düzey Paketleme Yonga Pazar Payı
Genel paketleme ve test pazarındaki yoğunlaşmaya kıyasla, ileri düzey paketleme ve test pazarındaki yoğunlaşma nispeten düşüktür. 2017 yılında, ilk 8 üretici ileri düzey paketleme pazar payının %67’sini oluşturuyordu.

Gelişmiş ambalajlama pazarındaki tedarikçiler farklı uzmanlık alanlarına sahiptir:
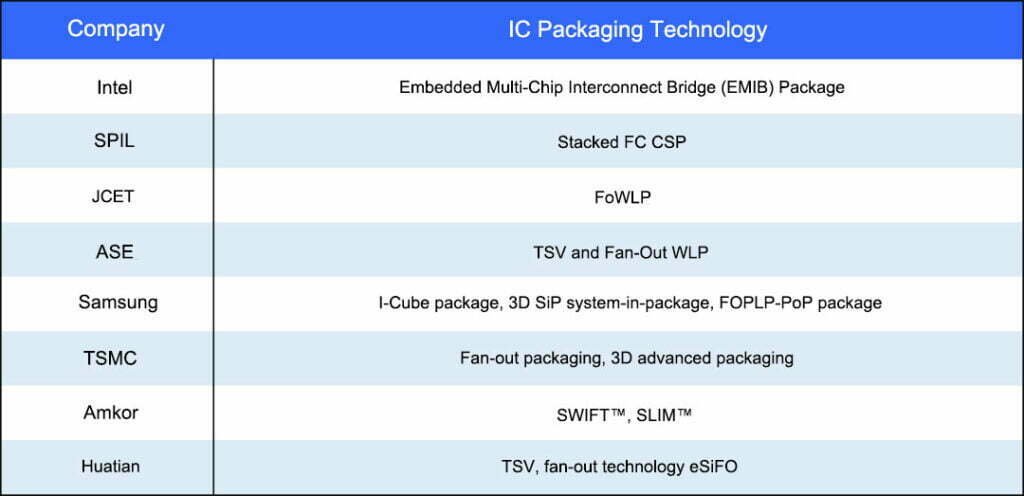
Çin IC Ambalaj Sektörünün Durumu
Çin'in IC ambalajlama endüstrisi çok erken bir dönemde başlamış ve hızla gelişmiştir; bu endüstri esas olarak geleneksel ambalajlama ürünlerine dayanmaktadır. Son yıllarda, yerli üreticiler birleşme ve satın almalar sürecinden geçmiştir. Şu anda, Çin'in teknoloji platformu yurtdışı üreticilerle temelde aynı seviyeye gelmiştir. Dahası, BGA, TVS, WLCSP ve SiP gibi ileri düzey ambalajlama teknolojileri seri üretime geçmiştir.
Bununla birlikte, Tayvan ve ABD’deki ileri düzey ambalajlama sektörünün toplam gelirleri arasında hâlâ belirli bir fark bulunmaktadır. TrendForce’un istatistiklerine göre, Çin’in 2018 yılındaki ileri düzey ambalajlama geliri yaklaşık 52,6 milyar yuan olarak gerçekleşmiştir. Bu rakam, yurt içi ambalajlama ve test gelirlerinin toplamının %25’ini oluşturmuş olup, küresel ortalamanın %41’inin altında kalmıştır. Dolayısıyla, gelecekte büyüme için hâlâ büyük bir potansiyel bulunmaktadır.
Çin İleri Düzey IC Paketleme Pazarı
Buna ek olarak, anakara ambalaj şirketleri ile uluslararası lider üreticiler arasında da büyük bir uçurum bulunmaktadır. Bu uçurum, özellikle HPC yonga ambalaj teknolojisi gibi yüksek yoğunluklu entegre devre ambalaj teknolojilerinde belirgindir. TSMC tarafından önerilen SoC çoklu yonga 3D istifleme teknolojisi. CPU/GPU ve belleğin genel hesaplama hızını büyük ölçüde artırabilen, çıkıntısız bir bağlama yapısı kullanmaktadır. Intel de benzer bir 3D ambalajlama konsepti önermiş ve belleği CPU ve GPU yongalarının üzerine istiflemiştir.

Çin’in ileri düzey ambalaj pazarının küresel üretim değeri nispeten düşük olmakla birlikte, hızla büyüyor ve pazardaki payı giderek artıyor. Yole verilerine göre, 2017 yılında Çin’in ileri düzey ambalaj üretim değeri 2,9 milyar ABD doları olarak gerçekleşmiş ve dünya toplamının %11,9’unu oluşturmuştur; bu rakamın 2020 yılına kadar 4,6 milyar ABD dolarına ulaşarak dünya toplamının %14,8’ini oluşturacağı tahmin edilmektedir. Verilere göre, Çinli ambalaj ve test şirketleri 2018 yılında ileri düzey ambalajlama alanında üretim kapasitesindeki artışı hızlandırdı ve büyüme oranı %16 ile küresel oranın iki katına ulaştı.
pazarın itici gücü
Gelişmiş paketleme için iki farklı geliştirme yolu bulunmaktadır:
Birincisi, boyutları küçülterek çip boyutuna yaklaştırmaktır. Burada önemli bir gösterge, çip alanının paket alanına oranıdır. Bu oran 1’e ne kadar yakınsa o kadar iyidir; bu kapsamda WLCSP, FC, Bumping, Fanout vb.
teknolojiler yer almaktadır. İkincisi ise işlevsel geliştirmedir; bu yaklaşım, heterojen entegrasyona ağırlık verir ve TSV, SIP vb. teknolojilerle sistem minyatürleşmesinde çok işlevlilik sağlar.
1. SIP Teknolojisi
Küresel yarı iletken üretim süreci, diyotların fiziksel sınırlarına yaklaşmaktadır. En gelişmiş üretim süreci 7 nm'dir. Devasa yatırımlar nedeniyle, üretim açısından yonga performansını daha da artırmak giderek daha pahalı hale gelmektedir. Yonga paketlemesinden başlayarak, sistem-içinde-paket (SIP) teknolojisi, mantık yongaları ve bellek gibi farklı işlevlere sahip yongaları bir araya getirmektedir.
Pasif bileşenler IPD, RF RF ve sensörler ile diğer yongalar tek bir modülde paketlenir; bu da yonga boyutunu küçültebilir, yonga performansını artırabilir ve güç tüketimini azaltabilir. Nesnelerin İnterneti (IoT), SIP paketleme teknolojisinin gelişimini destekleyen önemli bir uygulama senaryosudur ve giyilebilir cihazlar, gelecekte sistem-içinde-paket teknolojisi için büyük uygulama potansiyeline sahip bir alandır. Apple Watch'taki parmak izi tanıma sensörü, 3D yüz tanıma sensörü, WiFi kablosuz ağı ve diğer işlevsel modüller bir arada paketlenmiştir; bu, ASE'nin sistem-içinde-paket (SiP) modül teknolojisinin kullanımıdır.
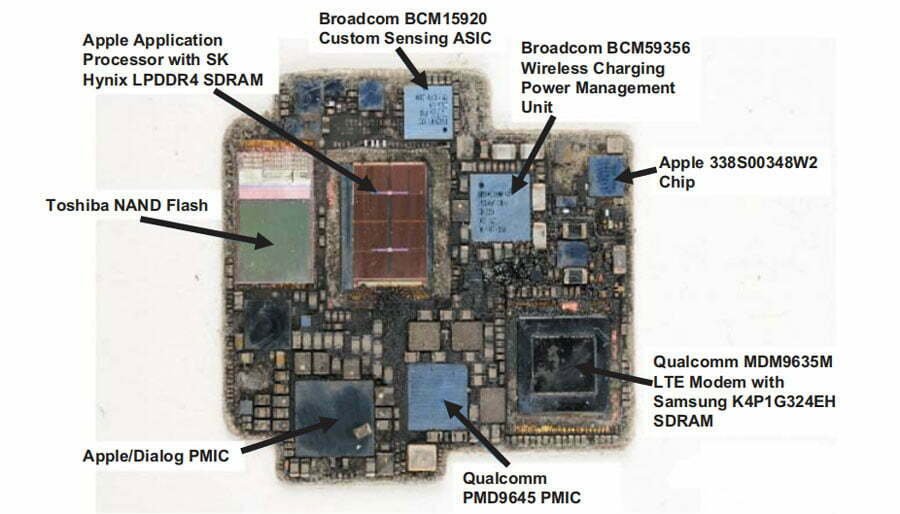
SIP teknolojisi, entegre devreleri, ayrık elemanları, optik elemanları, bellekleri, çok katmanlı seramik kondansatörleri ve çip dirençlerini, birbirlerinin sinyallerini bozmadan ince ve kısa alt tabakalara başarıyla entegre eder. Apple’ın sistem paketleme uygulamalarında rakiplerinden en az bir ila iki yıl önde olduğuna inanıyoruz. Farklı uygulama gereksinimlerine ve ürün karmaşıklığına göre, sistem içi paketleme (SiP) türleri, birden fazla aktif ve pasif bileşen içeren 2D modüller ve daha karmaşık 3D modüller olarak ayrılabilir. Örneğin, sistemdeki PiP (Paket İçi Paket), PoP (Paket Üzeri Paket) ve sistemdeki 2.5D/3D paketleme teknolojisi.
2. TSV Teknolojisi
3D paketleme teknolojisinin bir temsilcisi olarak TSV teknolojisi, gelecekte 3D NAND FLASH flash bellek paketleme ve DRAM bellek paketleme alanlarında daha geniş uygulama alanlarına sahip olacaktır. Bellek, yerli yarı iletken alanında en fazla büyüme potansiyeline sahip alt sektör haline gelmiştir. İki büyük bellek projesi olan Yangtze Memory (NAND FLASH) ve Hefei Changxin (DRAM), 2020 yılında seri üretime geçecek ve bu durum, gelişmiş paketleme teknolojisine sahip yerli üreticiler için şüphesiz büyük bir büyüme fırsatı olacaktır.
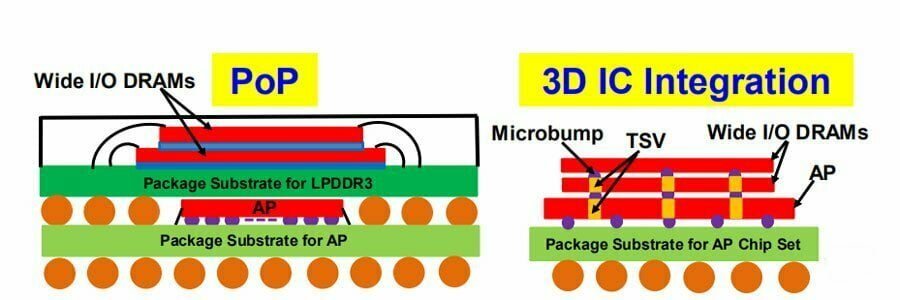
3. Yayılma
5G çağına girerken, daha yüksek veri aktarım hızı ve bant genişliği kapasitesi elde etmek için, aktarım ortamı olarak daha yüksek frekanslı elektromanyetik dalgalar kullanılmalıdır; bu dalgaların dalga boyları daha kısadır ve milimetre dalga seviyesine girer. 5G çağındaki iki ana frekans olan Sub-6GHz frekans bandı ve 28GHz milimetre dalga frekans bandı, frekansın artması nedeniyle dalga boyunun düşmesi sonucunda antenin daha kısa olmasıyla sonuçlanır; bu nedenle, tasarımın basitleştirilmesi ve maliyetlerin düşürülmesi amacıyla 5G çip çağında antenin çipe entegre edilmesi beklenmektedir.
Yeni nesil 5G yongaları için iki olası paketleme teknolojisi vardır: bir alt tabakaya sahip AiP (Paket İçinde Anten) ve taşıyıcı kartı olmayan fan-out paketi. İkinci fan-out paketleme şeması bir alt tabaka gerektirmediğinden, maliyetleri daha da düşürebilir ve birden fazla yongayı entegre ederek yonga boyutunu küçültebilir; bu nedenle fan-out paketleme teknolojisi, 5G yonga paketlemenin ana akım teknolojisi haline gelebilir.
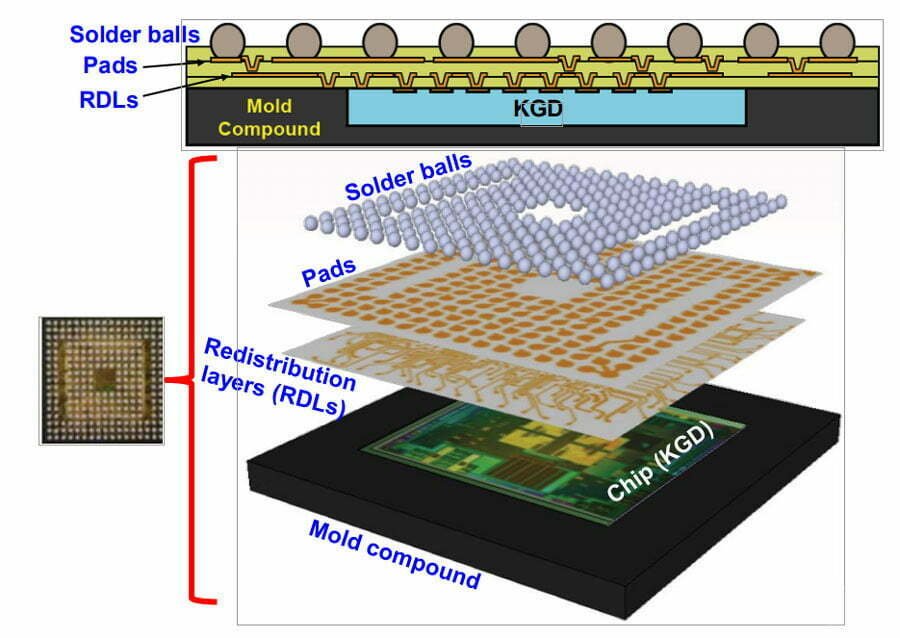
Araçtaki her elektronik modül farklı paketleme teknolojileri kullanmaktadır ve otomotiv elektroniğindeki milimetre dalga radar yongasının paketlemesinde de çok sayıda Fan-out paketleme teknolojisi kullanılacaktır.
Yerli paketleme ve test fabrikası Changdian Technology, Xingke Jinpeng'i satın aldıktan sonra eWLB paketleme teknolojisini de bünyesine katarak milimetre dalga radar alanında ilk paketleme ve test üreticilerinden biri haline gelmiştir. Huatian Technology'nin de son teknolojik atılımların ardından bu alanda çalışmalar yapması beklenmektedir.
Teknoloji geliştirme yönü
Yarı iletken paketlemede iki tür vardır: geleneksel paketleme ve ileri düzey paketleme. İleri düzey paketlemenin ölçeğinin sürekli genişlemesiyle birlikte, bu alandaki pay giderek geleneksel paketleme eğilimine yaklaşmış ve onu aşmıştır. Yarı iletken endüstrisi için paketleme ve test, artık geçmişteki gibi sadece ayrı bir üretim aşaması değil, tasarım, malzeme ve ekipmanı bir araya getiren entegre bir çözümdür.
Bu nedenle, yarı iletken paketleme ve test alanında gelişmiş paketleme giderek daha önemli hale gelmektedir. Yole'un tahminlerine göre, küresel gelişmiş paketleme pazarı 2020 yılına kadar tüm entegre devre paketleme hizmetlerinin %44'üne ulaşacak ve yıllık işletme geliri yaklaşık 31,5 milyar ABD doları olacaktır; Çin'in gelişmiş paketleme pazarı ise 2020 yılında 4,6 milyar ABD dolarına ulaşacak ve yıllık bileşik büyüme oranı %16 olacaktır. Teknik açıdan bakıldığında, FOWLP, SiP ve 3DTSV en çok ilgi gören üç ileri düzey paketleme ve test teknolojisidir.
1. FOWLP Ambalaj
FOWLP paketi, farklı üretim süreçlerinden elde edilen birden fazla yongayı kompakt bir pakette birleştirmeye yönelik yeni bir yöntemi ifade eder. Bu yöntem ilk olarak Intel tarafından önerilmiştir. FOWLP’nin fan-in paketleme teknolojisine göre avantajları şunlardır: daha ince paket kalınlığı, ölçeklenebilirlik (G/Ç sayısını artırmak için), iyileştirilmiş elektriksel performans, iyi termal performans ve alt tabakasız üretim süreci.
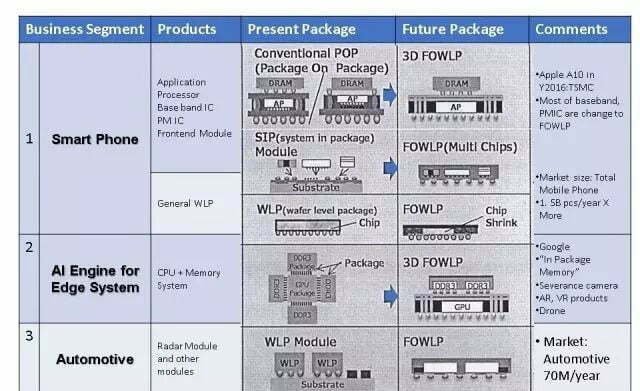
2. SiP Ambalajı
Sistem-içinde-paket (SiP), bir veya daha fazla IC yongasını ve pasif bileşeni tek bir pakette birleştiren, IC paketleme alanındaki en üst düzeyde yer alan yeni bir paketleme teknolojisidir. SiP, maliyetleri düşürmek ve pazara sunma süresini kısaltmak için mevcut temel kaynakların ve yarı iletken üretim süreçlerinin avantajlarını bir araya getiren ideal bir çözümdür. Aynı zamanda, SOC'deki işlem uyumluluğu, sinyal karışması, gürültü paraziti ve elektromanyetik parazit gibi zorlukların üstesinden gelir. Ayrıca, SiP'nin uygulama alanı çok geniştir. Şu anda, akıllı telefonların üretim değeri yaklaşık %70 ile en yüksek oranı oluşturmaktadır.
5G teknolojisinin ticari kullanımıyla birlikte SiP ambalajına olan talep artmaktadır. İlk olarak, bağımsız RF'nin değerindeki artış nedeniyle, RF ön ucunun genel pazar büyüklüğü hızla artmıştır. Genel olarak, genellikle GaAs tabanlı olan RF ön ucu, 5G milimetre dalga anteni ve RF entegrasyon bileşenlerinin modülerleştirilmesi yönünde bir eğilim vardır. 5G anteni esas olarak LCP'den (Sıvı Kristal Polimer) oluşur ve SiP ambalajlama, heterojen entegrasyon için oldukça uygundur. SiP ambalajlamanın RF sektöründe daha popüler hale gelmesi beklenmektedir.
3. 3D Ambalaj - TSV
3D paketleme, boyut, ağırlık, hız, verim ve enerji tüketimi gibi temel performans göstergelerini iyileştirir ve çoğu yarı iletken üreticisi tarafından en umut vaat eden paketleme yöntemi olarak kabul edilir. İleri düzey paketlemenin etki alanı, yüksek performans ve yüksek yoğunluklu entegrasyona sahip ileri teknolojilere doğru genişlemeye devam ederken, dördüncü nesil 3D paketleme teknolojisi olarak bilinen TSV'nin, ileri düzey paketlemenin gelecekteki gelişimi için sürdürülebilir bir itici güç haline gelmesi beklenmektedir.