QFN Paketi nedir?
Quad Flat No-Leads Package (QFN), kare şekli ve dış bağlantı uçlarının bulunmaması ile karakterize edilen bir yüzey montajlı paketleme türüdür. Bunun yerine, dört kenarı boyunca elektrik bağlantıları için iletken pedler (pimler) içerir ve tipik pim aralıkları 0,65 mm, 0,5 mm, 0,4 mm ve 0,35 mm'dir.
Harici uçların bulunmaması nedeniyle, QFN paketleri Quad Flat Paketlere (QFP) kıyasla daha küçük bir ayak izine ve yüksekliğe sahiptir. QFN paketinin tabanının ortasında büyük bir açık termal ped bulunur. QFN paketlerinde kanatlı uçlar yoktur; bunun yerine, iç pimler ile pedler arasında kısa elektrik yolları sunarlar, bu da düşük öz endüktans ve iç hat direnci ile sonuçlanır ve mükemmel elektrik performansı sağlar. Açıkta kalan termal ped, ısı yayma kanalı görevi görür ve QFN paketlerini ısı yayma konusunda oldukça verimli hale getirir.
QFN Ambalajının Yapısı
Şimdi tel bağlamalı QFN paketine bir göz atalım; iç yapısı şu şekildedir:

Kalıp ve Kurşun Çerçeve
QFN ambalajı, mat kalay kaplamalı bakır alaşımından yapılmış bir kurşun çerçeve ile çevrelenmiş bir kalıptan oluşur. Kurşun çerçevenin ana malzemesi bakırdır ve A194, C7025 ve FET64 gibi farklı kaliteler yaygın olarak kullanılmaktadır.
Kalıplama Macunu
Elektrikli kalıplama bileşiği, baz reçine olarak epoksi reçine, sertleştirici olarak yüksek performanslı fenolik reçine ve silikon mikro tozu gibi dolgu maddelerinin yanı sıra çeşitli katkı maddelerinden oluşan toz halindeki bir kalıplama bileşiğidir.
Kaplama Malzemesi
QFN paketinin altındaki açıkta kalan ped için kullanılan kaplama malzemesi genellikle saf kalay veya nikel-paladyum-altındır (NiPdAu). Bu malzeme, hem devre kartına (PCB) bağlantı sağlar hem de etkili bir ısı transferi sağlar. Epoksi malzeme ise yonga ile ped arasındaki bağlantıyı sağlamlaştırır.
Yonga Yapıştırma
İki ana türü vardır: iletken ve iletken olmayan. Bu malzemeler, yapıştırıcılar, yonga sabitleme filmi (DAF), lehim teli ve lehim macunu gibi çeşitli şekillerde bulunabilir.
Bağlantı Teli
Bağlantı tellerinin başlıca türleri arasında bakır, altın, gümüş ve alüminyum bulunur.
QFN Paketlemenin Avantajları
Küçük boyutlu ve hafif
SOP ve TQFP gibi diğer paketlerle karşılaştırıldığında, QFN boyut ve ağırlık açısından önemli avantajlar sunar. "Paket verimliliği" terimi, yonga alanının paket alanına oranının 1'e yaklaşmasını ifade eder ve bu da yüksek verimliliği gösterir. SOP'un paket verimliliği 0,1-0,2 iken, QFN 0,3-0,4'e, hatta termal ped kullanılmadığında 0,5'e ulaşabilir; bu da yüksek verimliliğini ortaya koymaktadır.
QFN, PCB alanı gereksiniminin az olması nedeniyle cep telefonları ve kameralar gibi taşınabilir elektronik cihazlarda yaygın olarak kullanılmaktadır.
Mükemmel Isıl Performans
QFN paketlerinin alt kısmında, devre kartına doğrudan lehimlenebilen geniş bir lehim yuvası bulunur. Bu lehim yuvası bir ısı emici görevi görür; çalışma sırasında yonganın ürettiği ısıyı etkin bir şekilde dağıtır, böylece ısı dağılım alanını ve hızını artırır.
Üstün Elektriksel Performans
QFN paketlerinde harici uçlar bulunmadığından elektriksel yollar daha kısadır; bu da daha düşük özindüktans ve iç kablolama direnci sağlayarak üstün elektriksel performans sunar.
QFN ayrıca yüksek güvenilirlik ve maliyet etkinliği sunar.
QFN Paketi için Bağlantı Teknolojisi
İşte bazı yaygın QFN paketleme teknikleri: Tel Bağlantı, Flip Chip ve Klips Bağlantısı.
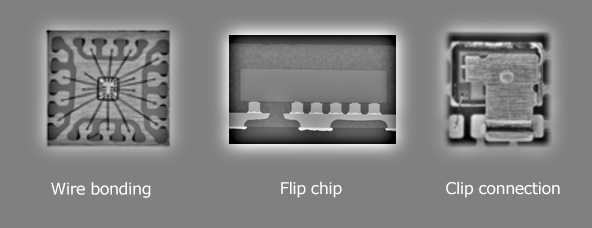
Tel Bağlantı
- Tanım: Tel bağlama, yarı iletken yongayı paket alt tabakasına bağlamak için kullanılan geleneksel bir yöntemdir. Bu yöntemde genellikle ince metal teller (altın veya alüminyum gibi) kullanılarak yonganın bağlantı noktaları, paket veya PCB üzerindeki bağlantı noktalarına bağlanır.
- QFN ile ilişkisi: Bir QFN (Quad Flat No-lead) pakette, tel bağlama, çipin pedlerini QFN paketinin lehim pedlerine bağlamak için kullanılabilir. Bu yöntem, özellikle düşük frekanslı veya düşük güç uygulamalarında, çipten PCB'ye elektrik bağlantıları kurmak için sıklıkla kullanılır.
- Kullanım örneği: Bu, özellikle daha küçük bağlantı boyutlarının ve daha uygun maliyetli montajın istendiği uygulamalarda yaygın olarak kullanılan bir paketleme tekniğidir.
Flip Chip
- Tanım: Flip chip, yarı iletken yonganın ters çevrilip geleneksel tel bağları yerine lehim topları (veya çıkıntılar) kullanılarak doğrudan pakete veya PCB’ye lehimlendiği bir paketleme tekniğidir. Bu, daha iyi termal ve elektriksel performansa sahip yüksek yoğunluklu bir bağlantı sağlar.
- QFN ile ilişkisi: QFN kurşunsuz bir ambalaj olmasına rağmen, flip chip teknolojisi bir QFN tasarımında, özellikle yonga ile QFN ambalajının pedleri arasındaki bağlantılar için kullanılabilir. Bu durumda, yonga ters çevrilir (flip) ve doğrudan alt tabakaya veya ambalaja tutturulur.
- Kullanım örneği: Flip chip, genellikle RF devreleri, işlemciler ve diğer yüksek frekanslı veya yüksek güçlü elektronikler gibi daha yüksek yoğunluklu bağlantılar gerektiren yüksek performanslı uygulamalarda kullanılır.
Klips Bağlantısı
- Tanım: Klips bağlantısı, yonga ile paket veya alt tabaka arasında elektriksel veya termal bir bağlantı kurmak için fiziksel bir klips veya kelepçenin kullanıldığı yöntemi ifade eder. Bu yöntem, QFN paketlerinde daha az yaygın olmakla birlikte, yüksek güçlü uygulamalarda veya belirli endüstrilerde daha sıklıkla kullanılır.
- QFN ile ilişkisi: Klips bağlantısı, QFN paketlemede kullanılan tipik bir yöntem değildir. Ancak, özellikle daha yüksek akım veya güçle çalışılması gereken durumlarda, klipsin güçlü bir mekanik ve elektriksel bağlantı sağladığı belirli özel QFN paketlerinde kullanılabilir.
- Kullanım örneği: Bu bağlantı yöntemi, güç elektroniği, yarı iletken güç cihazları gibi yüksek güçlü sistemlerde veya sağlam ve düşük dirençli bağlantıların gerekli olduğu durumlarda kullanılır.
QFN Paketleme Süreci
QFN paketleme süreci, yonga levha taşlama, kesme, yonga yapıştırma, tel bağlama, kapsülleme, kaplama, işaretleme ve ayırma gibi çeşitli adımlardan oluşur. Dört temel adım şunlardır:
1. Adım: Yonga Taşlama
QFN ambalajlama için ayrılan sınırlı alana sığması amacıyla yonga plakasının kalınlığını azaltır.
2. Adım: Küp şeklinde doğrama
dilimleme işlemi, tek tek yongaları yonga plakasından ayırır.
3. Adım: Yonga Yapıştırma
ayrılmış yongaları, gerekli bağlantı uçlarına sahip metal bir taşıyıcıya yerleştirir.

4. Adım: Tel Bağlama
çipin işlevsel bağlantı noktalarını otomatik tel bağlama makinesi kullanarak paket uçlarına bağlar.

5. Adım: Kapsülleme
çipi ve metal taşıyıcıyı epoksi reçine ile kaplayarak korur.
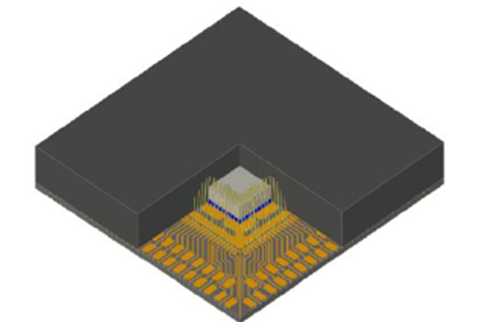
6. Adım: Kaplama
bakır uçların üzerine oksitlenmeyi önlemek için bir kat kalay kaplar.

7. Adım: İşaretleme
çipi ürün adları, müşteri logoları ve parti bilgileriyle etiketleyin.

8. Adım: Parçaların Ayrılması
Ayırma işlemi, hazırlanan paketleri tek tek parçalara ayırır.
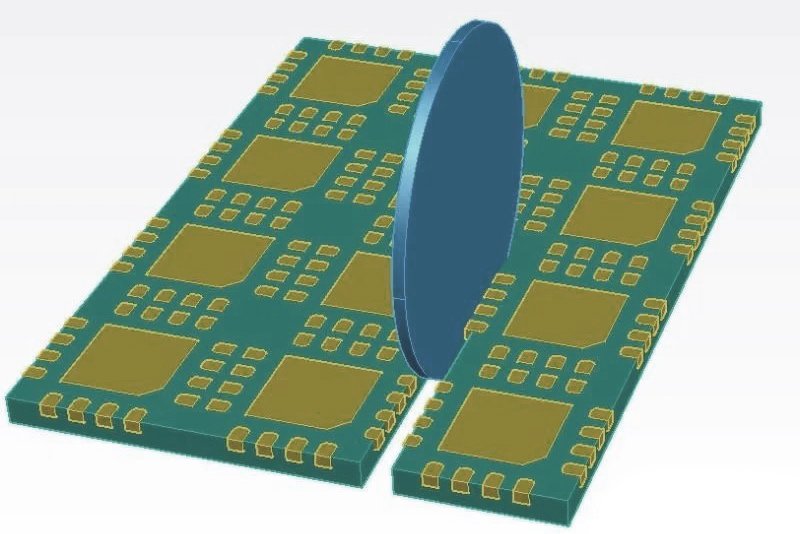
QFN Yerleşim Şeması Tasarım Kılavuzu
Bir QFN (Quad Flat No-lead) bileşeni için PCB ayak izini tasarlarken, lehimleme sürecinde sorunların önlenmesi ve optimum elektriksel ve termal performansın sağlanması için hassas ve etkili bir yerleşim planı oluşturmak hayati önem taşır. Aşağıda, sağladığınız referans içeriğe dayalı olarak QFN ayak izi tasarımının temel unsurlarını ele alan ayrıntılı bir inceleme yer almaktadır:
Yaygın QFN Aralığı ve Örnek
QFN bileşenleri genellikle 0,5 mm, 0,4 mm ve 0,35 mm aralıklarında sunulur. Örnek olarak, 0,5 mm aralıklı bir QFN bileşenine odaklanalım. Bu tür bileşenlerin veri sayfasında genellikle bileşen boyutları bir aralık olarak verilir (ör. 0,20–0,30 mm), burada en tipik değer 0,25±0,05 mm olabilir. Uygulamada, üreticiler kendilerini korumak için toleransları abartma eğilimindedir, ancak gerçek boyutların listelenenler kadar geniş olmayabileceğini unutmamak önemlidir.

Önerilen PCB Yerleşim Tasarımı
Bir QFN bileşeninin PCB ayak izini tasarlamak için çeşitli faktörlerin dikkatle değerlendirilmesi gerekir:

Küçük Ped Genişliği: Üretici 0,3 mm'lik bir ped genişliği önerebilir, ancak en iyi uygulamalara göre 0,27 mm'lik bir genişlik tavsiye edilir. Daha geniş bir ped genişliği, özellikle şablon tasarımı (serigrafi) uygun şekilde optimize edilmediğinde, pedler arasında lehim köprüleri oluşma riskini artırabilir. Ayrıca, ped genişliği QFN bileşeninin kendi uç genişliğinden (genellikle 0,25 mm) daha dar olmamalıdır.
Ped Uzunluğu: Önerilen ped uzunluğu genellikle 0,8 mm'dir ve bu kabul edilebilir bir değerdir. Örneğin, toplam paket genişliği 3 mm ve dış ped uzunluğu 3,7 mm ise, paket genişliğini (3 mm) çıkararak 2'ye bölmek, her bir taraf için 0,35 mm'lik bir uzantı verir. Yakındaki bileşenlerle, özellikle de merkezi ısı yayma pediyle paraziti önlemek için bu uzunluk bu değeri aşmamalıdır.
Isı Emici Ped Boyutu: Merkezi ısı emici ped, genellikle 1,65 mm civarında olan bileşenin termal ped boyutlarıyla eşleşmelidir. Boyutun üreticinin önerisinden daha büyük olması gerekmez, ancak termal performansı artırmak için yuvarlatılmış köşeli (özellikle ısı dağılımı için) tasarlanmalıdır.
Isı Dağılımı için Termal Via Tasarımı
QFN'lerde genellikle verimli ısı dağılımı için birden fazla bakır katmanına bağlanması gereken büyük merkezi ısı yayıcılar bulunur. PCB tasarımında:
Termal Via Boyutu: 1,6 mm kalınlığındaki bir PCB için, delik çapı 0,3 mm olan viaların kullanılması idealdir. Vialar çok büyük olmamalıdır, çünkü bu durum yeniden akış sırasında lehim pastasının sızmasına yol açabilir. Benzer şekilde, çok küçük de olmamalıdır, çünkü bu durum delme sorunlarına veya yetersiz termal iletkenliğe neden olabilir. Şablon tasarım sürecinde sorunların yaşanmaması için vialar arasındaki mesafe dikkatle değerlendirilmelidir.
Via Sayısı ve Aralığı: Isıyı etkili bir şekilde dağıtmak için, vialar termal ped üzerinde eşit aralıklarla yerleştirilmelidir. Ancak, viaların birbirine çok yakın yerleştirilmesi şablon tasarımında sorunlara neden olabilir ve lehimleme işlemi sırasında potansiyel sorunlara yol açabilir. Uygun lehim pastası birikimini sağlamak ve lehim köprülenmesini önlemek için vialar arasında yeterli aralık bırakıldığından emin olun.
Şablon Tasarımında Dikkat Edilmesi Gerekenler
Şablon Kalınlığı: 0,5 mm aralıklı bir QFN bileşeni için önerilen şablon kalınlığı genellikle 0,13 mm'dir. Bu kalınlık, lehim pastası hacmi ile yeniden akış lehimleme sırasında akış kabiliyeti arasında iyi bir denge sağlar.
Şablon için Ped Açıklığı: Lehim pastasının genleşmesini hesaba katmak için şablon açıklığı, ped genişliğinden biraz daha dar olmalıdır. Daha önce de belirtildiği gibi, 0,27 mm'lik bir ped genişliği, 0,22 mm ile 0,24 mm arasındaki bir şablon açıklığı genişliğine karşılık gelmelidir; bu, yeterli lehim pastası hacmini sağlarken, lehim köprülerine yol açabilecek fazla pastayı önler.
Ped Uzunluğu ve Açıklıkları: Şablon için ped uzunluğu 0,1 mm içe doğru ayarlanmalıdır ve dış pedlerin uzantısı 0,15 mm ile 0,25 mm arasında değişebilir. Amaç, özellikle daha küçük pedlerde fazla pasta olmadan eşit bir pasta tabakası sağlamaktır.
Termal Ped Açıklığı: Büyük termal ped için şablon açıklığı, gerçek ped boyutundan daha küçük olabilir; genellikle toplam alanın yaklaşık %40-60'ı kadardır. Lehim pastasının eşit bir şekilde akmasını sağlamak ve aşırı lehimlemeyi veya yetersiz pasta kullanımını önlemek için bir ızgara veya "tarama" deseni (ör. çapraz tarama veya kare ızgara) oluşturmak çok önemlidir. Ayrıca, potansiyel lehim pastası sızıntısına yol açabilecek herhangi bir viyanın üst üste binmesini önlemek için açıklıklar dikkatlice tasarlanmalıdır.
Sık Yapılan Hatalar ve En İyi Uygulamalar
Ayak İzi Tasarımında Toleransın Göz Ardı Edilmesi: Mühendisler genellikle, boyutların lehimleme ve elektriksel performans açısından optimize edilip edilmediğini dikkate almadan, veri sayfasından üreticinin önerdiği ayak izi boyutlarını körü körüne kopyalarlar. PCB tasarımını son haline getirmeden önce, kumpas gibi ölçüm araçlarını kullanarak boyutları doğrulamak çok önemlidir.
Padlerin Aşırı Tasarımı: Bazı tasarımcılar, üretim toleranslarını telafi etmek için pad boyutlarını büyütme hatasına düşerler, ancak bu, padler arasında köprü oluşması ve yeniden akış işlemi sırasında kısa devre riskinin artması gibi, çözdüğünden daha fazla soruna yol açabilir.
Yetersiz Isı Dağılımı: Termal viyalara ve ısı dağılımı tasarımına yeterince dikkat edilmemesi, IC'nin aşırı ısınmasına ve bunun sonucunda arıza veya hatalı çalışmaya neden olabilir. Bileşeni serin tutmak ve güvenli sınırlar içinde çalıştırmak için, termal pedin altında yeterli viyaların ve topraklama için yeterli bakır alanının bulunmasını sağlamak çok önemlidir.
QFN Ambalajının Uygulamaları
QFN ambalajı şu alanlarda yaygın olarak kullanılmaktadır:
- Telekomünikasyon ürünleri
- Cep telefonları
- Kablosuz LAN
- Taşınabilir ürünler
- Kişisel dijital yardımcılar (PDA'lar)
- Dijital kameralar
- Düşük ila orta kurşun sayısına sahip paketler
- Bilgi cihazları
Doğru QFN Paketini Seçmek
QFN paketi seçimi, aşağıdakiler dahil olmak üzere çeşitli faktörlere bağlıdır:
- Alan Kısıtlamaları: İnce ve ultra ince QFN'ler, alanın sınırlı olduğu uygulamalar için en uygun seçenektir.
- Isı Yönetimi İhtiyaçları: Açıkta kalan termal pedlere veya çoklu termal viyalara sahip paketler, ısıya duyarlı bileşenler için idealdir.
- Güvenilirlik: SWF QFN gibi paketler daha iyi inceleme imkanı sunar, bu da onları lehim bağlantı kalitesinin kritik olduğu yüksek güvenilirlik gerektiren uygulamalar için ideal hale getirir.
- Montaj ve Üretim Hususları: Yanları ıslatılabilir kenarlara veya ped üzerinde kurşun tasarımına sahip olanlar gibi bazı QFN'ler, montajı basitleştirir ve mekanik dayanıklılığı artırır.