В эпоху серверов с искусственным интеллектом, смартфонов 5G и автономных транспортных средств производительность микросхемы зависит от качества «нервной системы», на которой она основана, — подложки для интегральных схем. По мере того как плотность размещения схем достигает своих физических пределов, выбор технологического процесса определяет целостность сигнала и надежность конечного продукта.
Сегодня в отрасли доминируют три основных «инструмента для формирования»: Tenting (субтрактивный), mSAP (модифицированный полуаддитивный процесс) и SAP (полуаддитивный процесс). В этом руководстве подробно рассмотрены их технические механизмы, преимущества и недостатки, а также их место в современной экосистеме электроники.
1. Процесс трафаретной печати (субтрактивный метод)
Процесс нанесения фоторезиста — это наиболее традиционная и широко используемая технология формирования трассировок в производстве печатных плат и подложек низкой плотности. Его основной принцип заключается в «покрытии и удалении» — подобно высечению печати из каменного блока.
Как это работает: все начинается с ламината с медным покрытием (CCL) с толстой медной фольгой (обычно > 12 мкм). Сухая пленка (фоторезист) покрывает задуманные участки схемы, как «палатка» над отверстиями (отсюда и название). Затем незащищенная медь удаляется химическим травлением.
Проблема (боковое травление): поскольку травление удаляет медь одновременно по вертикали и горизонтали, образуется «трапециевидное» поперечное сечение. Это «боковое травление» ограничивает точность ширины линии и промежутка ($L/S$) примерно до $30\mu m/30\mu m$.
Наилучшее применение: стандартная бытовая электроника, автомобильные печатные платы и традиционные подложки для BGA с проволочной сваркой (WB BGA).
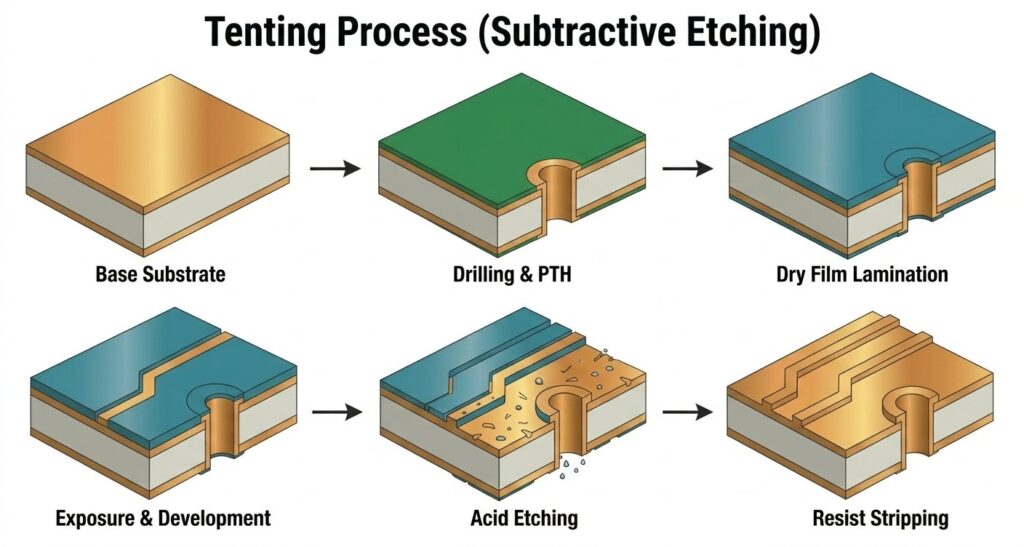
2. mSAP (модифицированный полуаддитивный процесс)
По мере увеличения количества выводов и повышения скорости передачи сигналов технология mSAP стала связующим звеном между традиционными печатными платами и высококачественными подложками для интегральных схем. В настоящее время она является основным выбором для подложек FCBGA, используемых в сетевых чипах и процессорах смартфонов премиум-класса.
Принцип действия: вместо толстой меди в mSAP используется ультратонкая медная основа (обычно 3–5 мкм) или химически осажденный «затравочный слой». Схема «добавляется» путем селективного гальванического осаждения до желаемой толщины.
Преимущество: после гальванизации быстрая «мгновенная травление» удаляет ультратонкий базовый слой. Поскольку основа настолько тонкая, время травления минимально, что приводит к получению почти вертикальных прямоугольных стенок схемы с характеристиками $L/S$ до $10\mu m/10\mu m$.
Наилучшее применение: высокопроизводительные процессоры для смартфонов (серия Apple A, Snapdragon), корпуса размером с чип (FCCSP) и печатные платы типа SLP (Substrate-like PCB).
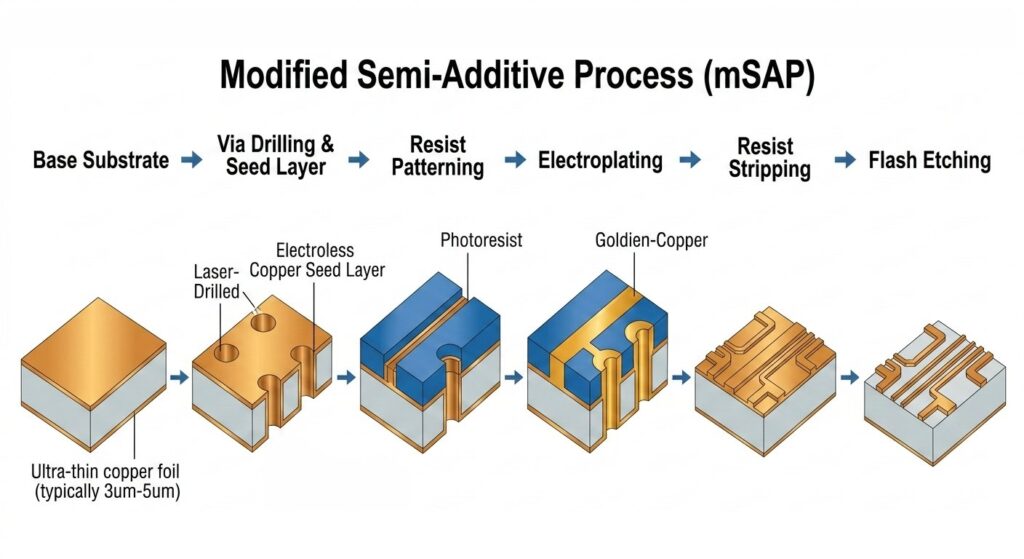
3. SAP (полуаддитивный процесс)
Технология SAP представляет собой вершину точности изготовления схем и часто называется «очищенной» версией mSAP. В ней полностью отказались от использования медной фольги в пользу «чистого нанесения».
Принцип действия: в ней используется безмедный диэлектрический материал, в первую очередь ABF (Ajinomoto Build-up Film). На гладкую поверхность химическим способом наносится микроскопический «затравочный слой» ($< 1\mu m$), после чего выполняется селективное гальваническое покрытие для формирования схем.
Преимущество: поскольку зародышевый слой практически отсутствует, травление не оказывает никакого влияния на морфологию схемы. Это обеспечивает чрезвычайную точность ($L/S < 10\mu m$) и превосходный контроль импеданса для высокоскоростных сигналов.
Наилучшее применение: Вычисления высокой производительности (HPC), ускорители искусственного интеллекта (Nvidia H100) и передовые технологии упаковки, такие как CoWoS и HBM.
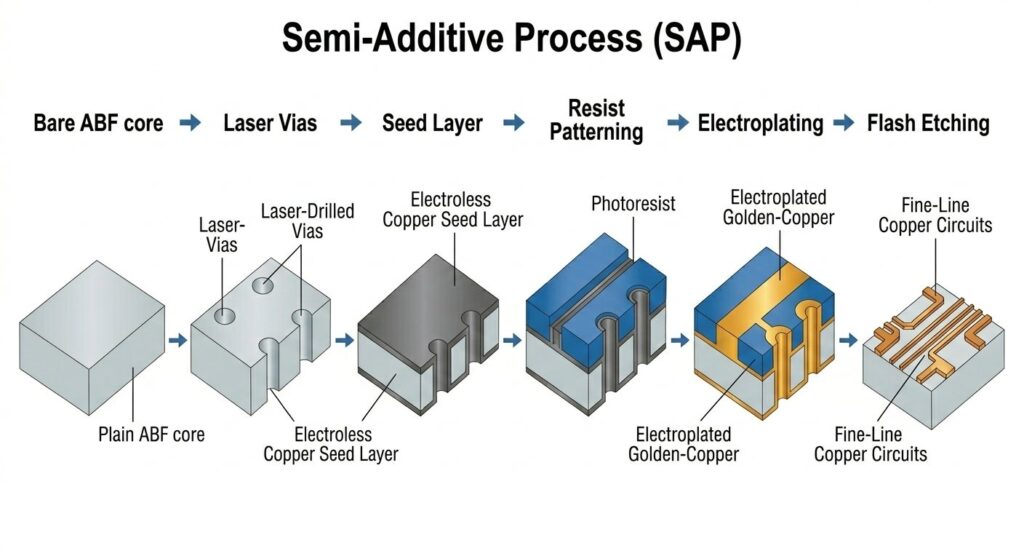
4. Сравнительная таблица: Tenting, mSAP и SAP
| Feature | Tenting | mSAP | SAP |
|---|---|---|---|
| Core Principle | Subtractive: Etch away thick copper foil | Additive: Plate over ultra-thin copper base | Pure Additive: Seed layer on copper-free dielectric |
| Line Precision (L/S) | > 30μm | 10μm - 30μm | < 10μm |
| Cross-section Shape | Trapezoidal (Side-etching) | Near-Rectangular | Perfectly Rectangular |
| Base Material | Standard CCL | Ultra-thin copper foil | ABF (Ajinomoto Build-up Film) |
| Primary Application | Consumer PCBs / Motherboards | Smartphone AP / High-end HDI | AI Accelerators / CPU / GPU Substrates |
| Cost & Maturity | Low Cost / Highly Mature | Medium-High / Mainstream High-end | Very High / Cutting-edge |
Взгляд в будущее: будущее производства
Отрасль движется в направлении «гибридного» подхода, позволяющего сбалансировать стоимость и производительность: для основных слоев используется технология Tenting, а для внешних слоев с высокой плотностью — mSAP/SAP. По мере того как спрос на ИИ раздвигает границы закона Мура, новые технологии, такие как стеклянные подложки и встроенные микросхемы, будут продолжать развиваться наряду с этими тремя основными процессами.
Понимание нюансов этих методов производства — первый шаг к освоению сложной сферы современной упаковки микросхем и аппаратной безопасности.